覆銅陶瓷基板(Direct Copper Bonding, DCB)是指銅箔在高溫下直接鍵合到氧化鋁或氮化鋁陶瓷基板表面上的特殊工藝方法,制成的復合板具有優良的電絕緣性能、高導熱性、高軟釬焊性、高附著強度、高電流承載能力。DCB 基板還可刻蝕出各種圖形,已成為大功率電力電子器件如絕緣柵雙極型晶體管(InsulatedGate Biopolar Thrans istor, IGBT)封裝結構和互連技術的基礎料,作為電力電子裝置的一部分,被廣泛應用于電動/混合動力汽車、風能發電、太陽能發電、柔性直流輸電、蓄電池、牽引傳動(高鐵、動車、飛機)等領域中。

銅結晶粒度是覆銅陶瓷基板領域中重要又往往容易被忽略的一環,較大的銅晶粒對于改善覆銅陶瓷基板的溫度循環( Temperature Cycling )與可靠性有一定幫助,同時較大的銅晶粒對于提升塑封類模塊中塑封料與基板之間的結合可靠性也有顯著提升。本期HEXCERA?基板小課堂與大家一起探討銅晶粒的定義(Definition)、測量方法(Measuring Method)及其對覆銅陶瓷基板性能、功率模塊封裝可靠性的影響。
DCB基板的銅結晶粒度取決于銅材料本身與所使用的加工工藝。普通無氧銅的耐熱性較差,經高溫熱處理后,晶粒迅速長大,晶粒尺寸甚至可達毫米級,這將在無氧銅板與陶瓷板的結合面及其自由表面處形成“橘皮組織”,增加無氧銅板的表面粗糙度。HEXCERA?在覆銅陶瓷基板的生產過程中,會控制銅表面結晶粒度,一般晶粒大小控制在60~150μm之間,同時實現對基板表面粗糙度的控制。以下為HEXCERA??DCB&AMB覆銅陶瓷基板的粗糙度管控范圍。
HEXCERA??DCB:Ra≤3um,Rz≤16um,Rmax≤50um;
HEXCERA??AMB:Ra≤1.5um,Rz≤10um,Rmax≤50um;
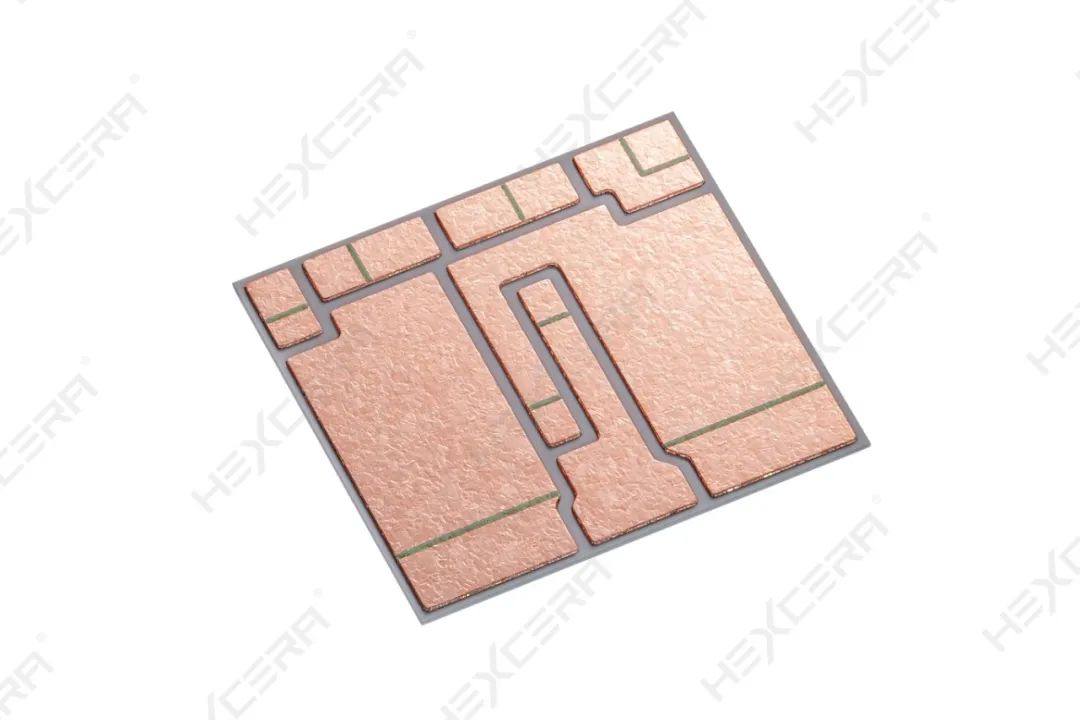
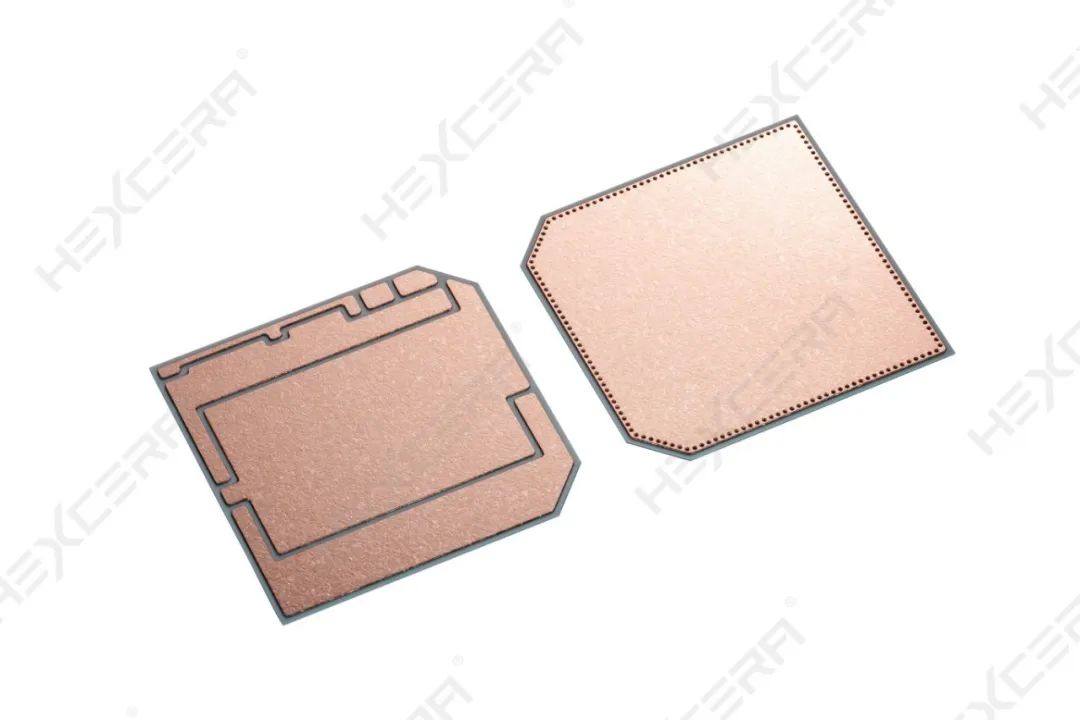
通常可以通過使用光學顯微鏡測量銅晶粒度,銅晶粒度即單位長度的晶粒個數。如下圖1所示,使用顯微鏡在X200倍率下可實現對指定區域內銅晶粒大小的測量與計數。

圖1 銅結晶粒度測量
在了解銅晶粒(copper grain)的基本概念之后,那銅晶粒是如何影響覆銅陶瓷基板的性能呢?接下來,HEXCERA?給大家解讀一下,晶粒大小如何影響基板的各項性能。
無論是DCB還是AMB基板,晶粒越小,晶粒的位錯密度增加,會導致位錯運動時易于發生位錯塞積和位錯交割,進而對位錯的運動造成阻礙,其最直接的體現就是基板在溫度循環過程中由于包辛格效應及棘輪效應的影響導致基板內部應力不斷累積增長最終導致的分層失效。下圖2、3為不同晶粒大小的DCB基板溫度循環的C-SAM情況,明顯看出大晶粒的DCB基板溫度循環壽命更長,測試條件為:
-55℃~+150℃, hot/cold chamber system,15min at min/max. Transfer time <30s。
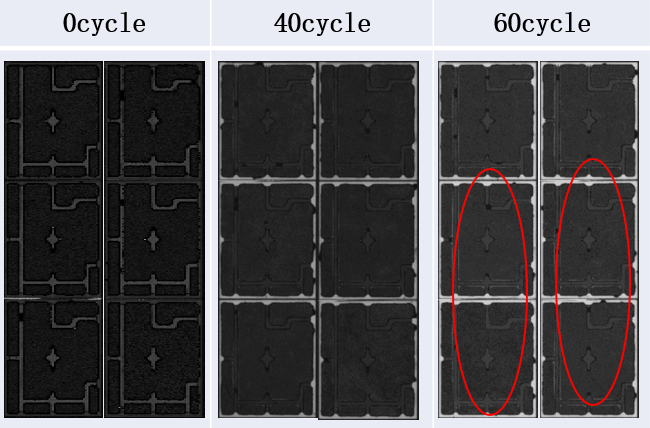 圖2 小晶粒DCB基板C-SAM
圖2 小晶粒DCB基板C-SAM
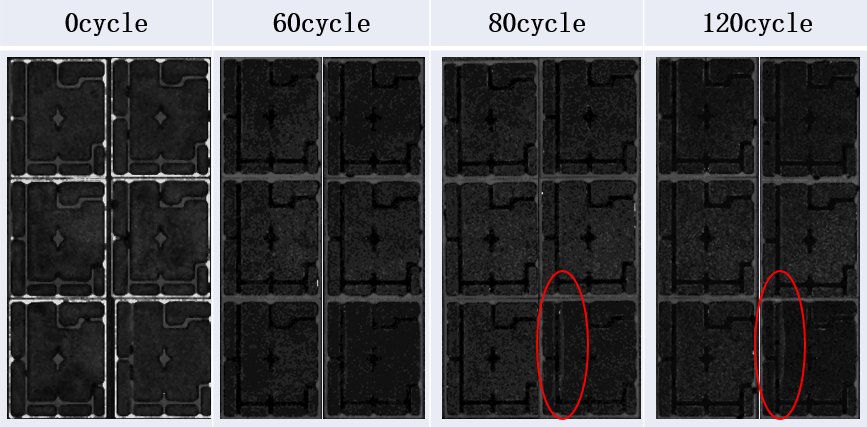 圖3 大晶粒DCB基板C-SAM
圖3 大晶粒DCB基板C-SAM
隨著晶粒大小的變化,晶界的重要性也慢慢凸顯,晶粒越細化,晶界越多,晶界內產生的電阻率會增加,根據Hall-Petch(霍爾-配奇公式:描述晶體塑性變形強度與晶粒尺寸關系的經驗公式)及晶界電阻率的計算公式:

其中,σHp為晶界強化引起的強度增量,σ0為晶格摩擦力,k為Hall-Petch斜率,d為晶粒尺寸,ρgb為晶界電阻率,ρ0gb為單位晶界密度的電阻率。由公式可以簡要總結為:晶粒尺寸減小,會使銅的塑形變形強度和電阻率增大,導電率下降;相反地,增大晶粒尺寸,會使銅的塑形變形強度和電阻率減小,導電率增大。
綜上,對于覆銅陶瓷基板來說,如果將銅晶粒調控到合適尺寸,那么不管是對基板性能還是封裝后模塊的整體可靠性都會有不錯的提升。HEXCERA?研發團隊致力于從提高產品性能,提高客戶的適配性和可靠性方面,對覆銅陶瓷基板進行研究,從而給客戶專業的優化建議與不同的解決方案,幫助客戶提升產品性能。
原文始發于微信公眾號(瀚思瑞半導體):HEXCERA?基板小課堂(第一期):?銅晶粒對覆銅陶瓷基板性能影響的探究
長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入交流群。

