低溫共燒陶瓷技術是一種以微晶玻璃或玻璃/陶瓷兩相復合材料為基礎的新型微電子封裝技術。LTCC 技術以其優異的電學、熱學、機械及互聯特性,已成為新一代無源器件小型化、集成化、多功能化及系統級封裝的首選方式,被廣泛應用于各種微電子器件領域,如高精度片式元件、無源集成功能器件、無源集成基板及微電子功能模塊等封裝制品中。近年來,5G/6G移動通信、虛擬現實、人工智能等新興技術的涌現為 LTCC 材料的發展帶來了全新的機遇。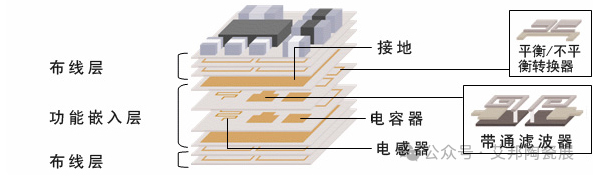
系統級集成封裝向高密度、多功能、大功率和智能化方向發展已成為不可避免的趨勢,而隨集成度的持續增加,熱耗散功率密度急劇上升,導致微電子器件的散熱問題愈發突出,嚴重威脅微電子器件的可靠性和使用壽命,這便對 LTCC 基板材料的散熱性能提出了非常嚴苛的要求。一般地,固體材料的熱導率與其聲子平均自由程密切相關。而玻璃材料原子排列具有短程有序、長程無序的特點,導致玻璃基體聲子平均自由程較小,這使得以微晶玻璃或玻璃/陶瓷兩相復相材料為基礎的 LTCC 材料的熱導率較低,難以滿足大規模及超大規模集成電路的應用要求。1、LTCC 技術的特點
LTCC 技術主要是采用可低溫燒結的玻璃或玻璃陶瓷復合材料,通過流延成型制出厚度精確且致密的生瓷帶,再通過激光打孔、精密絲網印刷等工藝在生瓷帶上印刷電路圖形,將多層生瓷帶疊壓,并在生瓷帶中內埋必要的元件,利用 Au、Ag 等金屬漿料制成內外電極,最后在低于900℃下燒結,形成高密度的電路基板。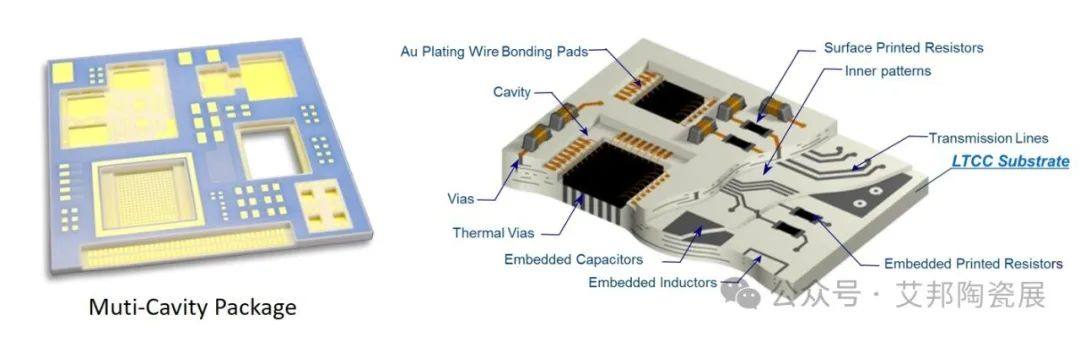
LTCC 技術是一種先進的無源集成及混合電路封裝技術,與其他集成電路封裝技術相比顯示出巨大的優越性,能夠顯著提高多層微電路芯片封裝設計的靈活性。LTCC 技術的特點:(1)介電性能的可調控性。LTCC 材料在擁有較低的介電損耗的同時可以通過調節原料成分及其配比調控介電常數,適配于不同需求的基板,提高電路設計的活性。(2)較低的燒結溫度。LTCC 技術可以在低溫條件下進行燒結,降低能耗,從而避免高溫對電子元件和材料的損害。(3)高密度導線布線能力。LTCC 工藝優化了線寬間距使其更小,可以實現更加緊密的布線結構,提供更高的導電率和更好的信號傳輸性能。(4)可以實現無源件的集成。通過內埋的方式減少電感、濾波器等元件數量,以此提升封裝密度與可靠性。(5)具有良好的工藝兼容性。能夠與多種材料組合,并與層布線技術相互兼容,得到高性能的混合多芯片組件,實現更加高效和靈活的設計和生產。2、LTCC 材料熱導率的影響因素
LTCC 材料導熱載體主要是聲子,熱導率的大小由聲子的平均自由程決定,其導熱性能與它的成分組成和雜質含量、缺陷及孔隙率、顆粒尺寸和結構密度、熱處理程序等因素有關。為了提升材料的熱導率往往會采用提升材料純度與密度、減少氣孔及缺陷的產生、合理的熱處理程序及在晶體內部構建導熱通道等方式來提升材料性能。原料成分和配比的不同影響著 LTCC 材料的熱導率盡管LTCC材料具有比普通PCB基板更好的導熱性,但由于其玻璃相較多,其熱導率僅為 2.0~2.5W/(m·K) 為了滿足更加高效、節能的需求,提升 LTCC 材料熱導率,采用的最普遍的方式是組分摻雜。一些材料在制備過程中會出現晶粒生長異常等狀況,填料的加入能有效改變析晶速度、延緩離子遷移速率、提高熱導率。同時,某些特殊物料的加入還可以在材料內部構筑高導熱網絡,提升材料導熱性能。
在制備 LTCC 材料時需要通過燒結來提升性能,在此過程中由于胚體中含有雜質和較多的玻璃相,其內部會產生氣孔。孔徑的大小直接影響材料內部熱能的傳輸效率,孔徑越大,熱能傳輸得越快;氣孔分布的均勻性影響材料內部的熱能傳輸的均勻性;氣孔間相互連通的方式直接決定了材料內部熱能的傳輸通道。材料的內部缺陷和顯微結構會影響聲子的傳播使熱導率發生改變。缺陷會產生引起聲子散射的中心,降低聲子的平均自由程和導熱系數。因此,在制備 LTCC 材料時可以采取增加燒結時間和添加燒結助劑等方式來減少缺陷的產生。LTCC 材料的導熱性很大程度上取決于所加入的物料,但在燒結過程中這些物料會與原物質發生物理化學反應,使其內部結構改變,產生缺陷。因此,在選取原料時應注意所添加物料對 LTCC 材料的結構變化影響。制備 LTCC 材料的流程中,熱處理是最重要的一步。在此過程中會發生一系列的物理化學變化,影響材料的顯微結構。熱處理的燒結溫度、升溫速率、保溫時間都對材料的內部結構有一定影響,這也導致在不同條件下熱處理過的材料熱導率有所不同。LTCC 材料的性能主要受所析出晶相種類、結晶度及晶粒尺寸等因素影響,合理的熱處理溫度和時間能夠有效促進玻璃的析晶,增加結晶度,使晶粒尺寸變大,進而提升熱導率。來源:《高導熱低溫共燒陶瓷(LTCC)材料的研究進展》,肖楠,等.艾邦建有LTCC交流群,誠邀LTCC生產企業、設備、材料企業參與。
長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入LTCC交流群。
The 2nd Ceramic Packages Industry Forum河北·石家莊
序號 | 暫定議題 | 擬邀請 |
1 | 集成電路陶瓷封裝的發展概況 | 擬邀請陶瓷封裝廠商/高校研究所 |
2 | 光通信技術的發展及陶瓷封裝外殼的應用趨勢 | 擬邀請光通信企業/封裝廠商/高校研究所 |
3 | 電子封裝陶瓷的研究進展 | 擬邀請陶瓷封裝廠商/高校研究所 |
4 | 陶瓷封裝技術在傳感器領域的應用 | 擬邀請陶瓷封裝廠商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封裝技術 | 擬邀請陶瓷封裝廠商/高校研究所 |
6 | 集成電路陶瓷封裝外殼仿真設計 | 擬邀請陶瓷封裝廠商/高校研究所 |
7 | 系統級封裝用陶瓷材料研究進展和發展趨勢 | 擬邀請陶瓷封裝廠商/高校研究所 |
8 | 基于3D-SiP集成技術的新型微波模塊 | 擬邀請陶瓷封裝廠商/高校研究所 |
9 | 陶瓷封裝結構優化及可靠性分析 | 擬邀請陶瓷封裝廠商/高校研究所 |
10 | 低溫玻璃-陶瓷封裝技術的研究進展 | 擬邀請陶瓷封裝廠商/高校研究所 |
11 | 低溫共燒陶瓷基板及其封裝應用 | 擬邀請陶瓷封裝廠商/高校研究所 |
12 | 微電子陶瓷封裝的金屬化技術 | 擬邀請陶瓷封裝廠商/高校研究所 |
13 | 高溫共燒陶瓷金屬化膜厚影響因素分析 | 擬邀請陶瓷封裝廠商/高校研究所 |
14 | 銅漿在多層陶瓷封裝外殼制備技術中的應用 | 擬邀請陶瓷封裝/漿料廠商/高校研究所 |
15 | 電子陶瓷封裝用玻璃粉的開發 | 擬邀請陶瓷封裝/玻璃粉廠商/高校研究所 |
16 | 金屬陶瓷膠黏劑封裝工藝及可靠性研究 | 擬邀請陶瓷封裝/材料廠商/高校研究所 |
17 | 陶瓷封裝外殼釬焊工藝研究 | 擬邀請釬焊設備企業/高校研究所 |
18 | 高密度陶瓷封裝外殼散熱問題探討 | 擬邀請陶瓷封裝/材料廠商/高校研究所 |
19 | 陶瓷封裝平行縫焊工藝與技術 | 擬邀請陶瓷封裝/設備廠商/高校研究所 |
20 | 陶瓷封裝缺陷自動檢測技術 | 擬邀請檢測方案商 |
更多議題征集中,歡迎自擬或者推薦議題。演講&贊助&會議報名請聯系李小姐:18124643204(同微信)方式一:加微信
李小姐:18124643204(同微信)
郵箱:lirongrong@aibang.com
掃碼添加微信,咨詢展會詳情


https://www.aibang360.com/m/100216?ref=196271點擊閱讀原文,即可在線報名!
原文始發于微信公眾號(艾邦陶瓷展):影響低溫共燒陶瓷(LTCC)材料熱導率的關鍵因素分析