隨著電子設備功耗越來越高、小型化集成化更為突出和頻率越來越高,要求封裝產品更高的散熱效果、更為密集的布線電路、更低的損耗,因此在封裝材料以及制作工藝方面需要不斷的創新。艾邦建有陶瓷封裝全產業鏈微信群,歡迎陶瓷封裝產業鏈上下游加入,請您識別二維碼加入。長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊1.厚膜工藝和薄膜工藝各有千秋
在電子封裝領域,陶瓷厚膜產品與薄膜產品由于其各自的特點都有較為廣泛的應用。●?陶瓷厚膜工藝的優勢是多層布線容易,能夠很好地實現三維互聯,但是其金屬化由于絲網印刷工藝的限制平整度較差,微波傳輸損耗較大,線寬與線間距很難突破30μm。●?陶瓷薄膜工藝則很容易實現 20μm 線寬線間距,滿足高密度布線,并且金屬化平整度較高,微波傳輸損耗小,其缺點是布線層數限制難以突破,多層布線難度相對較大。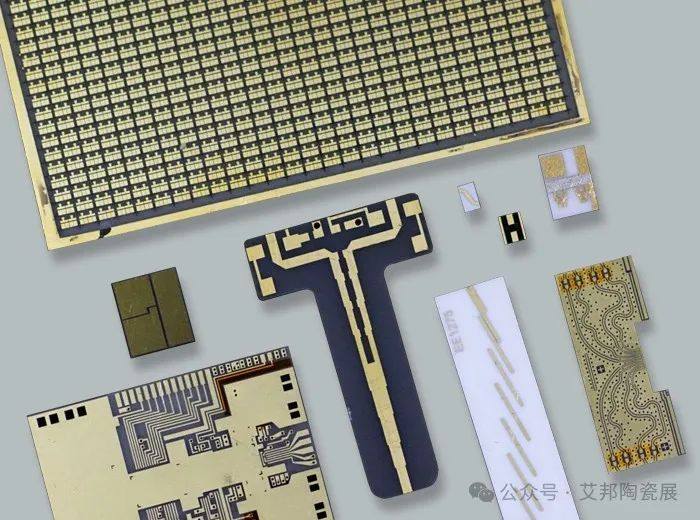
受到加工方式的限制,多層共燒陶瓷(HTCC/LTCC)在高可靠系統級封裝領域中存在平面度較大(>30μm)、最小線寬較大(>50μm)等問題。這些問題會導致陶瓷基板與芯片無法高可靠連接、封裝密度難以進一步提升,直接限制了陶瓷基板向更高密度封裝領域發展。與厚膜陶瓷加工工藝不同,薄膜工藝主要采用光刻、刻蝕、沉積等方式進行,具有無收縮、可制作納米級精細線條、沉積方式選擇多等優勢。若將半導體制造工藝與多層共燒陶瓷技術相結合,有望獲得性能更好的產品以滿足未來高密度集成電路封裝需求。2.多層共燒陶瓷薄厚膜基板制作工藝流程
HTCC薄厚膜基板結構一般由 HTCC與 HTCC表面薄膜金屬化布線兩部分組成,結構中心為 HTCC,上下表面為薄膜金屬化布線。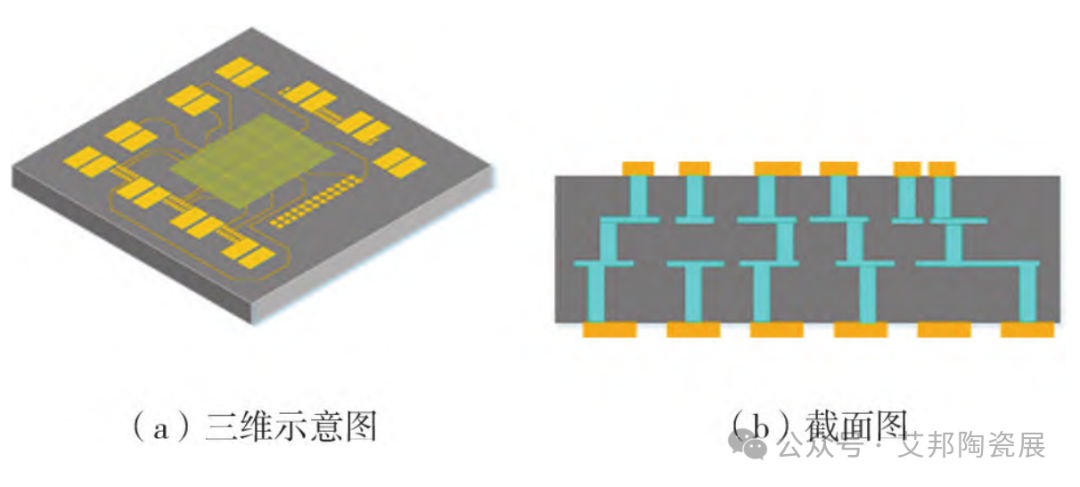
首先通過HTCC工藝進行陶瓷多層基板的加工,包括通孔制作和內部線路制作,再通過研磨、拋光等處理,獲得平整、光潔的陶瓷基板,使表面粗糙度達到薄膜電路制作的要求,再利用薄膜工藝分別對 HTCC基板正背面進行精細線條制作。采用氧化鋁/氮化鋁生瓷帶和厚膜金屬漿料作為主要原材料,通過絲網印刷的方式將金屬漿料印刷在生瓷帶上構成金屬電路,并采用通孔填孔的方式使上下層導通,再進行多片疊層,最后經過高溫燒結(溫度在1800℃以上)、表面處理,形成一個三維布線系統的單片結構(HTCC基板)。
薄膜工藝流程包括清洗磨拋后的 HTCC基板,進行烘干,利用磁控濺射在陶瓷基板表面沉積一層金屬種子層,并在其表面利用光刻膠進行圖形化制作,將需要電鍍的區域裸露出來;光刻膠圖形化后,利用電鍍工藝進行金屬層增厚;電鍍完成后去除光刻膠,利用刻蝕劑將沉積的種子層去除即可完成單面金屬化制作。之后將制作完成的表面進行保護,利用相同的工藝進行另一表面圖形化制作。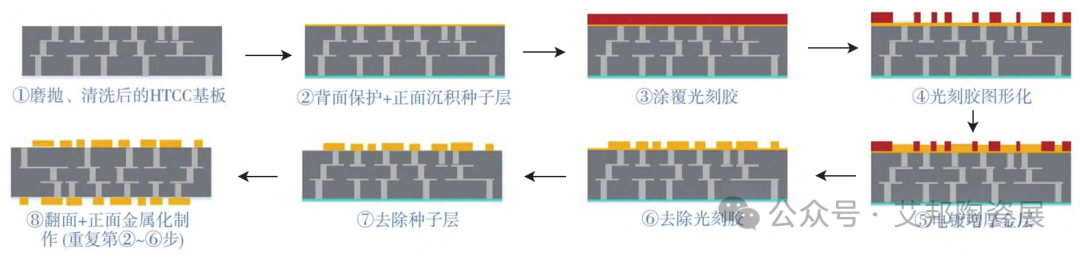
在制造過程中,最為重要的環節是 HTCC與金屬化薄膜的結合。因此,HTCC基板的表面處理與表面薄膜金屬化的制作尤為重要。HTCC的表面處理決定了 HTCC表面特性是否滿足后續薄膜金屬化工藝條件,薄膜金屬化工藝則決定了薄厚膜 HTCC陶瓷基板精細布線能力及薄膜與 HTCC的結合力。3.多層共燒陶瓷薄厚膜基板的應用
多層共燒陶瓷薄厚膜電路基板是一種理想的大規模集成電路散熱基板和封裝材料,具有結構強度高、耐高溫、導熱性能好、布線密度高、物理化學性質穩定等優點,可應用于光通信800G高速光模塊、微波射頻、功率器件、T/R組件等領域。1.多通孔高精度薄厚膜AlN基片制造技術,楊春燕,等.2.多層薄厚膜 HTCC 微系統封裝基板的制備技術研究,于斐,等.艾邦建有陶瓷封裝全產業鏈微信群,歡迎陶瓷封裝產業鏈上下游加入,請您識別二維碼加入。長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊The 2nd Ceramic Packages Industry Forum河北·石家莊
一、會議議題 序號 | 暫定議題 | 擬邀請 |
1 | 集成電路陶瓷封裝的發展概況 | 擬邀請陶瓷封裝廠商/高校研究所 |
2 | 光通信技術的發展及陶瓷封裝外殼的應用趨勢 | 擬邀請光通信企業/封裝廠商/高校研究所 |
3 | 電子封裝陶瓷的研究進展 | 擬邀請陶瓷封裝廠商/高校研究所 |
4 | 陶瓷封裝技術在傳感器領域的應用 | 擬邀請陶瓷封裝廠商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封裝技術 | 擬邀請陶瓷封裝廠商/高校研究所 |
6 | 集成電路陶瓷封裝外殼仿真設計 | 擬邀請陶瓷封裝廠商/高校研究所 |
7 | 系統級封裝用陶瓷材料研究進展和發展趨勢 | 擬邀請陶瓷封裝廠商/高校研究所 |
8 | 基于3D-SiP集成技術的新型微波模塊 | 擬邀請陶瓷封裝廠商/高校研究所 |
9 | 陶瓷封裝結構優化及可靠性分析 | 擬邀請陶瓷封裝廠商/高校研究所 |
10 | 低溫玻璃-陶瓷封裝技術的研究進展 | 擬邀請陶瓷封裝廠商/高校研究所 |
11 | 低溫共燒陶瓷基板及其封裝應用 | 擬邀請陶瓷封裝廠商/高校研究所 |
12 | 微電子陶瓷封裝的金屬化技術 | 擬邀請陶瓷封裝廠商/高校研究所 |
13 | 高溫共燒陶瓷金屬化膜厚影響因素分析 | 擬邀請陶瓷封裝廠商/高校研究所 |
14 | 銅漿在多層陶瓷封裝外殼制備技術中的應用 | 擬邀請陶瓷封裝/漿料廠商/高校研究所 |
15 | 電子陶瓷封裝用玻璃粉的開發 | 擬邀請陶瓷封裝/玻璃粉廠商/高校研究所 |
16 | 金屬陶瓷膠黏劑封裝工藝及可靠性研究 | 擬邀請陶瓷封裝/材料廠商/高校研究所 |
17 | 陶瓷封裝外殼釬焊工藝研究 | 擬邀請釬焊設備企業/高校研究所 |
18 | 高密度陶瓷封裝外殼散熱問題探討 | 擬邀請陶瓷封裝/材料廠商/高校研究所 |
19 | 陶瓷封裝平行縫焊工藝與技術 | 擬邀請陶瓷封裝/設備廠商/高校研究所 |
20 | 陶瓷封裝缺陷自動檢測技術 | 擬邀請檢測方案商 |
21 | 傳感器技術的發展及陶瓷封裝的應用趨勢 | 擬邀請傳感器/封裝廠商/高校院所 |
22 | 紅外探測器技術的發展及陶瓷封裝的應用趨勢 | 擬邀請探測器/封裝廠商/高校院所 |
更多議題征集中,歡迎自擬或者推薦議題。演講&贊助&會議報名請聯系李小姐:18124643204(同微信)方式一:加微信
李小姐:18124643204(同微信)
郵箱:lirongrong@aibang.com
掃碼添加微信,咨詢展會詳情


https://www.aibang360.com/m/100216?ref=196271點擊閱讀原文,即可在線報名!
原文始發于微信公眾號(艾邦陶瓷展):厚膜工藝+薄膜工藝,高精度HTCC薄厚膜基板了解一下