新冠疫情以來,中國市場因持續釋放發展的動力、潛能和韌性展現出對外吸引力。日前中國貿促會發布的《2022年第三季度中國外資營商環境調研報告》顯示,中國已經成為諸多外資企業全球業務發展的動力與引擎,絕大多數外資企業看好在華長期發展前景。

在中德建交50周年之際,作為最早進入中國市場的德國企業之一,賀利氏電子在中國合資企業賀利氏招遠(常熟)電子材料有限公司(簡稱“常熟公司”)也迎來了二十周年慶。“常熟公司就像一面鏡子,是中國工業在過去20年里飛速發展的見證。從最開始將國外研發好的產品拿到中國銷售,隨后在本地建立起了制造的技能,到現在已經成為一個達到全球水準的生產基地,并與國際接軌。”賀利氏電子中國銷售副總裁兼中國合資公司副總經理沈仿忠在常熟公司20周年慶典上表示,“當前半導體行業正處于黃金時代,低碳化和數字化著驅動市場進一步迅猛發展。”
第三代半導體走向主流,功率模塊封裝材料迎接新挑戰
在國內5G通信、新能源汽車、人工智能、工業互聯網、大數據、光伏等行業快速發展的大趨勢下,以及“碳達峰、碳中和”綠色低碳戰略不斷推進,隨著雙碳戰略的不斷推進,提升能源利用效率和能源轉換效率已經成為各行各業的共識,新能源汽車、光伏發電等市場迎來新一輪的快速發展時期。
沈仿忠指出,在此趨勢下,以碳化硅、氮化鎵為代表的寬禁帶半導體(第三代半導體)成為市場炙手可熱的新賽道,而其規模化應用進一步推動了功率模塊中封裝材料的變革。“寬禁帶功率器件相比硅基功率器件功率要大得多,因而通常伴隨著較高的工作溫度,在封裝過程中同樣需要能滿足更高熔化溫度,更強抗疲勞強度,高熱導率并且低電阻率的連接材料,以保證器件良好的散熱性能、可靠性和使用壽命。”他指出,“這一變化使得功率器件,無論是起支撐作用的電路板(金屬絕緣基板)、起電氣連接作用的互連材料(燒結銀焊接),還是起散熱作用的界面熱導材料等整個材料體系都需要創新的解決方案。”
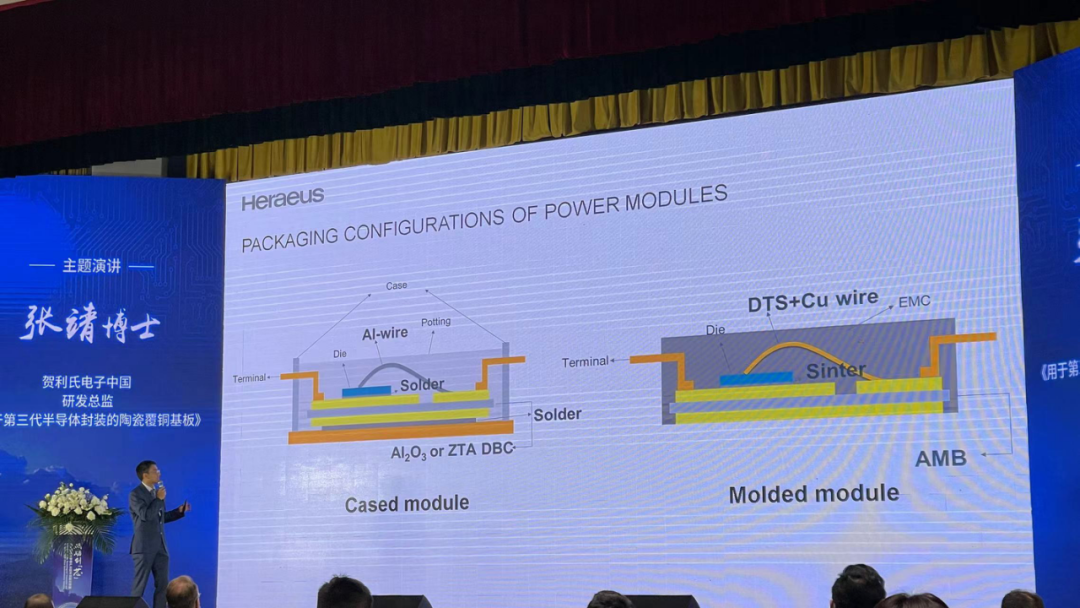
比如硅基IGBT通常使用氧化鋁陶瓷基板熱導率相對低,韌性低,與硅的熱膨脹系數匹配不好,并不適合作為高功率模塊封裝材料,因而碳化硅MOSFET轉向各類氮化鋁、氮化硅等復合陶瓷基板,覆銅板從直接覆銅工藝(DBC)轉向活性金屬焊接工藝(AMB);焊料方面,傳統功率器件所使用的軟焊料和錫膏就很難滿足低工藝溫度、高工作溫度,很好的導電性和散熱性能等要求,為此具備優越熱導率和更長使用壽命的無鉛燒結銀技術應運而生。此外,新能源汽車、光伏發電以及工業等應用環境特別嚴苛的領域,對能夠賦予電路和元器件更佳質量和可靠性的厚膜技術需求越來越多。
賀利氏電子中國研發總監張靖總結說,走向第三代半導體材料的功率器件,要在功率、頻率等性能瓶頸上實現突破,不管是工作溫度、散熱性能,還是可靠性,都需要相關封裝材料來解決。
中國新能源汽車進入新階段,創新材料解決方案日益緊迫
中國作為全球新能源汽車和光伏太陽能產業發展最為迅猛的地區,越來越多的本土制造商正在憑借出色的產品力獲得國外市場的認可,例如比亞迪、蔚來、上汽、紅旗等中國新能源汽車品牌,紛紛吹響出海的號角,最近德國汽車租賃公司Sixt一口氣下單10萬輛比亞迪電動汽車更是轟動了全球汽車行業。
“我認為這標志著中國新能源汽車品牌發展已經進入新的階段,新能源車巨大的市場前景,特別是最核心的動力電池實現全球領先,加之在汽車智能化方面的快速進步,成為中國新能源汽車品牌出海的底氣。”張靖表示,“新能源汽車的蓬勃發展無疑將打開碳化硅功率器件的巨大應用市場。Yole的數據顯示,2019年~2025年期間功率模塊市場將以9.1%的年復合增速進入快速增長階段,未來碳化硅功率模塊將成為新能源汽車的主流方案。相應的功率模塊封裝材料市場也將迎來激增,市場規模從2019年的14.7億美元增長至2025年的27.1億美元,年復合增速達10.7%。其中基板市場增速最為迅猛,年復合增速達到12.6%,2025年將達到6.15億美元。”

圍繞第三代半導體,賀利氏電子著力于研發除了晶圓以外的整體封裝解決方案,包括燒結銀材料和各類金屬陶瓷基板等出色的封裝產品和解決方案。更重要的是,在改善芯片性能方面,賀利氏電子推出了獨有的Die Top System(DTS)材料解決方案系統,通過材料的創新,充分優化電力電子模塊的性能,還能簡化工業化生產,很大程度提高盈利能力,加快客戶新一代電力電子模塊的上市步伐。此外,賀利氏電子還提供工程服務,確保客戶可以快速導入最新的材料解決方案,并迅速做出產品原型,以抓住瞬息萬變的市場的機會。
“伴隨著中國新能源汽車產業的迅速崛起,越來越多的本土廠商找到賀利氏電子,希望我們與之進行相關的合作開發,或者將我們創新的材料解決方案盡快導入到他們的產品中,在這方面中國廠商的引領趨勢已然十分矚目。”沈仿忠指出,為此賀利氏電子近幾年一直加大中國市場布局,未來還將繼續在電力電子和功率半導體方面加大投資,同時作為國內客戶的創新合作伙伴,憑借完善的應用與測試服務、廣泛的專業知識和全面現場幫助他們縮短產品上市時間。
數字化推動芯片異構集成,封裝材料走向多元化創新
數字化潮流下,5G、AIoT、物聯網等新興產業發展推動了短時間內數據呈現爆炸式增長,向計算提出了巨大的挑戰。面對海量的多樣化數據,突破算力瓶頸,提升算力與降低功耗之間的矛盾,令異構集成正在成為提升芯片算力的重要發展方向,對封裝技術帶來了多樣化的創新途徑以及前所未有的挑戰。
張靖表示,隨著半導體技術的發展,越來越多前道工藝被引入后道工藝當中,兩者的界限變得越來越模糊。隨之而來的是,越來越多超越傳統封裝理念的先進封裝技術被提出。異構集成的封裝技術演進道路上,從FC、SiP、WLP再到2.5D/3D封裝以及近來大熱的Chiplet,在微型化趨勢下,先進封裝中的元件數量不斷增加,帶來的功耗、散熱挑戰越來越大,與此同時,原材料成本和激烈的市場競爭也令芯片廠商對總體成本有了更多的顧慮,這些都對封裝材料提出了更高的要求。
“由于在越來越小的空間中集成了更多的功能,先進封裝面臨的熱管理需求與日俱增,散熱性能嚴重關乎芯片乃至終端產品的使用壽命。材料供應商需要通過系統化的創新,提供系統級的解決方案,在不斷降低總體擁有成本的同時幫助客戶將產品性能和功能發揮到極致。”他指出。
為滿足越來越嚴苛的應用要求,賀利氏電子加快創新步伐,帶來了很多深受行業信賴的封裝產品和解決方案。例如面對新能源汽車或消費電子中大功率電子設備的散熱需求,賀利氏推出了mAgic?系列燒結銀材料;面對從引線鍵合封裝到FC封裝,管腳間距需要更細的焊粉,賀利氏電子Welco?技術已更新至8號粉,可滿足線間距小于50μm的倒裝芯片需求;對于傳統的引線鍵合封裝,賀利氏電子新一代的金線替代品AgCoat? Prime鍍金銀線提供兼具高可靠性和性價比的創新方案;為應對環保及可持續發展需求,賀利氏電子還推出了采用100%再生黃金制成的鍵合金線和100%再生錫制成的Welco?系列焊錫膏版本。
“二十年間,常熟公司伴隨著中國半導體產業的發展成長成為中國電子封裝領域領先的材料制造商,到如今我們服務的本土客戶在部分領域已處于世界領先水平,包括5G、新能源汽車、新能源發電(光伏、風電等),還有mini LED、micro LED等產業,中國已經走在了全球前列。”張靖強調,如今賀利氏電子在本土研發出的成品不僅可以在本土市場適用,甚至已走向全球,真正見證了賀利氏電子從“在中國,為中國”到“在中國,為世界”的轉變。
在沈仿忠看來,發生這種轉變的內在原因,一是國內對知識產權的保護、創新環境發生了巨大的變化,其次是這里有最大的市場,巨大的需求,反過來也成為技術創新的最好的沃土。
材料創新從一個想法到產品并導入市場可能需要十年時間,即使是對現有成品進行一些小的調整,有時候也需要花上幾年,因此賀利氏作為材料供應商,需要在非常早期的階段就了解客戶的需求,從而才能更好的在客戶產品中導入材料,實現差異化的競爭力。“而貼近市場,尤其走在行業前端的領域,能更快、準、狠地將客戶最為迫切的需求,轉換成對產品的要求,最終轉化成符合市場趨勢的高品質產品。”
“行穩致遠,依托于強大的研發實力,在保證產品先進性的同時,我們也深入挖掘客戶的實際需求,在產品之外提供了諸如共同研發、工程服務,整合解決方案的多種服務,使我們能夠更加貼近客戶,也希望和客戶一起在未來攜手發展,共創輝煌。”沈仿忠表示。
*本文轉載自集微網 作者朱秩磊
END

原文始發于微信公眾號(賀利氏電子):從引進產品到輸出創新,賀利氏常熟公司20周年見證中國半導體巨變
長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入交流群。