11月30日,第七屆陶瓷封裝管殼產(chǎn)業(yè)論壇將于蘇州舉辦,屆時佳利電子、中電科43所/合肥圣達、合肥芯谷微電子、佛大華康、泓湃科技、上海住榮、德中激光、北京中礎(chǔ)窯爐、禾思眾成等業(yè)內(nèi)知名企業(yè)將帶來精彩報告分享,更多議題征集中,演講&贊助&參會請聯(lián)系李小姐:18124643204(同微信)
預(yù)成型焊片是一種表面平整的焊料薄片,有Au80Sn20、Au88Ge12、Au96.85Si3.15等,常用于陶瓷、可伐合金、芯片、IC封裝、金屬管殼等之間的焊接,廣泛應(yīng)用于包括可靠封裝連接、金屬外殼或陶瓷外殼氣密封裝工藝的焊接等領(lǐng)域。合金焊料熔封工藝中使用最廣泛的是Au80Sn20合金,能適應(yīng)高真空、高強度、耐腐蝕高要求。
一、什么是金錫合金焊片?有何優(yōu)勢?
金錫共晶(Au80wt%Sn20wt%)由金錫中間相δ(AuSn )和密排六方相ζ (Au5Sn)組成,是金錫合金中熔點最低的,具有優(yōu)良的焊接工藝性能和焊接接頭強度。金錫合金熔點280℃,釬焊溫度僅比它的熔點高出20~30℃(即約300~310℃)。在釬焊過程中,基于合金的共晶成分,很小的過熱度就可以使合金熔化并浸潤;另外,合金的凝固過程進行得也很快。因此,金錫合金的使用能夠大大縮短整個釬焊過程周期。作為共晶合金,金錫合金具有細小均勻的晶格,從而有著很高的強度。同時金錫合金焊料的高溫焊接強度也比較高,因而能夠耐受熱沖擊、熱疲勞,能夠在高溫環(huán)境或者溫度變化幅度大的環(huán)境下使用。金錫合金焊料在280℃熔點附近很小的一個范圍內(nèi)完全熔化成流動性很好的液態(tài),因而具有很小的粘滯性,能夠很迅速的鋪展開來,保證焊接的密封性。由于金錫合金焊料是共晶成分,組織細小,焊料強度較高,在接近熔點的時候依然保持有一定的強度,同時抗裂紋擴展能力也很強,所以金錫共晶合金的抗蠕變性能和抗疲勞性能也很優(yōu)良。金錫合金焊料的熱導(dǎo)率為57W/m·k,在軟釬料中屬于較高水平,當(dāng)同樣的厚度焊料情況下,熱阻就小,因此焊接的器件具有良好的導(dǎo)熱性能。由于合金成份中金占了很大的比重(80%),材料表面的氧化程度較低。如果在釬焊過程中采用真空,或還原性氣體如氮氣和氫氣的混合氣,就不必使用化學(xué)助焊劑。具有良好的浸潤性,而對鍍金層又無鉛錫焊料的那種浸蝕現(xiàn)象。金錫合金與鍍金層的成分接近,因而通過擴散對很薄鍍層的浸溶程度很低;同時也沒有像銀那樣的遷徒現(xiàn)象。Au80Sn20?焊料的不足之處是價格較貴,性能較脆,延伸率很小,不易加工。用于微電子封裝的釬焊料有很多形式,常見的焊絲、焊膏以及預(yù)成型焊片等。由于金錫合金的脆性,很難制成連續(xù)、性能均勻并且能夠纏繞的焊絲。預(yù)成型片通常首先將焊料制成焊料片,然后通過機械沖裁、剪切制成所需的焊片形狀,能夠確保釬焊料的精確用量和準確位置,以達到在最低成本情況下獲得最佳的質(zhì)量。預(yù)成型焊片最早在上世紀60年代應(yīng)用于一些元器件如金屬封裝的鉭電容,現(xiàn)在主要用于一些無源器件、光電器件的生產(chǎn)及封裝。1)采用預(yù)制成型焊片工藝,能夠精確控制釬焊料用量、成分和表面狀態(tài)。通過合理設(shè)計預(yù)制成型焊片的厚度和形狀,精確控制焊料的使用量,用最少的焊料量,滿足最好的焊接要求,在保證焊接質(zhì)量的情況下將焊接成本大幅降低。2)通常采用預(yù)制成型焊片工藝是在保護氣氛中進行,在這種條件下,可以免除使用易污染和難以控制的助焊劑,免除焊接后成本很高的清洗過程,節(jié)約成本,減少環(huán)境污染。3)通過合理設(shè)計的預(yù)成型焊片通常能以最小的成本形成很好的焊接效果,使焊接接頭獲得很高的電學(xué)性能和焊接成品率,所以預(yù)成型焊片焊接工藝是高可靠、高導(dǎo)熱封裝的理想焊接工藝。4)對于需要連接的基板材料的變化和特殊性能或環(huán)境保護的要求,對金錫焊料預(yù)成型片幾乎不受任何限制。二、金錫焊片在陶瓷封裝管殼的應(yīng)用
Au80Sn20等合金焊料密封不僅能用于各類高可靠IC,也能用于MEMS中慣性陀螺等并滿足高真空、低漏率;也能用在PHEMT結(jié)構(gòu)GaAs器件的密封腔內(nèi),滿足氫含量低的要求。在綜合考慮外殼和蓋板成本、適應(yīng)多種類型器件、密封工藝設(shè)備投入、成品率、可靠性等因素,合金焊料熔封工藝是首選。氣密電子封裝產(chǎn)品的一部分需要焊接到一些陶瓷部件上。主要是考慮陶瓷具有一些金屬件無法達到的物理性能如低熱膨脹系數(shù)、電絕緣、高強度等。金錫預(yù)成型焊片在陶瓷封裝的應(yīng)用有:1)當(dāng)有源器件芯片和基板兩者都需要具有低熱膨脹系數(shù)時把有源器件芯片粘接到一個外殼內(nèi)。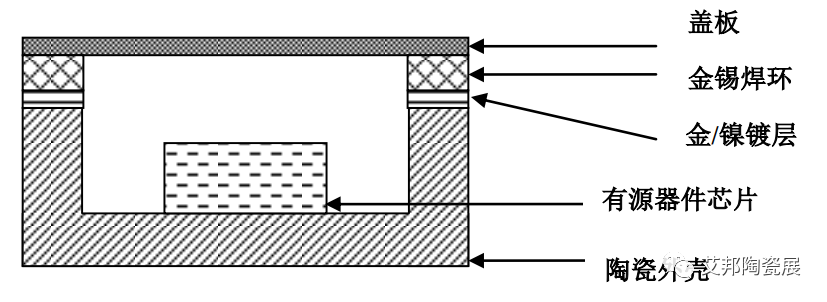
圖? 金錫合金預(yù)成型片用于陶瓷封裝氣密封蓋示意圖2)封蓋,即把一個金屬或玻璃的蓋板密封到陶瓷外殼上。采用一定厚度,形狀為不封閉框架的金錫預(yù)成型片。對于封蓋,一般會采用平行縫焊機對連接處局部加熱,在平行縫焊過程中金錫焊片受熱熔化與陶瓷表面金屬緊密結(jié)合。這樣對封裝內(nèi)用金錫合金釬焊的有源器件芯片將不會受到影響。3)引線絕緣子的焊接。采用高強度的陶瓷做絕緣體,要求釬焊材料具有良好的潤濕性、抗腐蝕性和高的楊氏模量等。采用金錫合金焊接的器件能夠經(jīng)受得起長時間的熱應(yīng)力循環(huán)。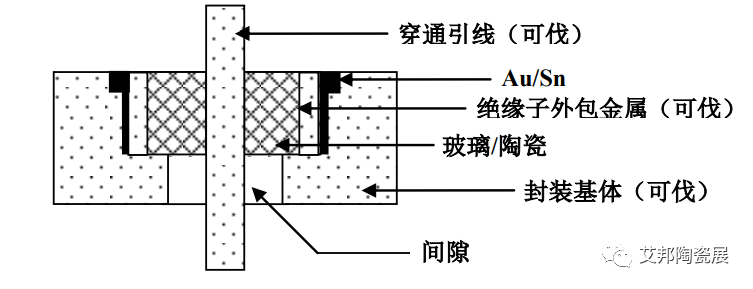
圖??金錫合金預(yù)成型片在光電封裝中的應(yīng)用在光電器件如發(fā)射器、接收器及放大器等封裝中的穿通粘接中,墊圈型金錫預(yù)成型片也是一種最好的選擇。在連接過程中,熔化的金錫墊圈在毛細作用下會填充在絕緣子外導(dǎo)體和封裝基體(兩者皆由可伐合金制造并鍍以鎳和金)之間的間隙,由于絕緣子和基體之間的空隙很小,過多的釬焊料會造成短路。作為預(yù)成型片的優(yōu)點之一,精確數(shù)量的金錫釬焊料可做成墊圈型預(yù)成型片以防止短路。利用金錫合金預(yù)成型焊片制作預(yù)置金錫蓋板/殼體,即將金錫預(yù)成型焊片精確定位并點焊后,固定在合金或陶瓷殼體上,解決了傳統(tǒng)工藝存在的定位問題,并且縮短了封裝工藝流程,廣泛應(yīng)用在混合集成電路、半導(dǎo)體集成電路、微波器件、傳感器、光電器件的陶瓷外殼氣密封裝等領(lǐng)域。艾邦建有陶瓷封裝全產(chǎn)業(yè)鏈微信群,歡迎陶瓷封裝產(chǎn)業(yè)鏈上下游掃碼加群與我們交流。
長按識別二維碼關(guān)注公眾號,點擊下方菜單欄左側(cè)“微信群”,申請加入群聊
?
The?7th Ceramic Packages?Industry Forum(虎丘區(qū)城際路21號 近高鐵蘇州新區(qū)站)序號 | 暫定議題 | 擬邀請 |
1 | 多層陶瓷高溫共燒關(guān)鍵技術(shù)介紹 | 佳利電子 總經(jīng)理 胡元云 |
2 | 氮化鋁陶瓷封裝材料現(xiàn)狀及技術(shù)發(fā)展趨勢 | 中電43所/合肥圣達 研究員級高工 張浩 |
3 | 半導(dǎo)體芯片管殼封裝及設(shè)備介紹 | 佛大華康 董事長 劉榮富 |
4 | HTCC陶瓷封裝用配套電子材料的匹配性問題研究 | 泓湃科技 CEO 陳立橋 |
5 | 多層共燒陶瓷燒結(jié)關(guān)鍵技術(shù)探討 | 北京中礎(chǔ)窯爐 |
6 | 陶瓷封裝管殼行業(yè)視覺檢測方案 | 禾思眾成 |
7 | 多層陶瓷關(guān)鍵設(shè)備技術(shù) | 上海住榮 |
8 | 集成電路陶瓷封裝外殼仿真設(shè)計 | 合肥芯谷微 研發(fā)總監(jiān) 胡張平 |
9 | 激光技術(shù)在陶瓷封裝管殼領(lǐng)域的應(yīng)用 | 德中技術(shù) |
10 | 多層共燒金屬化氮化鋁陶瓷工藝研究 | 待定 |
11 | 陶瓷封裝外殼在光通信領(lǐng)域的應(yīng)用趨勢 | 擬邀請十三所/三環(huán) |
12 | 多層陶瓷封裝外殼的生產(chǎn)工藝和可靠性設(shè)計 | 擬邀請東瓷科技/宜興電子器件總廠 |
13 | 基于HTCC的高可靠性封裝技術(shù) | 擬邀請河北鼎瓷/燦勤科技 |
14 | 等離子清洗在高密度陶瓷封裝外殼上的應(yīng)用 | 擬邀請吉康遠景/東信高科/納恩科技/深圳正陽/晟鼎精密 |
15 | HTCC高溫共燒陶瓷用生瓷帶的開發(fā) | 擬邀請六方鈺成 |
16 | B-stage膠水在管殼封裝中的應(yīng)用 | 擬邀請佛山華智 |
更多議題征集中,演講&贊助請聯(lián)系李小姐:18124643204(同微信)
?
方式一:加微信
注意:每位參會者均需要提供信息
方式二:長按二維碼掃碼在線登記報名

或者復(fù)制網(wǎng)址到瀏覽器后,微信注冊報名
https://www.aibang360.com/m/100179?ref=196271
原文始發(fā)于微信公眾號(艾邦陶瓷展):金錫預(yù)成型焊片在陶瓷封裝外殼中的應(yīng)用