多層陶瓷外殼以其優(yōu)良的性能被廣泛應(yīng)用于航天、航空、軍事電子裝備及民用電子產(chǎn)品的集成電路和電子元器件的封裝。常用的陶瓷外殼有集成電路陶瓷外殼,如 D 型 (DIP )、F (FP )、G 型 (PGA )、Q 型 (QFP )、C 型 (LCC )、BGA 型等;混合集成電路陶瓷外殼;光電器件陶瓷外殼;微波器件陶瓷外殼;聲表面波器件陶瓷外殼;晶體振蕩器陶瓷外殼;固體繼電器 陶瓷外殼及各種傳感器(如霍爾傳感器)用陶瓷外殼等等。
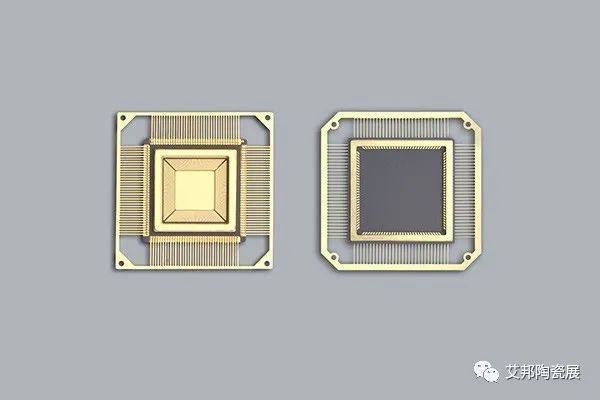
圖 CQFP,圖源宜興電子器件總廠
多層陶瓷外殼采用多層陶瓷金屬化共燒工藝進(jìn)行生產(chǎn)。多層陶瓷外殼分為高溫共燒陶瓷外殼(HTCC)和低溫共燒陶瓷外殼(LTCC)兩類(lèi)。多層陶瓷外殼由于其體積小、導(dǎo)熱性好、密封性好、機(jī)械強(qiáng)度高,因其封裝可靠性高而得到廣泛應(yīng)用。但是,在使用中仍然會(huì)出現(xiàn)失效。本文就HTCC高溫共燒多層陶瓷外殼的失效模式、失效機(jī)理進(jìn)行分析介紹。艾邦建有陶瓷封裝全產(chǎn)業(yè)鏈微信群,歡迎陶瓷封裝產(chǎn)業(yè)鏈上下游掃碼加群與我們交流。

一、多層陶瓷外殼的失效模式
多層陶瓷外殼在生產(chǎn)和使用中出現(xiàn)的失效模式通常有以下幾種:
(1)在機(jī)械試驗(yàn)中出現(xiàn)陶瓷底座斷裂失效;
(2)在使用中出現(xiàn)絕緣電阻小于標(biāo)準(zhǔn)規(guī)定值,出現(xiàn)失效;
(3)在使用中外殼出現(xiàn)斷、短路失效;
(4)在使用中出現(xiàn)外殼外引線脫落,或無(wú)引線外殼的引出端焊盤(pán)與外電路連接失效;
(5)使用中出現(xiàn)電鍍層銹蝕失效;
(6)使用中出現(xiàn)密封失效;
(7)鍵合和芯片剪切失效;
(8)使用不當(dāng)造成失效。
二、多層陶瓷外殼的失效機(jī)理分析
1、陶瓷底座的斷裂失效
其主要失效機(jī)理如下:
(1)由于所采用的陶瓷材料的抗彎強(qiáng)度不足;
(2)在生產(chǎn)過(guò)程中偏離了規(guī)定的工藝參數(shù)。例如:層壓中未將各層生陶瓷片壓成一個(gè)整體,降低了陶瓷底座的機(jī)械強(qiáng)度;在燒結(jié)過(guò)程中,由于燒結(jié)溫度過(guò)高或過(guò)低而造成陶瓷底座過(guò)燒或生燒,從而降低了陶瓷底座的機(jī)械強(qiáng) 度所致;
(3)由于結(jié)構(gòu)設(shè)計(jì)錯(cuò)誤,在設(shè)計(jì)外殼底座的底板時(shí),底板取值太小,使底板 過(guò)薄。因此,產(chǎn)品在機(jī)械試驗(yàn)時(shí),造成外殼芯腔部位應(yīng)力集中,從而出現(xiàn) 外殼底座斷裂失效。
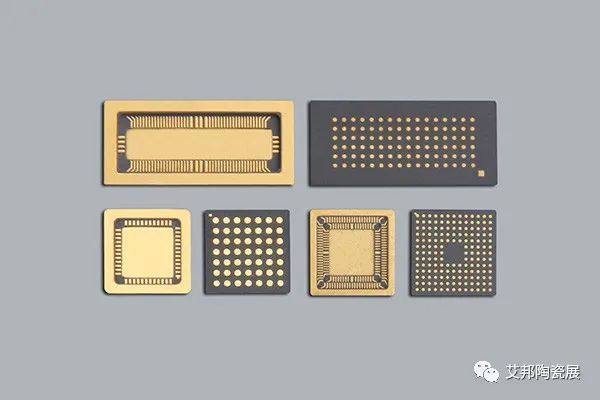
圖 CLGA封裝,圖源宜興電子器件總廠
2、絕緣電阻失效
其主要失效機(jī)理如下:
(1)所采用的陶瓷材料的體積電阻率和絕緣強(qiáng)度不夠,使產(chǎn)品的絕緣電阻達(dá)不到標(biāo)準(zhǔn)規(guī)定的要求;
(2)在印刷生產(chǎn)過(guò)程中,偏離了規(guī)定的工藝參數(shù),例如金屬漿的黏度不符合規(guī)定或印刷機(jī)的工藝參數(shù)不對(duì),使印刷線條之間發(fā)生短路或接近短路,導(dǎo)致絕緣電阻失效;
(3)在印刷生產(chǎn)過(guò)程中,由于操作者不注意工藝衛(wèi)生,造成印刷線條之間發(fā)生短路或接近短路,導(dǎo)致絕緣電阻失效;
(4)在電鍍后的清洗過(guò)程中,由于未充分清洗干凈,殘留的鍍液電介質(zhì)導(dǎo)致絕緣電阻值下降,導(dǎo)致絕緣電阻失效。
3、斷、短路失效
1)有引線外殼的斷、短路失效
(1)層間互連失效造成了外殼的斷路失效:例如:互連孔金屬化填料不足,層壓時(shí)工藝參數(shù)不符合規(guī)定,形成分層現(xiàn)象,造成上下層之間不能連接,造成層間互連斷路失效;
(2)印刷金屬化線路時(shí),線間短路,引起了外殼短路失效。例如:金屬漿的黏度不符合規(guī)定或印刷機(jī)的工藝參數(shù)不對(duì);操作者不注意工藝衛(wèi)生,造成 印刷線條之間發(fā)生短路,從而引起了外殼短路失效。
2)無(wú)引線外殼的斷、短路失效
(1)在平面印刷時(shí),印刷線路與引出端通孔連接斷路;在引出端通孔孔壁金屬化時(shí),引出端通孔內(nèi)壁掛漿不連續(xù);在印刷底面引出端焊盤(pán)時(shí),焊盤(pán)未與引出端通孔的金屬漿連接;在層壓時(shí),由于層壓工藝參數(shù)控制不當(dāng),使引出端通孔內(nèi)分層使引出端通孔金屬化產(chǎn)生斷裂,因而造成了外殼的斷路失效。
(2)印刷金屬化線路時(shí),線間短路,引起了外殼短路失效。
4、外引線脫落失效或無(wú)引線外殼的引出端焊盤(pán)與外電路連接失效
1)有引線外殼的外引線脫落失效
(1)釬焊引線的金屬化焊盤(pán)的金屬化強(qiáng)度不夠,而造成這一問(wèn)題的原因:
①金屬化配方本身的金屬化強(qiáng)度低,
②金屬化層的厚度偏薄造成金屬化強(qiáng)度低,
③外殼陶瓷底座在燒結(jié)時(shí)溫度過(guò)高或過(guò)低造成金屬化強(qiáng)度低;
(2)陶瓷底座在釬焊前進(jìn)行化學(xué)鍍鎳時(shí),鍍鎳層偏薄,使焊料與金屬化焊盤(pán)的浸潤(rùn)性差,導(dǎo)致引線的抗拉強(qiáng)度差;
(3)釬焊工藝不符合要求,造成這一問(wèn)題的原因:
①釬焊裝配模具不符合要求使引線的裝配偏離焊盤(pán)或未與焊盤(pán)接觸到位,
②釬焊溫度過(guò)高造成焊料流失或溫度過(guò)低焊料熔融不夠,這些問(wèn)題均會(huì)造成外引線的抗拉強(qiáng)度差;
(4)釬焊引線的焊料量不足,造成引線不能與焊盤(pán)完全釬焊好,降低了外引線的抗拉強(qiáng)度。
2)無(wú)引線外殼的引出端焊盤(pán)與外電路連接失效
(1)引出端金屬化焊盤(pán)的金屬化強(qiáng)度不夠,而造成這一問(wèn)題的原因:
①金屬化配方本身的金屬化強(qiáng)度低,
②金屬化層的厚度偏薄造成金屬化強(qiáng)度低,
③外殼陶瓷底座在燒結(jié)時(shí)溫度過(guò)高或過(guò)低造成金屬化強(qiáng)度低;
(2)在電鍍中,由于鍍金和鍍鎳層偏薄,使用戶(hù)在釬焊時(shí),金和鎳很快與焊料熔為合金,導(dǎo)致焊料與金屬化焊盤(pán)的浸潤(rùn)性差,從而使焊盤(pán)與外電路連 接失效。
5、電鍍層銹蝕失效
其主要失效機(jī)理如下:
(1)電鍍配方選擇不當(dāng)或所用化學(xué)藥品質(zhì)量差,使鍍液的雜質(zhì)含量高,造成 鍍層內(nèi)的雜質(zhì)含量高,鍍層的孔隙率高,抗腐蝕能力差;
(2)電鍍工藝或工藝控制不當(dāng),造成鍍層孔隙率高或鍍層的均勻性差,造成 電鍍層失效;
(3)電鍍用純水質(zhì)量差,造成鍍液中雜質(zhì)含量高或清洗不干凈,使電鍍層質(zhì)量及表面質(zhì)量差,造成了電鍍層失效;
(4)鍍層厚度設(shè)計(jì)不合理,使鍍鎳層和鍍金層的抗腐蝕能力差、可焊性差、可鍵合性不好,造成電鍍層失效。
6、密封性失效
其主要失效機(jī)理如下:
(1)布線印刷時(shí),金屬漿厚度太厚,層壓時(shí)金屬漿兩邊不能壓密實(shí),內(nèi)引線兩邊漏氣,造成密封失效;
(2)層壓前印刷好的生陶瓷片太干,使正常的層壓工藝不能將產(chǎn)品壓成一個(gè)密實(shí)的整體,層間漏氣,從而造成密封失效;
(3)層壓工藝參數(shù)控制不當(dāng),使產(chǎn)品不能壓成一個(gè)密實(shí)的整體,形成層間漏氣,從而造成密封失效;
(4)由于封接環(huán)表面平整度差,在采用焊料封蓋時(shí)焊料不足以填滿焊縫造成漏氣,電鍍質(zhì)量差,焊料與封接環(huán)浸潤(rùn)性差造成漏氣;
(5)平行縫焊用蓋板采用的材料厚度不當(dāng)、退火工藝控制不好、電鍍工藝控制不當(dāng),從而造成用戶(hù)平封時(shí),采用正常的平封工藝封蓋時(shí)發(fā)生密封失效。
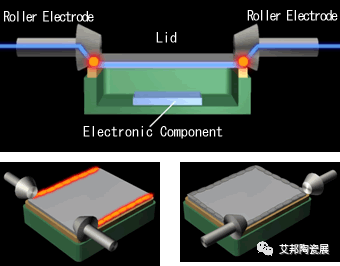
圖 平行縫焊
7、鍵合和芯片剪切失效
其主要失效機(jī)理如下:
(1)由于金屬化強(qiáng)度低,在鍵合時(shí),金屬化層受到破壞,導(dǎo)致鍵合點(diǎn)剝離失效;其次,由于內(nèi)引線和腔底的金屬化表面平整度差,導(dǎo)致鍵合和芯片粘結(jié)強(qiáng)度差,引起失效;
(2)由于外殼在電鍍時(shí),鍍層厚度偏薄或鍍層的均勻性差,使鍵合強(qiáng)度和芯片粘結(jié)強(qiáng)度差,造成鍵合和芯片剪切失效;
(3)由于用戶(hù)在使用中,鍵合工藝參數(shù)不當(dāng),造成鍵合失效;在芯片粘結(jié)時(shí),焊料選用不當(dāng)或粘結(jié)工藝參數(shù)不當(dāng)造成芯片粘結(jié)強(qiáng)度差,造成失效。
8、使用不當(dāng)造成失效
其主要失效機(jī)理為:用戶(hù)在使用過(guò)程中,由于對(duì)外殼的性能及使用要求了解不夠,在儲(chǔ)存、使用過(guò)程中工藝控制不當(dāng);在檢測(cè)、試驗(yàn)過(guò)程中,方法不當(dāng),對(duì)外殼造成破壞性失效。例如:在使用過(guò)程中,直接用手接觸外殼,手上的油污沾染在外殼上,從而造成絕緣電阻、鍍層等失效;在試驗(yàn)過(guò)程中,由于使用的夾具不當(dāng),造成外殼機(jī)械強(qiáng)度失效等等。
多層陶瓷外殼的主要失效模式有以下幾種:陶瓷底座斷裂失效,絕緣電阻失效,斷、短路失效,外引線脫落失效,電鍍層銹蝕失效,密封失效,鍵合和芯片剪切失效和使用不當(dāng)失效,根據(jù)其失效機(jī)理,在外殼的制造和使用過(guò)程中采取措施,以防止多層陶瓷外殼失效的發(fā)生。
文章來(lái)源:湯紀(jì)南.多層陶瓷外殼的失效分析和可靠性設(shè)計(jì)[J].電子與封裝, 2006,6(10):22-26.

長(zhǎng)按識(shí)別二維碼關(guān)注公眾號(hào),點(diǎn)擊下方菜單欄左側(cè)“微信群”,申請(qǐng)加入群聊
?
推薦活動(dòng):【邀請(qǐng)函】第七屆陶瓷封裝產(chǎn)業(yè)論壇(11月30日·蘇州)
蘇州匯融廣場(chǎng)假日酒店
(虎丘區(qū)城際路21號(hào) 近高鐵蘇州新區(qū)站)?
| 時(shí)間安排 | 議題 | 演講單位 |
| 08:45-09:00 | 開(kāi)場(chǎng)致辭 | 艾邦創(chuàng)始人 江耀貴 |
| 09:00-09:30 | 多層陶瓷高溫共燒關(guān)鍵技術(shù)介紹 | 佳利電子 副總 胡元云 |
| 09:30-10:00 | 氮化鋁HTCC封裝材料現(xiàn)狀及技術(shù)發(fā)展趨勢(shì) | 中電科43所/合肥圣達(dá) 研究員 張浩 |
| 10:00-10:30 | 茶 ?歇 | |
| 10:30-11:00 | 三維電鍍陶瓷基板(3DPC)及其封裝應(yīng)用 | 華中科技大學(xué)/武漢利之達(dá) 教授/創(chuàng)始人 陳明祥 |
| 11:00-11:30 | HTCC氫氮?dú)夥諢Y(jié)窯爐 | 北京中礎(chǔ)窯爐 副總經(jīng)理 付威 |
| 11:30-12:00 | 多層共燒陶瓷的增材制造技術(shù) | 中南大學(xué) 教授 王小鋒 |
| 12:00-13:30 | 午 ?餐 | |
| 13:30-14:00 | 微波大功率封裝外殼技術(shù)發(fā)展 | 中電科55所 研究員 龐學(xué)滿 |
| 14:00-14:30 | HTCC陶瓷封裝用配套電子材料的匹配性問(wèn)題研究 | 泓湃科技 CEO 陳立橋 |
| 14:30-15:00 | 芯片管殼等溫空腔封裝 | 佛大華康 總經(jīng)理 劉榮富 |
| 15:00-15:30 | 高速高精度HTCC全工藝流程視覺(jué)檢測(cè)應(yīng)用介紹 | 深圳禾思 CEO 楊澤霖 |
| 15:30-16:00 | 精密激光在LTCC/HTCC加工中的關(guān)鍵技術(shù)及發(fā)展趨勢(shì) | 德中技術(shù) 戰(zhàn)略發(fā)展與市場(chǎng)總監(jiān) 張卓 |
| 16:00-16:30 | 茶 ?歇 | |
| 16:30-17:00 | 多層陶瓷封裝外殼的生產(chǎn)工藝和可靠性設(shè)計(jì) | 宏科電子 副廠長(zhǎng) 康建宏 |
| 17:00-17:30 | 低溫共燒LTCC和高溫共燒HTCC燒結(jié)中的關(guān)鍵因素 | 蘇州阿爾賽 總經(jīng)理 王笏平 |
| 17:30-18:00 | 多層共燒陶瓷生產(chǎn)線裝備與系統(tǒng) | 中電科2所 高級(jí)專(zhuān)家 郎新星 |
| 18:00-18:30 | PVD技術(shù)在封裝用陶瓷基板上的應(yīng)用 | 中國(guó)科技大學(xué) 教授 謝斌 |
| 18:30-19:00 | 高溫共燒陶瓷(HTCC)封裝與系統(tǒng)集成 | 福州大學(xué) 副教授 韓國(guó)強(qiáng) |
| 19:00-20:30 | 晚 ?宴 | |

贊助及支持企業(yè)

?
方式一:加微信

郵箱:lirongrong@aibang.com
注意:每位參會(huì)者均需要提供信息
方式二:長(zhǎng)按二維碼掃碼在線登記報(bào)名

或者復(fù)制網(wǎng)址到瀏覽器后,微信注冊(cè)報(bào)名

原文始發(fā)于微信公眾號(hào)(艾邦陶瓷展):高溫共燒多層陶瓷外殼的失效機(jī)理分析
長(zhǎng)按識(shí)別二維碼關(guān)注公眾號(hào),點(diǎn)擊下方菜單欄左側(cè)“微信群”,申請(qǐng)加入交流群。

