
摩爾定律問世已近60年,人們不無驚奇地看到半導體芯片制造工藝水平以一種令人目眩的速度提高,隨著集成電路逐步向大規模和超大規模發展,為了滿足半導體芯片小型化、微型化的需求,必須研制體積小、重量輕的各類器件用陶瓷封裝外殼。與此同時高便攜的現代電子產品,除具備低導通阻抗、低開關損耗、低熱阻等特性之外,還需實現纖薄小巧的表面貼裝,帶動中小規模集成電路及半導體分立器件用陶瓷外殼向更小、更薄、散熱性能更好的芯片級封裝發展。

為適應目前小型氣密性陶瓷外殼的應用,必須提高陶瓷材料的密度和強度以實現薄型化、輕量化。傳統陶瓷材料制作的封裝外殼機械強度相對較低,在恒定加速度、機械沖擊等試驗中偶發陶瓷基體斷裂情況,從而出現封裝漏氣、布線開路等失效現象;在整機系統極限試驗中偶因陶瓷微裂紋,從而造成引線脫落、焊框分層等失效現象。另外,傳統陶瓷材料制作的封裝外殼致密度不足,容易因釋氣而出現內部水汽超標、氫氣含量超標等失效現象。
?
根據經驗,陶瓷管殼氣密性與陶瓷材料的抗彎強度成正比關系,抗彎強度越高,管殼氣密性越好,而封裝管殼的核心訴求就是實現高氣密性封裝,我司常規陶瓷材料的抗彎強度為450-480MPa,而國內外比較優秀同行水平已經達到大于500MPa的水平。
為了縮短差距,淮瓷科技有限公司科技部在總經理的指示下,著手開發粉體材料必須為國產的高強度HTCC陶瓷生瓷帶。科技部收到指令后,積極擬定研發路線,包括陶瓷配方的優化、分散工藝的優化、流延前處理工藝優化、流延工藝的優化、層壓工藝的匹配、燒結曲線的優化。然后著手采購原材料緊鑼密鼓地進行試驗,在經歷了100多次的制漿、流延、試燒試驗和數據分析總結后,終于制備了2種高強度陶瓷生瓷帶配方,分別為550MPa和750MPa的樣件,并且優化了配方,使之能與HTCC生瓷加工工藝相匹配,共燒溫度跟目前量產材料一致。
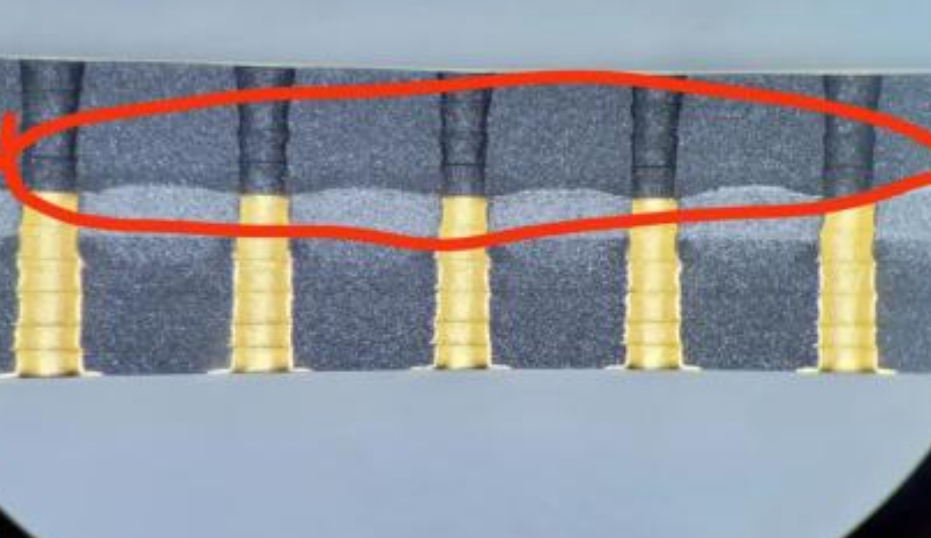
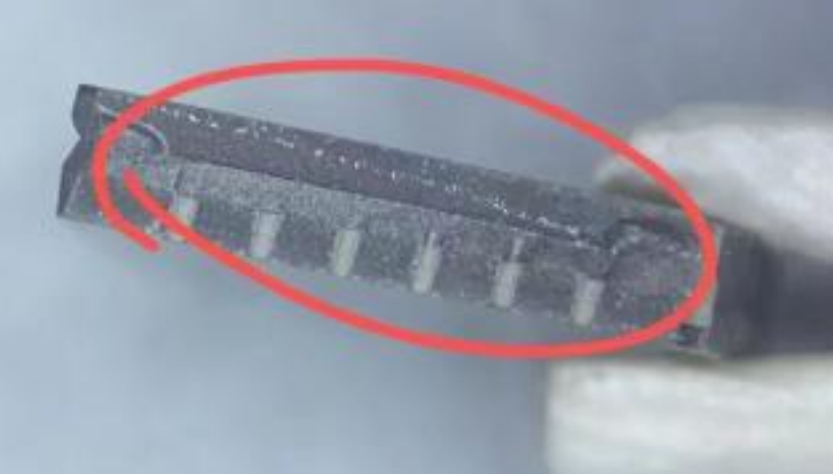
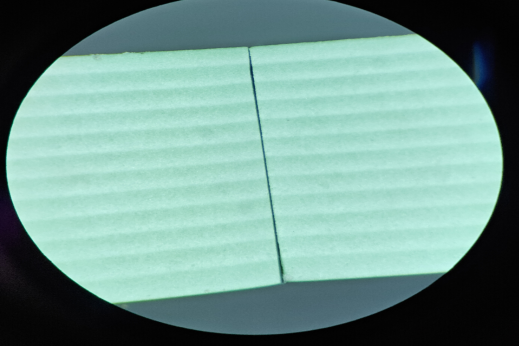
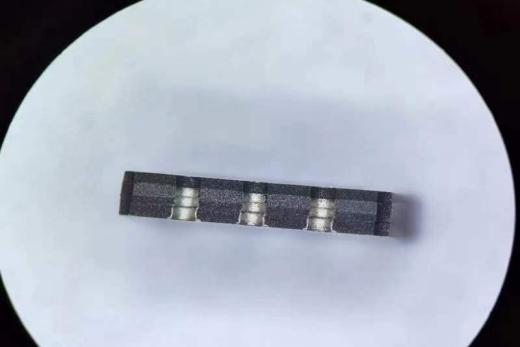
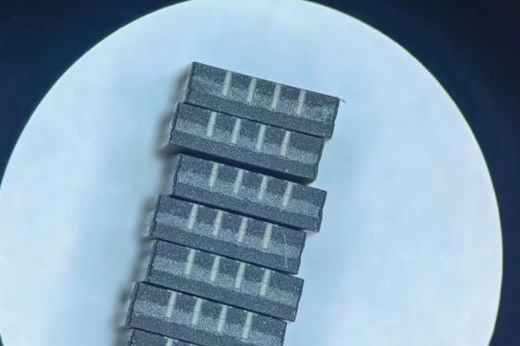
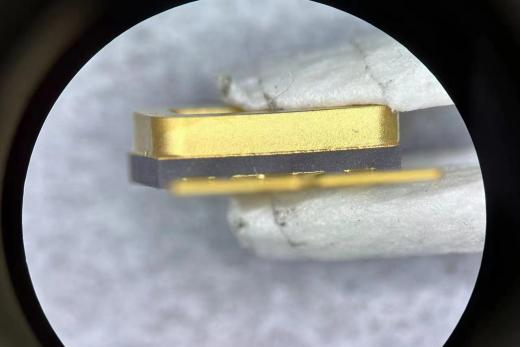

近日淮瓷科技收到國內某上市公司的管殼需求,要求制備窄壁厚(0.5mm)封裝管殼,公司積極開展項目研討,并選用550MPa強度的生瓷作為解決方案,豐富的材料選擇空間,為公司順利接單提供了有力支撐。
研發能力是企業的生命力所在,淮瓷科技將繼續拓展新材料,新工藝的路徑,不斷延伸陶瓷封裝外殼領域的技術觸角,緊跟半導體集成電路的發展趨勢,助力國產封裝事業勇攀高峰。

原文始發于微信公眾號(淮瓷科技有限公司):提高材料性能,解決生產難題
長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入交流群。

