低溫共燒陶瓷(Low Temperature Co-Fired Ceramics,LTCC)封裝能將不同種類的芯片等元器件組裝集成于同一封裝體內(nèi)以實(shí)現(xiàn)系統(tǒng)的某些功能,是實(shí)現(xiàn)系統(tǒng)小型化、集成化、多功能化和高可靠性的重要手段。
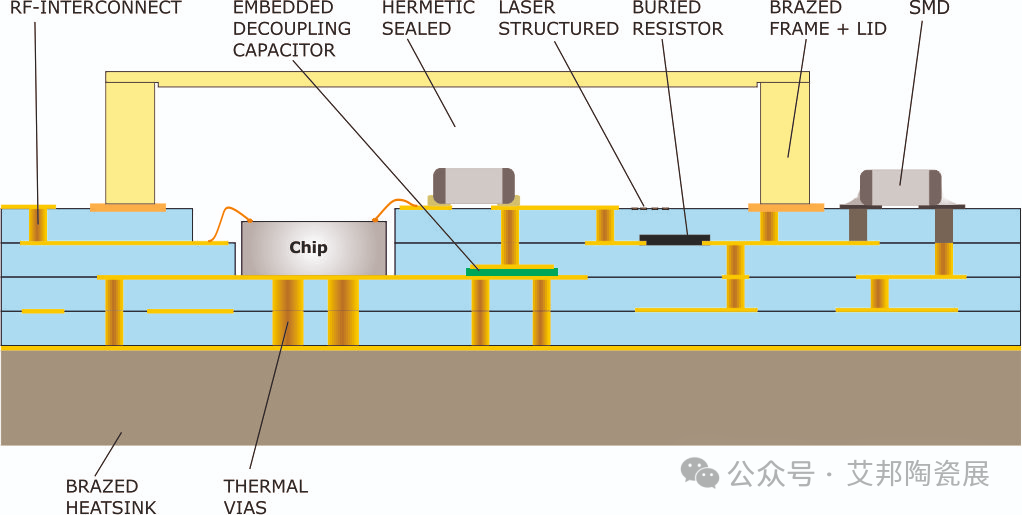
圖 LTCC封裝結(jié)構(gòu)示意圖,來源:MSTLTCC 封裝材料是指用于承載電子元器件及其相互連線,起到機(jī)械支撐、密封環(huán)境保護(hù)、信號傳遞、散熱和屏蔽等作用的基體材料,包括 LTCC 基板、布線、殼體、框架、熱沉、蓋板、焊料等材料,總體上分為LTCC 基板材料、封裝金屬材料和焊接材料三大類。艾邦建有LTCC交流群,誠邀LTCC生產(chǎn)企業(yè)、設(shè)備、材料企業(yè)參與。
長按識別二維碼關(guān)注公眾號,點(diǎn)擊下方菜單欄左側(cè)“微信群”,申請加入LTCC交流群。LTCC 基板材料包括 LTCC 生瓷帶和與生瓷帶配套的導(dǎo)體和電阻等材料。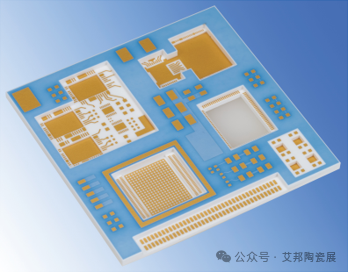
LTCC所用的布線和通孔連接的導(dǎo)體材料以 Au、Ag、Pd、Pt等貴金屬或它們的合金(二元合金或三元合金 PdAg、PtAg、PtAu、PtPdAu等)為導(dǎo)電相,其性能穩(wěn)定,工藝成熟,可在空氣氣氛下燒結(jié)。Cu 也是高電導(dǎo)率材料,導(dǎo)熱率較高,焊接性能優(yōu)異,適合低溫?zé)Y(jié),但由于 Cu 在空氣中受熱后極易氧化,故與 Au、Ag 等貴金屬材料不同,在燒結(jié)時需有中性氣氛(常用氮?dú)?做保護(hù)氣體。表 LTCC 與 HTCC 主要導(dǎo)體材料比較
LTCC 封裝用生瓷帶主要有玻璃陶瓷系(微晶玻璃)和玻璃+陶瓷系兩類。●?玻璃陶瓷系在基板燒結(jié)時析出低介電常數(shù)低損耗微晶相,適合制作高頻組件或模塊用基板中。●?玻璃+陶瓷系以玻璃作為低溫?zé)Y(jié)助劑,陶瓷作為主晶相,改善基板力學(xué)和熱性能,其介電常數(shù)和介電損耗一般比微晶玻璃要大,主要用于中低頻電路基板。表? LTCC材料基本性能
對傳輸線路來說,低介電常數(shù)有利于信號的高速傳輸(信號的傳輸延遲時間正比于介電常數(shù)的方根)。更高的介電常數(shù)意味著更小的波長,也意味著使用高介電常數(shù)可以使微波器件的尺寸做得更小。
推薦閱讀:2024年 LTCC 生瓷帶的生產(chǎn)企業(yè)名單
LTCC 封裝金屬材料主要根據(jù)金屬封裝材料特性進(jìn)行選擇,需要綜合考慮金屬材料的熱導(dǎo)率、熱膨脹系數(shù)、密度、可焊性、工藝成熟性等。表 封裝金屬材料基本特性
含鎳 29%、鈷 18% 的 Fe-Ni-Co 系合金稱為可伐(Kovar)合金,其熱膨脹系數(shù)較小,與常用 LTCC 基片熱膨脹系數(shù)相匹配,具有較好的加工性,成本較低,是一種較常用的金屬管殼材料。但其熱導(dǎo)率不高,這也限制了它作為金屬管殼封裝的應(yīng)用范圍。CuW 和 CuMo 合金則結(jié)合了 WMo 和Cu 的許多優(yōu)異特性,從而具有良好的導(dǎo)熱導(dǎo)電性、耐電弧侵蝕性、抗熔焊性和耐高溫、抗氧化性等特點(diǎn),并且熱膨脹系數(shù)可在一定范圍內(nèi)選擇,主要應(yīng)用于大規(guī)模集成電路和大功率微波器件中,作為熱控板、散熱元件(熱沉材料)和引線框架使用。但因 CuW 和 CuMo 密度較大等原因,使用范圍受限,不適于在便攜式電子產(chǎn)品和航空航天裝備中應(yīng)用,在要求電子設(shè)備輕量化的 LTCC 封裝中應(yīng)用越來越少。鋁硅合金材料具有質(zhì)量輕、熱膨脹系數(shù)較低、熱傳導(dǎo)性能良好、強(qiáng)度和剛度高等優(yōu)點(diǎn),且與金、銀、鎳可鍍,硅與鋁潤濕良好,具有易于精密機(jī)加工、無毒、成本低廉等優(yōu)越性能,受到國內(nèi)外學(xué)者的廣泛關(guān)注,成為具有廣闊應(yīng)用前景的電子封裝材料之一。AlSiC 具有高熱導(dǎo)率、低膨脹系數(shù)、高強(qiáng)度、低密度、良好的導(dǎo)電性等特點(diǎn),正被越來越多的學(xué)者所關(guān)注,ASiC 作為基板或熱沉材料在國內(nèi)封裝領(lǐng)域已得到批量應(yīng)用。LTCC 封裝焊接材料主要作為連接材料,用于 LTCC 基板與金屬底板、金屬圍框、引腳的焊接,基板上元器件組裝、焊球連接及基板垂直互連等。LTCC 封裝用焊接材料熔點(diǎn)一般低于 450 ℃,屬于軟釬料。LTCC 封裝在生產(chǎn)過程中,需進(jìn)行金屬與陶瓷焊接、元器件組裝、焊球陣列制作、垂直互連等工序,這些組裝和封裝過程常常是通過多步焊接完成的。為了使后道工序不影響前道工序焊接結(jié)果(元件回熔和移位),不同工序所用焊料的熔點(diǎn)往往要有一定的溫度差,形成溫度梯度。●?有鉛焊料主要是鉛錫焊料,其工藝成熟,常用的 Sn63Pb37 焊料焊點(diǎn)可靠性、光澤度及一些機(jī)械性能優(yōu)于無鉛焊料。●?無鉛焊料主要指金系焊料和錫銀系焊料。雖然無鉛焊料工藝、物理等某些特性不如鉛錫焊料,但無鉛焊料在某些方面也表現(xiàn)出良好的特性,如錫銀銅焊料具有鉛錫焊料 1.5~2.0 倍的抗張強(qiáng)度和優(yōu)秀的抗熱疲勞性能,金錫焊料具有比鉛錫焊料高得多的抗拉強(qiáng)度和優(yōu)異的抗氧化性。無鉛化也是電子材料的一個發(fā)展方向。LTCC 封裝焊接材料有焊膏和焊片,焊膏更適合微小元器件和焊球等多點(diǎn)位置的焊接,焊片常用于圍框、基板等面積相對較大的焊件和精確尺寸(焊料逸出少)焊件的焊接。Au80Sn20 、Au88Ge12 等焊料需在氮?dú)獗Wo(hù)或真空氣氛下焊接,其成本較高,主要用于金屬與 LTCC 基板氣密性焊接;鉛錫焊料、錫銀系焊料等可在空氣氣氛中焊接,主要用于元器件焊接和垂直互連等。來源:LTCC 封裝技術(shù)研究現(xiàn)狀與發(fā)展趨勢,李建輝,丁小聰.艾邦建有LTCC交流群,誠邀LTCC生產(chǎn)企業(yè)、設(shè)備、材料企業(yè)參與。
長按識別二維碼關(guān)注公眾號,點(diǎn)擊下方菜單欄左側(cè)“微信群”,申請加入LTCC交流群。
第七屆精密陶瓷暨功率半導(dǎo)體產(chǎn)業(yè)鏈展覽會
2025年8月26日-28日
展出2萬平米、1,000個攤位、500多家展商、50,000名專業(yè)觀眾;匯聚IGBT/SiC功率半導(dǎo)體產(chǎn)業(yè)鏈;熱管理材料產(chǎn)業(yè)鏈,精密陶瓷、電子陶瓷、陶瓷基板、薄膜/厚膜陶瓷電路板、陶瓷封裝管殼、LTCC/HTCC/MLCC加工產(chǎn)業(yè)鏈、SOFC/SOEC隔膜等產(chǎn)業(yè)鏈上下游企業(yè)!

展會預(yù)定:
?
掃碼添加微信,咨詢展會詳情

?
掃碼添加微信,咨詢展會詳情

原文始發(fā)于微信公眾號(艾邦陶瓷展):低溫共燒陶瓷(LTCC)封裝材料介紹