精密劃片機主要用于硅片、陶瓷、玻璃、砷化鎵等材料的加工,也被廣泛應用于集成電路(IC)、陶瓷薄板、PCB、藍寶石玻璃等行業。劃片機作為半導體芯片后道工序的封裝環節加工設備之一,用于晶圓的劃片、分割或開槽等微細加工,其切割的質量與效率直接影響到芯片的封裝質量和生產成本。例如用于LED晶片的分割,形成LED芯粒。

半導體晶圓劃片機主要用于封裝環節,是將含有很多芯片的wafer晶圓分割成一個一個晶片顆粒的設備,目前行業主要以機械劃片為主,包括主軸、控制系統等,由于切割基體為半導體器件,所以產品良率及控制要求較高。
劃片機目前以砂輪機械切割為主流切割方式,激光是重要補充。劃片機主要包括砂輪劃片機和激光劃片機:(1)砂輪劃片機是綜合了水氣電、空氣靜壓高速主軸、精密機械傳動、傳感器及自動化控制等技術的精密數控設備,在國內也稱為精密砂輪切割機。(2)激光劃片機是利用高能激光束照射在工件表面,使被照射區域局部熔化、氣化、從而達到劃片的目的。
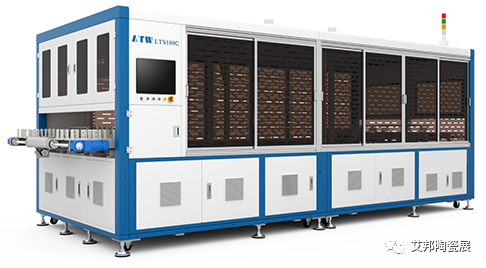
目前市場以砂輪切割機為主,主要是激光切割不能使用大功率以免產生熱影響區(HAZ)破壞芯片;激光切割設備非常昂貴(一般在100萬美元/臺以上);激光切割不能做到一次切透(因為HAZ問題),因而第二次切割還是用劃片刀來最終完成。
VLSI數據顯示劃片機在封裝設備的價值量為28%,根據SEMI數據,2021年全球封裝設備市場規模為69.9億美元,2021年全球封裝設備市場規模為69.9億美元,對應2022年劃片機的市場空間約為20.4億美元。
從格局看國外供應商如日本DISCO、東京精密、以色列ADT等壟斷。目前日本Disco壟斷了全球70%以上的封裝關鍵設備減薄機和劃片機市場,東京精密ACCRETECH次之,劃片機國產化率僅5%左右,國內主要企業有光力科技、中電科45所、江蘇京創、沈陽和研以及深圳華騰等。
原文始發于微信公眾號(艾邦陶瓷展):晶圓劃片機——封裝工序的超精密設備