銅晶粒度是直接鍵合銅(DBC)基板的一項重要特征。人們無法完全避免銅晶粒度的變化,但當粒度變化較大時,直接鍵合銅基板的后續封裝或性能可能會受到影響。羅杰斯電力電子解決方案(PES)團隊憑借其在這方面的經驗和能力,協助模塊制造商提供擁有均勻粒度的基板。在這篇博客中,我們將說明為什么銅晶粒度變化要受到限制以及羅杰斯電力電子解決方案團隊為此做出的努力。
?
銅晶粒度對封裝工藝和基板性能的影響
?
模塊制造商會在封裝中用到照相定位系統和自動光學檢驗系統。這些系統依靠光的反射來將部件準確地放置在基板上或檢測故障。但光的反射取決于銅晶粒度。細銅粒表面具有漫反射性質,也就是說,其表面存在均勻的光反射。與之相反的是,光在粗銅粒面上的反射方向根據其銅晶粒方向的不同而不同。 下圖展示了光反射在粗粒銅面(左)和細粒銅面(右)上的典型差異。工藝工程師通常會通過優化機器設置來處理一種或另一種粒度,但對于不同批次或同一生產批次內出現的較大的粒度差異,他們一般不會選擇視而不見。
?
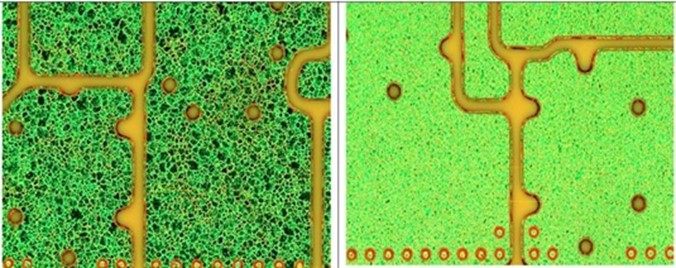
?
此外,銅晶粒度還會影響基板的彎曲程度和使用壽命。熱循環調查表明,銅晶粒度較小的直接鍵合銅基板更容易失效。被稱為錯位的晶體缺陷能夠輕松地在晶粒中移動,但晶界能夠阻止錯位。晶粒越小,表面積-體積比越大,晶界-錯位比越大。晶界越多,強度越高。因此,銅晶粒度越小,在熱循環過程中的變形就越小。 也就是說,承受更大熱機械應力的陶瓷最終比粗粒銅更早破裂。
?
因此,模塊制造商要求其直接鍵合銅基板供應商控制銅晶粒度,并控制不同批次或同一生產批次內的粒度差異。但這要求供應商對直接鍵合銅工藝和銅原材料有足夠的了解。
?
影響銅晶粒度的因素
?
直接鍵合銅基板的銅晶粒度取決于銅原材料自身以及直接鍵合銅工藝。
?
對于直接鍵合銅工藝,必須使用高等級無氧銅(標準名稱:Cu-OFE,材料編號:CW009A),專用于電子和導熱應用。該材料純度極高,最高氧含量僅為5 ppm(0.0005%)。除氧含量外,銅原材料中的雜質元素及其濃度也是影響直接鍵合銅工藝的關鍵參數。羅杰斯針對銅原材料供應商制定了相應規范。所有批次的銅均需持有測試證書,確保其雜質含量低于規定限值。雖然雜質總含量低于 50ppm (0.0050%),某種雜質不超過 25ppm (0.0025%),但無法排除化學成分的變化。這可能導致粘結工藝之后銅晶粒度發生變化。
?
因此,銅原材料的供應商無法保證直接鍵合銅基板的銅晶粒度。直接鍵合銅工藝,特別是其溫度曲線,對成品的銅晶粒度有著顯著影響。因此,應在鍵合后測量銅晶粒度。
?
銅晶粒度的測量方法和典型值
?
羅杰斯會對每片原銅箔進行檢查。從線圈中取出一片銅。然后將其氧化并與陶瓷鍵合。最后,清潔基板,除去表面上的氧化銅,測量銅晶粒度。通常使用光學顯微鏡測量銅晶粒度。銅晶粒度即每mm的粒數。典型值從不到3粒/mm(粗糙銅)到10粒/mm以上(細粒銅)不等。
?
如下圖所示,2.3 mm的長度內共有16粒。因此這條線上的銅晶粒度為2.3 mm/16=144 μm或16/2.3 mm=7.0粒/mm。在5條平行線和5條垂直線上重復上述測量步驟,計算平均值。
?

?
四十多年來,羅杰斯 PES 團隊一直專注于生產 DBC 基板。我們為電力電子和汽車行業提供了數以億計的基板產品。多年以來,我們積累了很多經驗,不斷完善直接鍵合銅工藝,在最先進的封裝工藝和基板性能之間尋求最佳的平衡點,實現始終如一的質量。2013年我們對銅晶粒度及其變化進行了研究和探討。下面的柱狀圖展示了研究期間直接鍵合銅基板平均銅晶粒度的分布。
?

?
隨著封裝技術的發展和模塊制造商對基板性能的追求,銅晶粒度有待進一步優化。
來源:羅杰斯
長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入交流群。