陶瓷封裝外殼具備高氣密性,高導熱,高強度,與芯片材料適配的熱膨脹系數等優點,廣泛應用在航空航天、軍事裝備、地面雷達、光通信、醫療器械和傳感器等有高可靠性需求的諸多行業。根據 Semiconductor Insight 最新報告數據,2022年全球陶瓷封裝市場價值為29.223億美元,預計到2029年將達到41.582億美元,復合年增長率為5.2%。

圖??陶瓷四邊無引線封裝外殼(CQFN),攝于航科創星展臺
陶瓷封裝外殼主要包括具有窗口和支撐件結構的外殼圍框、陶瓷饋通組件、蓋板、散熱底板,如圖1所示。蓋板設于外殼圍框頂部,將外殼圍框上部開口封閉;外殼圍框側墻上開設有多個窗口,在窗口內裝載有陶瓷件,陶瓷件位于外殼圍框外側的一端設有焊接區,焊接區連接有引線,陶瓷件位于外殼圍框內側的一端設有可供內部封裝芯片和外部電路鍵合的鍵合區,焊接區與鍵合區電連接;散熱底板位于外殼圍框底部;零部件通過預制成型焊片焊接組裝在一起。部分陶瓷封裝管殼產品例如紅外探測器封裝外殼、光通信封裝外殼等設置光窗。
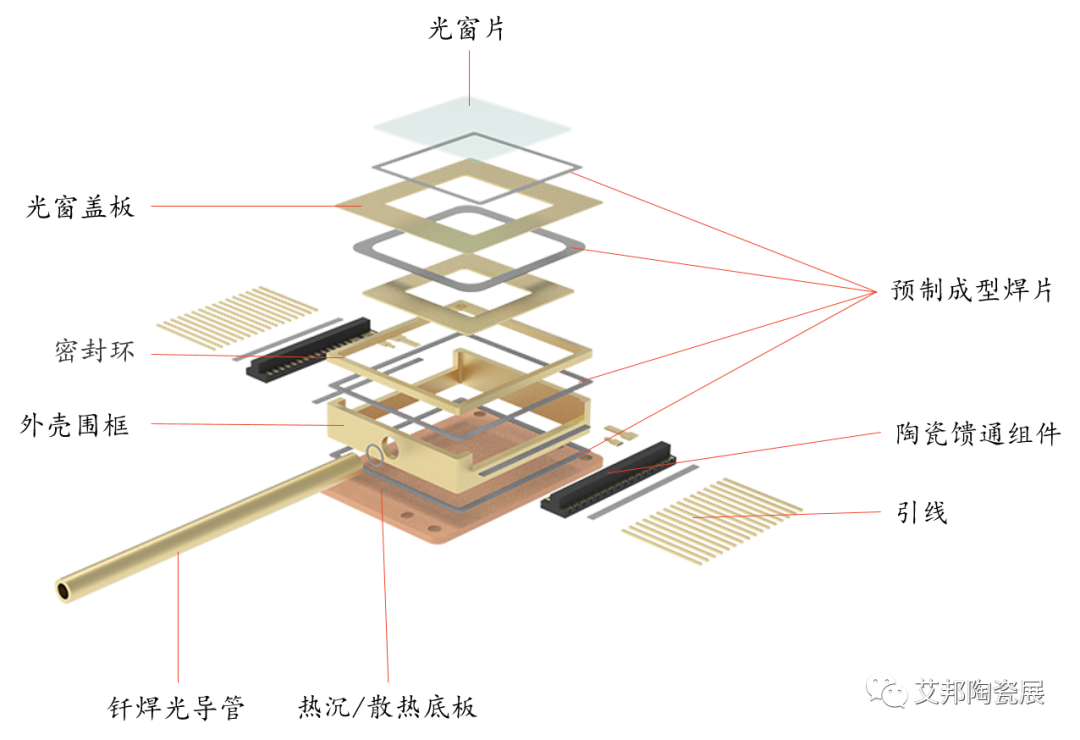
圖1 非制冷型紅外探測器封殼結構示意圖,來源:中航天成
如圖2所示,多層陶瓷封裝外殼制造技術包括原材料制備、流延、沖孔沖腔、金屬化印刷、層壓、熱切、燒結、鍍鎳、釬焊、鍍金等技術;光通信用陶瓷封裝外殼還會焊光窗。其封裝過程涵蓋外殼清洗、裝片、清洗、引線鍵合、封蓋、外引線處理、打標、檢測等。
 圖2??陶瓷封裝管殼工藝流程
圖2??陶瓷封裝管殼工藝流程
所涉及的原材料及耗材主要包括:
陶瓷材料:氧化鋁、氮化鋁、莫來石等材料; 匹配的金屬化漿料:鎢漿、鉬錳漿料等; 金屬零部件(圍框、蓋板等):可伐合金(鐵鎳鈷合金)、鐵鎳合金等; 接合材料:預制成型焊片(AgCu、金錫)、B-stage 粘接劑; 封殼散熱底板采用CPC、CMC、鎢銅、鉬銅等高散熱材料,熱導率最高260W/m.K。若采用銅金剛石(Cu-Dia)材料,其熱導率可達580W/m.K; 光窗:硅、鍺、硒化鋅、藍寶石等材料; 耗材:氰化亞金鉀電鍍液、添加劑、膜帶、耐火材料等。

長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊
?
序 號 | 暫定議題 | 擬邀請企業 |
1 | 半導體陶瓷封裝外殼仿真設計 | 擬邀請仿真設計專家 |
2 | 多層陶瓷集成電路封裝外殼技術發展趨勢 | 擬邀請陶瓷封裝企業 |
3 | 光通信技術的發展及陶瓷封裝外殼的應用趨勢 | 擬邀請光通信企業 |
4 | 多層陶瓷封裝外殼的生產工藝和可靠性設計 | 擬邀請陶瓷封裝企業 |
5 | 多層陶瓷高溫共燒關鍵技術介紹 | 擬邀請HTCC企業 |
6 | 電子封裝用陶瓷材料研究現狀 | 擬邀請材料企業 |
7 | 多層共燒金屬化氮化鋁陶瓷工藝研究 | 擬邀請氮化鋁企業 |
8 | HTCC陶瓷封裝用電子漿料的開發 | 擬邀請導電漿料企業 |
9 | 多層共燒陶瓷燒結關鍵技術探討 | 擬邀請燒結設備企業 |
10 | 陶瓷封裝外殼的焊料開發 | 擬邀請焊材企業 |
11 | 電子封裝異質材料高可靠連接研究進展 | 擬邀請陶瓷封裝企業 |
12 | 厚膜印刷技術在陶瓷封裝外殼的應用 | 擬邀請印刷相關企業 |
13 | 高精密疊層機應用于多層陶瓷基板 | 擬邀請疊層設備 |
14 | 陶瓷封裝管殼表面處理工藝技術 | 擬邀請表面處理企業 |
15 | 激光技術在陶瓷封裝管殼領域的應用 | 擬邀請激光企業 |
16 | 陶瓷封裝釬焊工藝介紹 | 擬邀請釬焊設備企業 |
17 | 半導體芯片管殼封裝及設備介紹 | 擬邀請封焊設備企業 |
18 | 全自動高速氦檢漏系統在陶瓷封裝領域的應用 | 擬邀請氦氣檢測設備企業 |
19 | 芯片封裝殼體自動化測量方案 | 擬邀請檢測設備企業 |
20 | 等離子清洗在高密度陶瓷封裝外殼上的應用 | 擬邀請等離子清洗企業 |
更多議題征集中,演講&贊助請聯系王小姐:13714496434(同微信)
?
方式一:加微信

郵箱:wanghuiying@aibang.com
注意:每位參會者均需要提供信息
方式二:長按二維碼掃碼在線登記報名

或者復制網址到瀏覽器后,微信注冊報名
原文始發于微信公眾號(艾邦陶瓷展):陶瓷封裝外殼的主要生產材料及設備
長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入交流群。


