碳化硅襯底切割技術是將SiC晶錠沿著一定的方向切割成晶體薄片的過程。將SiC晶錠切成翹曲度小、厚度均勻的晶片。切割方式和切割質(zhì)量影響晶片的厚度、粗糙度、尺寸、耗損度及生產(chǎn)成本等。
在碳化硅器件成本中,襯底占比47%左右,是價值量最高的原材料。在襯底加工環(huán)節(jié),由于碳化硅自身硬度大且脆性高,莫氏硬度達9.5級,僅次于鉆石,在現(xiàn)有技術背景下,切割難度較大,破損率較高,切割成本占比達50%左右。

在降本需求催動下,需要將一個大的碳化硅(SiC)晶錠切成盡可能多的薄碳化硅(SiC)晶圓襯底,同時隨著晶圓尺寸不斷增大(目前8英寸晶圓已有量產(chǎn),下一步將拓展12英寸晶圓的生長),這些都對切割工藝的要求提出了更高的標準。
目前主流的切割工藝大體分為多線切割和激光切割,多線切割又可細分為砂漿線切割和金剛石線切割。

來源:《碳化硅單晶襯底加工技術現(xiàn)狀及發(fā)展趨勢》,《碳化硅晶圓切割方法綜述》,東吳證券研究所
多線切割
多線切割
目前應用在碳化硅切割行業(yè)的是砂漿線切割和金剛石線切割。
砂漿線切割
砂漿切割切割相比于傳統(tǒng)的切割方式,克服了一次只能切割一片的缺點,可以加工較薄的晶圓(切片厚度小于0.3 mm),具有切縫窄、切割厚度均勻、材料損耗小等優(yōu)點,目前發(fā)展成熟,廣泛用于單晶和多晶碳化硅片的加工。
原理是利用線鋸的快速運動將切削液中的磨料顆粒帶入鋸縫,在切割線的壓力和速度的帶動下,游離的磨料顆粒在鋸縫中不斷滾動,從而實現(xiàn)材料的切割。
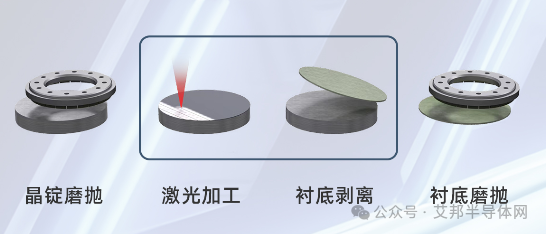
圖:砂漿線切割示意圖
利用該項技術切割碳化硅晶錠時,磨粒對切割效果有著很大的影響。碳化硅的硬度極高,切割液需要以金剛石微粉作為磨粒才能達到較為高效的切割目的。砂漿作為磨粒的載體,對懸浮于其中的磨粒起到穩(wěn)定分散、帶動運動的作用,因此對于其粘度和流動性有一定的要求。
缺點:切割速度低、磨粒利用率低、砂漿液難回收并且會對環(huán)境造成污染;另外在加工過程中游離的磨粒對鋼線也具有磨削作用,這不僅會導致切割出來的碳化硅晶片厚度不均勻,而且會降低線鋸的使用壽命。
砂漿線切割耗材:游離磨料多線切割的切割線多使用表面鍍Cu的不銹鋼絲(Ф150~300 μm),單根線總長度可以達到600~800 km。砂漿主要是由10~15 μm的碳化硅或金剛石和礦物油或水按一定比例混合而成。
砂漿線切割設備供應商:日本高鳥、唐山晶玉、湖南宇晶等。
金剛石線切割
金剛石線切割是將高硬度、高耐磨性的金剛石磨粒通過電鍍、樹脂粘接、釬焊或機械鑲嵌等方法固結(jié)在切割線上,通過金剛線的高速往返運動,磨粒直接與工件間形成相對的磨削運動,完成對SiC晶錠的切割。
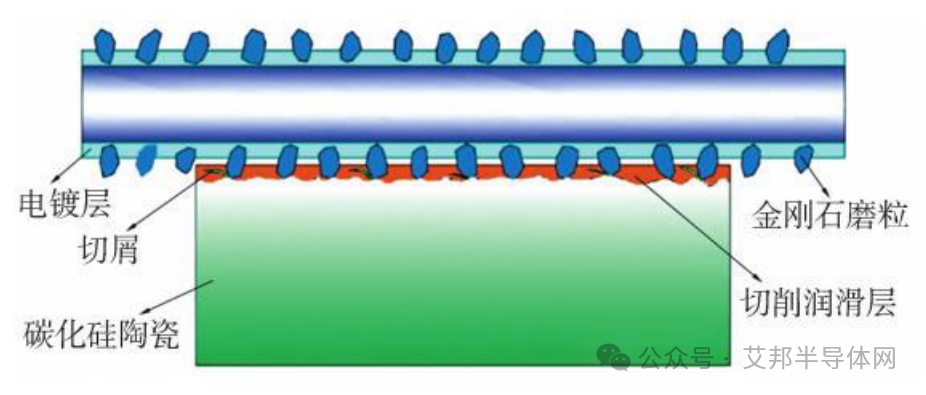
圖:金剛石線切割示意圖
相比游離磨料線鋸切割的“三體加工”,金剛石線鋸切割屬于“二體加工”,其加工效率是游離磨料線鋸切割的數(shù)倍以上,但仍有明顯缺點,切口較大,表面粗糙度較大,材料損失高達46%,切縫一般都在200μm以上。
金剛石線切割設備企業(yè):日本東洋現(xiàn)金機床、美國PSS集團、高策股份、煙臺力凱數(shù)控等。
激光切割
大致可分為水導激光切割和隱形切割。
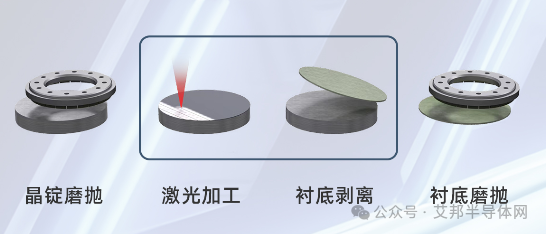
圖:激光切割碳化硅工序
碳化硅襯底除了“如何增產(chǎn)”,更應該思考的是“如何節(jié)約”。采用激光切片設備可以大大的降低損耗,提升產(chǎn)率。以單個20毫米SiC晶錠為例,采用線鋸可生產(chǎn)30片350um的晶圓,而用激光切片技術可生產(chǎn)50多片晶圓。同時,由于激光切片生產(chǎn)的晶圓的幾何特性更好,因此單片晶圓厚度可以減少到200 um,這就進一步增加了晶圓數(shù)量,單個20毫米SiC晶錠可以生產(chǎn)80多片晶圓。
水導激光切割
水導激光切割技術(Laser MicroJet,LMJ),又稱激光微射流技術。最早是由瑞士Synova西諾瓦公司基于傳統(tǒng)鉆石切割開發(fā)而來。
原理:在激光通過一個壓力調(diào)制的水腔時,將激光束聚焦在一個極小的噴嘴上,從噴嘴中噴出高壓水柱,在水與空氣的界面處,通過折射的原理形成激光的傳導,使得激光沿水流方向運動,從而通過高壓水射流引導加工材料表面進行切割。
目前國際上主要的激水柱集中在150mm-200mm左右,該技術在大尺寸的碳化硅(SiC)晶圓切割上,還有一定的技術瓶頸,但是6寸以內(nèi)的已無技術瓶頸。

圖:碳化硅冷切割流程圖
水導激光的主要優(yōu)勢在于切割質(zhì)量(切割端面的粗糙度),水流不僅能冷卻切割區(qū),降低材料熱變形和熱損傷,還能帶走加工碎屑,相較金剛線切割,它的速度明顯加快,且端面粗糙度普遍集中在Ra<1μm范圍內(nèi)。但由于水對不同波長的激光吸收率不同,目前最主要的應用是1064nm、532nm、355nm的綠激光,即使使用綠光激光器,其傳導率也基本上只有40%的激光功率。
國內(nèi)技術發(fā)展相對較,主要是哈工大和長春理工、西電等高校在積極研發(fā),目前可實現(xiàn)產(chǎn)業(yè)化的噴嘴是80μm(西諾瓦為50μm),并有望在近幾年實現(xiàn)校企合作的產(chǎn)業(yè)化,如哈工大產(chǎn)業(yè)化的哈焊研究院、西電產(chǎn)業(yè)化的晟光硅研等。
性能:
精度高,公差為 +/-3 μm
可切割任意形狀(2D)
切割速度高:薄晶圓 (<50 μm) 切割速度高達 200 mm/s
晶圓厚度從 50 μm 到 2 mm
最大軸速度1000mm/s
隱形激光切割
隱形激光切割(Stealth Dicing, SD)包括納秒級別脈沖激光器的激光隱形切割和超短脈沖激光切割。原理是將激光束透過碳化硅的表面聚焦晶片內(nèi)部,在所需深度形成改性層,從而實現(xiàn)剝離晶圓。
優(yōu)點是晶圓表面沒有切口,避免了刀具磨損和機械應力的影響,因此可以實現(xiàn)晶圓表面較高的加工精度(一般為±1μm),同時減少了后續(xù)的研磨拋光工藝過程,節(jié)省時間和材料成本。
納秒脈沖激光激光隱形切割近幾年在硅晶圓和藍寶石的切割上得到了快速發(fā)展和應用,但在加工碳化硅(SiC)過程中,脈沖持續(xù)時間遠長于碳化硅中電子和聲子之間的耦合時間(皮秒量級),因此會產(chǎn)生較大的熱效應,晶圓的高熱量吸收不僅使材料晶向發(fā)生偏移,還會產(chǎn)生較大的殘余應力,導致斷裂和不良剝離偏移。因此,在加工碳化硅(SiC)時一般采用超短脈沖激光器來實現(xiàn)激光隱切工藝,熱效應可大幅降低,但是,設備成本也因此直線上升。
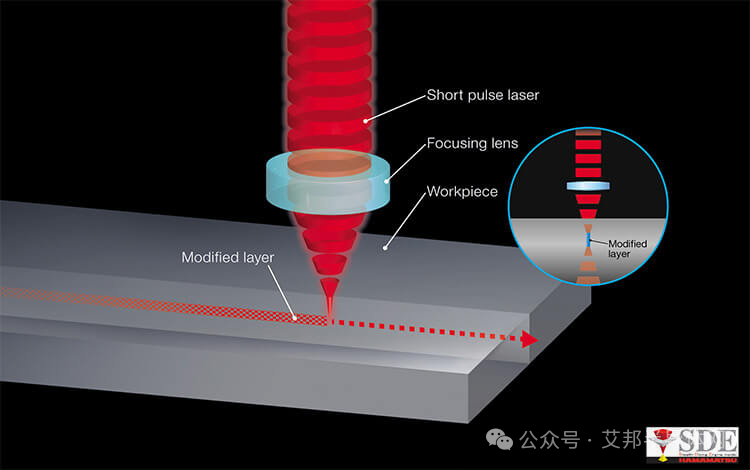
DISCO關鍵無定型黑色重復吸收技術
日本DISCO公司研發(fā)出了一種稱為關鍵無定形黑色重復吸收(key amorphous-black repetitive absorption,KABRA)的激光切割技術,以加工直徑6英寸、厚度20mm的碳化硅晶錠為例,將碳化硅晶圓的生產(chǎn)率提高了四倍。KABRA工藝本質(zhì)是上將激光聚焦在碳化硅材料的內(nèi)部,通過“無定形黑色重復吸收”,將碳化硅分解成無定形硅和無定形碳,并形成作為晶圓分離基點的一層,即黑色無定形層,吸收更多的光,從而能夠很容易地分離晶圓。

英飛凌冷切割技術
基于激光的冷切割(cold split)技術是Siltectra公司的核心技術,2018年英飛凌收購了該公司。
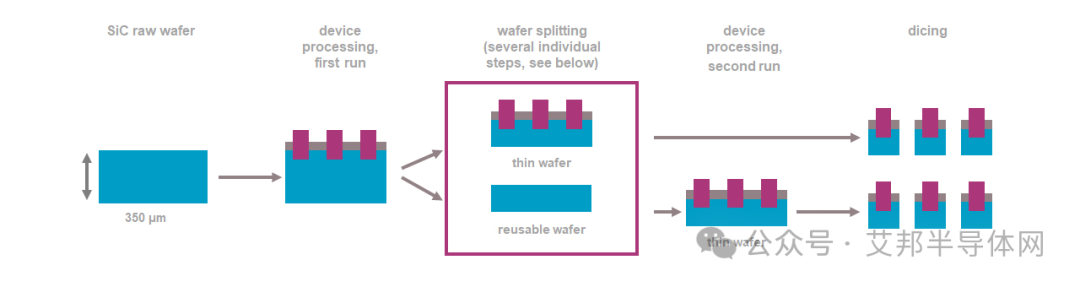
冷切割是一種高效的晶體材料加工工藝,與常見的鋸切技術相比,能夠?qū)⒉牧蠐p失降到最低幾乎不產(chǎn)生切口損失,是迄今為止第一個也是唯一一個能在半導體級實現(xiàn)20~200μm厚度無損切割的技術。英飛凌目將這項技術用于SiC晶錠的切割上,從而讓單個晶錠可出產(chǎn)的芯片數(shù)量翻番,良率提高到90%,成本降低20-30%。
該技術主要由兩個環(huán)節(jié)構成,第一步是先用激光照射晶錠剝落層,使碳化硅材料內(nèi)部體積膨脹,從而產(chǎn)生拉伸應力,形成一層非常窄的微裂紋,第二步則是通過聚合物冷卻步驟將微裂紋處理為一個主裂紋,最終將晶圓與剩余的晶錠分開。

大族激光改質(zhì)切割
國內(nèi)大族激光的激光改質(zhì)切割(QCB)是采用超快激光器(皮秒、飛秒)進行激光剝離的技術。該技術是使用精密激光束在晶圓內(nèi)部掃描形成改質(zhì)層,使晶圓可以通過外加應力沿激光掃描路徑拓展,完成精確分離。
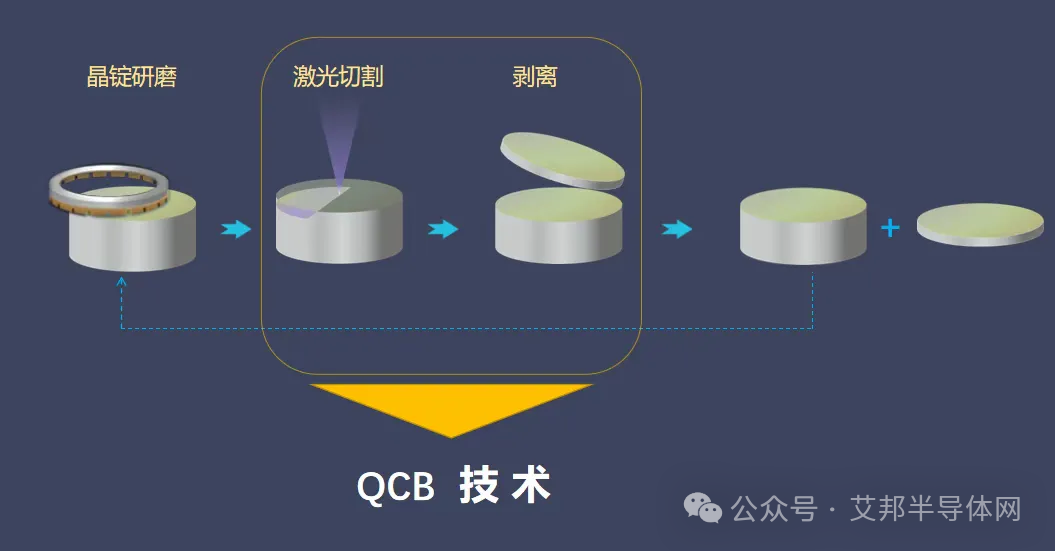
其他激光切割設備供應商還有德龍激光、華工激光、西湖儀器等。
總結(jié)

表:碳化硅切割技術對比
目前國內(nèi)市場上砂漿線切割技術已應用于絕大部分碳化硅襯底廠商,但砂漿切割損耗大、效率低、污染嚴重,正逐漸被金剛線切割技術迭代。
盡管金剛線相較于砂漿線切割優(yōu)勢明顯,但仍存在加工效率較低、材料損耗率高、設備及耗材壽命短、成本高等問題。
激光切割的性能和效率優(yōu)勢突出,與傳統(tǒng)的機械接觸加工技術相比具有許多優(yōu)點,包括加工效率高、劃片路徑窄、切屑密度高等,為碳化硅等下一代半導體材料的應用開辟了條新途徑,取代金剛線切割技術和砂漿線切割技術已成必然趨勢。隨著工業(yè)技術的發(fā)展,碳化硅襯底尺寸不斷增大,碳化硅切割技術快速發(fā)展,高效高質(zhì)量的激光切割將是未來碳化硅切割的重要趨勢。
-END-
為了促進行業(yè)交流和發(fā)展,艾邦新建碳化硅功率半導體產(chǎn)業(yè)鏈微信群,歡迎碳化硅前道材料與加工設備,后道器件生產(chǎn)和模塊封裝的行業(yè)朋友一起加入討論。 
長按識別二維碼關注公眾號,點擊下方菜單欄左側(cè)“微信群”,申請加入群聊

推薦活動:
碳化硅半導體加工技術創(chuàng)新產(chǎn)業(yè)論壇(蘇州·7月4日)
01
會議議題
01
會議議題

02
擬邀企業(yè)
高純碳粉、硅粉、碳化硅粉末、坩堝、籽晶等材料企業(yè); 晶錠、襯底、外延、晶圓等產(chǎn)品企業(yè); 碳化硅晶體、外延生長等設備企業(yè); 金剛石線切割、砂漿線切割、激光切割等切割設備企業(yè); 碳化硅磨削、研磨、拋光和清洗及耗材等企業(yè); 檢測、退火、減薄、沉積、離子注入等其他設備企業(yè); 高校、科研院所、行業(yè)機構等;
03
報名方式



04
收費標準
05
贊助方案

原文始發(fā)于微信公眾號(艾邦半導體網(wǎng)):順應降本增效趨勢,半導體碳化硅(SiC) 襯底4種切割技術詳解

