陶瓷外殼封裝工藝流程主要包括硅片減薄、劃片、裝片、鍵合、封帽、植球(針對CBGA)、回流焊等工序。其中植球和回流焊在 CBGA 封裝屬于關鍵工藝。

艾邦建有陶瓷封裝全產業(yè)鏈微信群,歡迎陶瓷封裝產業(yè)鏈上下游加入,請您識別二維碼加入。長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊1.硅片減薄
微電子產品在集成度、速度和可靠性不斷提高的同時正向輕薄短小的方向發(fā)展,與此相適應,新型的芯片封裝技術不斷涌現(xiàn),這些先進的封裝技術所需要的芯片厚度越來越薄。為滿足片式封裝器件薄型化需求,在劃片前必須對硅片進行減薄。(1)提高熱擴散效率隨著半導體結構越來越復雜、集成度越來越高,晶體管體積不斷減小,散熱已逐漸成為影響芯片性能和壽命的關鍵因素,薄的芯片更有利于散熱。(2)減小芯片封裝體積微電子產品日益向輕薄短小的方向發(fā)展,減小芯片封裝體積是適應這一發(fā)展趨勢的必由之路。(3)提高機械性能減薄后的芯片機械性能顯著提高,硅片越薄,其柔韌性越好,受外力沖擊引起的應力也越小。(4)提高電氣性能晶片的厚度越薄元件之間的連線將越短,元件導通電阻將越低,信號延遲時間越短,從而實現(xiàn)更高的性能。(5)減輕劃片加工量減薄以后再切割,可以減小劃片(Dicing)時的加工量,降低芯片崩邊的發(fā)生率。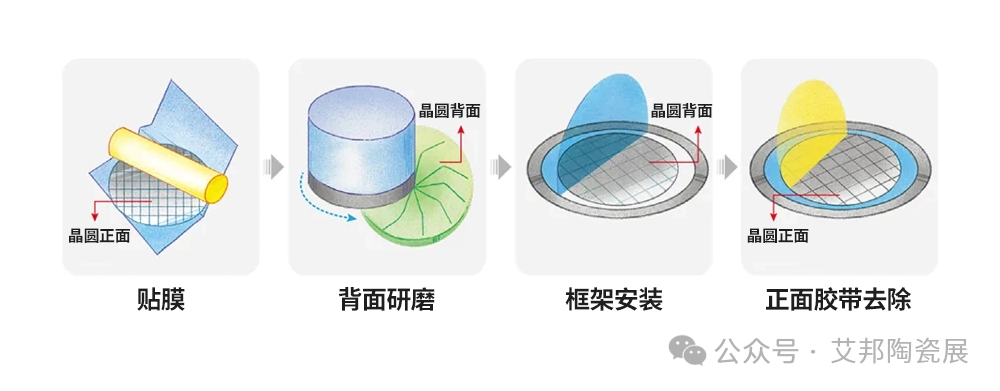
圖 晶圓背面研磨工藝的四個步驟,來源:SK Hynix高端芯片封裝時需要進行硅片減薄,硅片減薄后可以增加導熱效果、柔韌 性好、提高電性能等特點,然而當硅片減薄過程中,硅片易產生翹曲、崩邊、碎片等現(xiàn)象,硅片表面質量不受控。再有在倒裝芯片封裝過程中,芯片應力處理不好,會導致芯片邊緣和中央發(fā)生裂紋現(xiàn)象,導致器件失效,特別是對大面積芯片更容易發(fā)生,所以芯片應力消除十分重要,而芯片應力產生主要來源于芯片減薄過程中。研究認為,芯片在減薄完成后,必須進行拋光處理,拋光深度一般在1~5um范圍內,拋光后可以有效克服芯片因減薄帶來的應力問題。2.劃片工藝
在一個晶圓上,通常有幾百個至數(shù)千個芯片連在一起。它們之間留有一定的間隙,此間隙被稱之為劃片街區(qū)(Saw Street)。將每一個具有獨立電氣性能的芯片分離出來的過程叫做劃片或切割(Dicing Saw)。常用的方法有金剛刀劃片、砂輪劃片和激光劃片等幾種。劃片前首先需將晶圓貼在劃片膜上,并用專用框架固定,然后放入設備設置好程序進行自動劃切。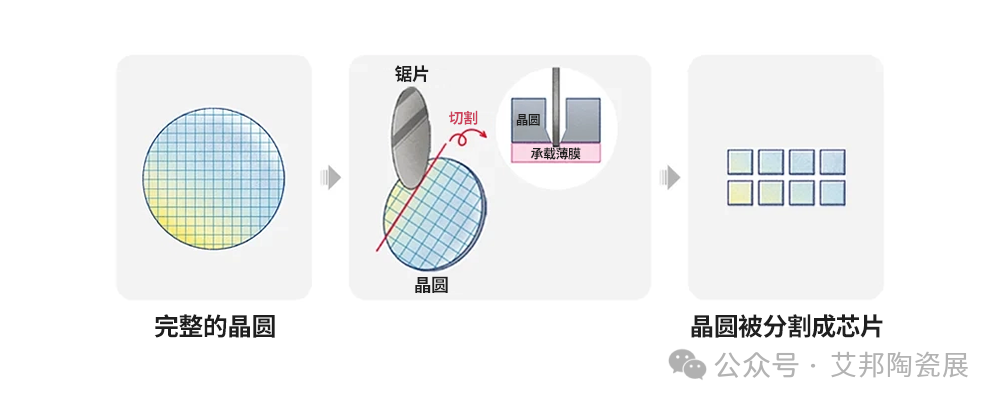
3.裝片工藝
裝片就是把集成電路芯片按照圖紙粘接到外殼襯底(如多層陶瓷封裝)或引線框架(如塑料封裝)上的指定位置,完成芯片的安裝。根據(jù)目前各種封裝結構和技術要求,裝片工藝可分為導電膠粘接法、低溫玻璃燒結法和低熔點合金的共晶焊接法等。焊接層除了為器件提供機械連接和電連接外,還須為器件提供良好的散熱通道。其方法可分為環(huán)氧樹脂粘接法和金屬合金焊接法。芯片在陶瓷基板上的粘接采用的主要材料有環(huán)氧樹脂(導電型、絕緣型)、聚酞亞胺等有機粘接劑和Au-Si共晶焊料、Au-Sn共晶焊料、Ag-玻璃焊料和軟合金(如Sn-Pb)焊料等無機粘接劑,配制成漿料或膜片的形式。無機材料的粘接原理靠的是元件粘接面之間的金屬合金化而形成電氣連接或固定,有機材料的粘接原理則是依靠粘接材料的強大粘接力使元件粘接面之間形成物理連接。無機粘接劑的優(yōu)點在于能引起污染的副產物較少(潮氣和腐蝕物少),其缺點是要面臨粘接器件的選擇。4.鍵合工藝
集成電路的芯片互連是將芯片pad與電子封裝外殼或基板鍵合指相連接,實現(xiàn)芯片與封裝結構的電路連接,發(fā)揮已有的功能。芯片互連常見的方法有引線鍵合(Wire Bonding,WB)、載帶自動鍵合(Tape Automated Bonding,TAB)、倒裝芯片鍵合(Flip Chip,F(xiàn)C)三種工藝。表 WB、TAB、FC三種互連技術比較
●?WB主要有合兩種方式:楔焊鍵合和球焊鍵。楔鍵合是通過楔形劈刀將熱、壓力、超聲傳給金屬絲(一般是硅鋁絲),設置一定的時間后焊接形成,焊接過程中不出現(xiàn)焊球;楔鍵合工藝中,劈刀背面有一個通孔,將金屬絲穿過通孔,與水平的被鍵合表面成30°~60°傾斜角度;球鍵合時將金絲穿過鍵合機劈刀毛細管,到達其頂部,利用氫氧焰或電氣放電系統(tǒng)產生電火花以熔化金屬絲在劈刀外的伸出部分,在表面張力作用下熔融金屬凝固形成標準的球形,球直徑一般是線徑的2倍~3倍,緊接著降下劈刀,在適當?shù)膲毫投ê玫臅r間內將金球壓在電極或芯片上。●?TAB鍵合技術是將芯片pad焊區(qū)與電子封裝外殼或基板上的金屬布線焊區(qū)用具有引線圖形的金屬箔絲連接的技術工藝。TAB技術相對于WB技術更容易實現(xiàn)標準化和自動化,從而實現(xiàn)產業(yè)規(guī)模生產,降低產品成本,提高生產效率。●?FC是芯片面朝下,芯片pad與基板焊區(qū)直接互連的一種方法。相對于WB和TAB互連技術,由于FC的互連省略互連線,互連產生的雜散電容、互連電容與互連電感均比WB和TAB小很多,從而有利于高頻高速電路的應用;FC占用基板面積較小,芯片安裝密度顯著提高。5.封帽(氣密性封裝)工藝
封帽工藝也叫密封,主要是針對陶瓷、金屬和玻璃等空腔外殼的密封工藝,其主要作用是保證所封閉的空腔中能具有適合標準的氣密性,主要針對集成電路制作過程中經過組裝(粘片、鍵合)并且檢驗合格后的電路進行密封處理。平行縫焊工藝和熔封工藝是常見的兩種封帽工藝。- 平行縫焊屬于電阻熔焊,在焊接時電極在移動的同時轉動(通過電極滾輪),在一定的壓力下電極之間斷續(xù)通電,進行點焊,通過流經一組平行的銅合金滾輪電極的焊接電流在電極與蓋板、蓋板與焊環(huán)之間這兩個高阻處產生焦耳熱,當溫度超過表面鍍層熔點時,鍍層熔化并形成合金后將蓋板與焊環(huán)密封。
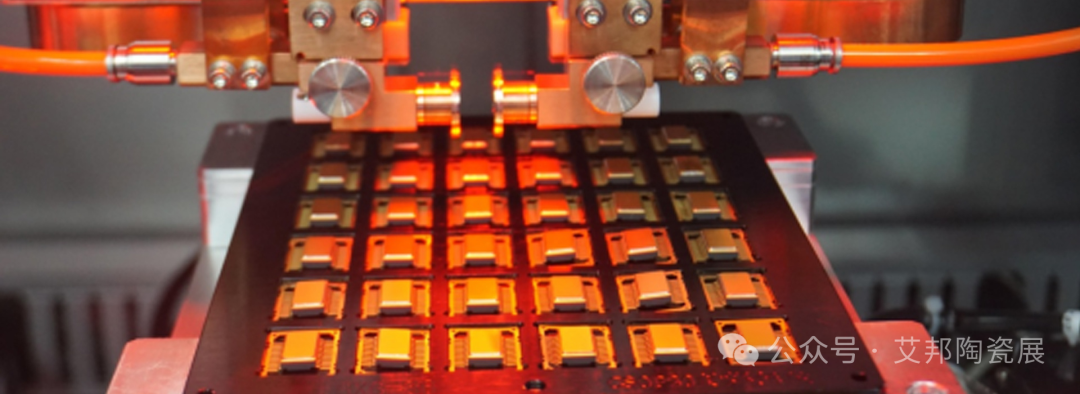
- 熔封工藝工作原理是在蓋板上預制一圈焊料環(huán),焊料環(huán)主要起到金屬活化作用,然后通過專用夾具將鍵合好的電路與蓋板固定,放入燒結爐或鏈式爐內經過一定的溫度曲線,焊料熔化,將蓋板、外殼焊接在一起形成良好的密封。
封帽工藝完成后,DIP、FP、QFP、PGA等類產品就完成了封裝,而針對于CBGA、CCGA類產品,還需要植球/植柱工藝。6.植球工藝
植球與回流焊工藝是CBGA封裝流程中的一部分。植球工藝是CBGA封裝中的關鍵工序,它是利用釬料球實現(xiàn)封裝外殼與PCB板之間的互連。CBGA封裝的植球工藝一般采用高鉛錫球作為互連材料,在一定溫度下,通過63Sn37Pb共晶焊膏熔化將封裝外殼上的金屬焊盤與高鉛錫球形成冶金連接。在此過程中,高鉛錫球不熔化。①首先,采用具有一定厚度和網孔直徑的網版通過印刷的方式將63Sn37Pb焊膏印刷到陶瓷外殼的金屬焊盤上;②然后,在已經印刷好的金屬焊盤上通過網版準確的放置高鉛錫球;③最后,確認錫球放置無問題后,將陶瓷外殼放入回流爐中,在設定好的回流溫度曲線下進行回流,一般經過預熱、活化、回流和冷卻四個階段,峰值溫度通常在210℃~235℃范圍內,此時熔化與金屬焊盤及高鉛錫球均形成可靠的冶金結合。至此,CBGA封裝的植球工藝完成。回流焊(reflow soldering)就是通過加熱使預置的釬料膏或釬料凸點重新熔化即再次流動,潤濕金屬焊盤表面形成牢固連接的過程。常用的回流焊熱源有紅外輻射、熱風、熱板傳導和激光等。資料來源:
1.CBGA(陶瓷球柵陣列)封裝關鍵工藝技術研究,尹學群.
2.高可靠陶瓷球柵陣列封裝技術研究,蒙喜鵬.
3.網絡公開信息
艾邦建有陶瓷封裝全產業(yè)鏈微信群,歡迎陶瓷封裝產業(yè)鏈上下游加入,請您識別二維碼加入。長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊The 2nd Ceramic Packages Industry Forum河北·石家莊
一、會議議題 序號 | 暫定議題 | 擬邀請 |
1 | 集成電路陶瓷封裝的發(fā)展概況 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
2 | 光通信技術的發(fā)展及陶瓷封裝外殼的應用趨勢 | 擬邀請光通信企業(yè)/封裝廠商/高校研究所 |
3 | 電子封裝陶瓷的研究進展 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
4 | 陶瓷封裝技術在傳感器領域的應用 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封裝技術 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
6 | 集成電路陶瓷封裝外殼仿真設計 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
7 | 系統(tǒng)級封裝用陶瓷材料研究進展和發(fā)展趨勢 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
8 | 基于3D-SiP集成技術的新型微波模塊 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
9 | 陶瓷封裝結構優(yōu)化及可靠性分析 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
10 | 低溫玻璃-陶瓷封裝技術的研究進展 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
11 | 低溫共燒陶瓷基板及其封裝應用 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
12 | 微電子陶瓷封裝的金屬化技術 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
13 | 高溫共燒陶瓷金屬化膜厚影響因素分析 | 擬邀請?zhí)沾煞庋b廠商/高校研究所 |
14 | 銅漿在多層陶瓷封裝外殼制備技術中的應用 | 擬邀請?zhí)沾煞庋b/漿料廠商/高校研究所 |
15 | 電子陶瓷封裝用玻璃粉的開發(fā) | 擬邀請?zhí)沾煞庋b/玻璃粉廠商/高校研究所 |
16 | 金屬陶瓷膠黏劑封裝工藝及可靠性研究 | 擬邀請?zhí)沾煞庋b/材料廠商/高校研究所 |
17 | 陶瓷封裝外殼釬焊工藝研究 | 擬邀請釬焊設備企業(yè)/高校研究所 |
18 | 高密度陶瓷封裝外殼散熱問題探討 | 擬邀請?zhí)沾煞庋b/材料廠商/高校研究所 |
19 | 陶瓷封裝平行縫焊工藝與技術 | 擬邀請?zhí)沾煞庋b/設備廠商/高校研究所 |
20 | 陶瓷封裝缺陷自動檢測技術 | 擬邀請檢測方案商 |
21 | 傳感器技術的發(fā)展及陶瓷封裝的應用趨勢 | 擬邀請傳感器/封裝廠商/高校院所 |
22 | 紅外探測器技術的發(fā)展及陶瓷封裝的應用趨勢 | 擬邀請?zhí)綔y器/封裝廠商/高校院所 |
更多議題征集中,歡迎自擬或者推薦議題。演講&贊助&會議報名請聯(lián)系李小姐:18124643204(同微信)方式一:加微信
李小姐:18124643204(同微信)
郵箱:lirongrong@aibang.com
掃碼添加微信,咨詢展會詳情


https://www.aibang360.com/m/100216?ref=196271點擊閱讀原文,即可在線報名!
原文始發(fā)于微信公眾號(艾邦陶瓷展):?一文了解陶瓷外殼封裝工藝流程