陶瓷外殼的發展趨勢是單芯片外殼的高性能化和多芯片外殼的高集成化,在億萬門級FPGA、高端CPU、系統級SiP封裝等產品需求的驅動下,封裝密度提升、小型化需求對陶瓷外殼布線提出了精細加工的要求,線寬/線距向小于50um/50um的方向發展,全自動標準化生產方式將外殼加工效率和產品品質提升到新的高度。

陶瓷外殼在高性能、多功能薄型化、輕量化、集成化等器件中的應用,對高導熱率的AIN陶瓷、大于700MPa抗彎強度A12O3陶瓷、與PCB板熱膨脹系數更匹配的高膨脹系數陶瓷、高速高頻用低損耗陶瓷及銅基低方阻漿料等新型材料和新型外殼提出了更迫切的需求。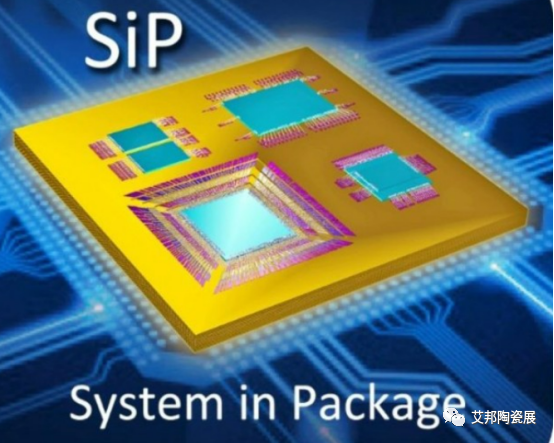
系統級封裝(SiP)集成了引線鍵合、倒裝焊和無源器件焊接等工藝,需要陶瓷外殼鍍層同時滿足引線鍵合和焊接要求合理布局、鍍層優化調整是外殼單位設計制造高端產品的關鍵。Ni/Pd/Au鍍層在同時滿足引線鍵合和焊接需求上,有顯著優勢,是系統級封裝外殼解決金屬化鍍層難題的關鍵。以陶瓷為主體,在進行金屬化之后,形成金屬陶瓷外殼。金屬陶瓷外殼作為集成電路的關鍵組件之一,起著電路支撐、電信號傳輸、散熱、密封及化學防護等作用,在對電路的可靠性影響以及電路成本的占比方面,外殼均占有重要地位。金屬陶瓷封裝技術向高密度、高性能、小型化模塊化方向發展,系統級封裝(SiP)以集成信號處理、存儲、傳輸等功能的優勢,是電子器件實現高性能、小型化的有效途徑。隨著封裝密度提升帶來的信號/申源完整性、散執、工藝兼容性、可制造性等問題,封裝工藝板級組裝應用與封裝設計將更緊密的聯合在一起,芯片、外殼、封裝與應用的協同設計仿真將大大縮短產品開發周期。
以CQFN/CDFN、CSOP為代表的表貼類器件需求的增加,對窄間距裝片、低弧度鍵合、窄邊框封帽等小型化、精細封裝工藝能力提出了新的要求:具有高導熱系數的燒結銀材料也將在金屬陶瓷封裝行業得到廣泛應用。由于集成電路的大規模增長需要,2022年陶瓷外殼需求將保持較大增速增長,陶瓷外殼、金屬外殼封裝業務也將持續增長。國內主要的陶瓷外殼生產企業有河北中瓷電子(003031)、潮州三環集團(300408)、合肥圣達、宜興電子器件、嘉興佳利電子、福建閩航、合肥伊豐、成都宏科、深圳瓷金、合肥中航天成等。文章引用:楊兵,陳波.中國金屬、陶瓷封裝產業調研報告
原文始發于微信公眾號(艾邦陶瓷展):金屬陶瓷外殼發展趨勢