電子封裝材料一般要具備與芯片相匹配的熱膨脹系數,同時具有很好的散熱性能。而廣義的電子封裝材料指除芯片以外,封裝體中剩下的所有部分,包括封裝外殼、基板、鍵合線、粘結材料、引線框架、封裝體底部焊點、散熱片等。
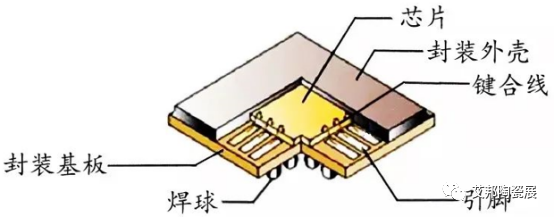

陶瓷封裝外殼主要對芯片和引線框架起到密封和保護的作用,通常需要具有與芯片相匹配的熱膨脹系數,散熱性較好且與內部器件的黏結性較好。目前而言,在導熱和可靠性要求較高的場合,會采用陶瓷封裝,比如一些軍用模塊、激光雷達、通訊器件等會使用陶瓷封裝。
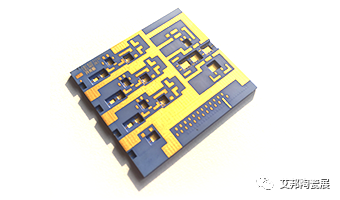
基板主要對芯片起到固定、支撐、散熱以及連接下層電路板的作用,在很多封裝形式當中可能不涉及基板,而是芯片直接貼裝在引線框架上。基板通常可以分為樹脂基板、陶瓷基板、金屬基板。常見的樹脂基板有玻璃纖維增強環氧樹脂基板、BT樹脂基板,常見的陶瓷基板為高溫共燒陶瓷基板(HTCC)和低溫共燒陶瓷基板(LTCC),金屬基板有銅基板、鋁基板。

引線框架的主要作用是承托芯片和外引管腳。一般需要具備高導電、導熱性,良好的熱匹配,良好的耐蝕性和抗氧化性。引線框架采用的材料一般為銅合金或鐵鎳合金。對于小尺寸芯片,引線框架一般采用綜合性能較好的銅合金(包括銅-鐵系,銅-鎳-硅系,銅-鉻系,銅-鎳-錫系),而一般的芯片則采用鐵鎳合金作為引線框架,其表面鍍銅。4、鍵合線

常用的鍵合線為金線、銅線或鋁線。鍵合線常用來連接芯片焊點和引線框架或基板,以實現芯片和外電路的電氣連接。鍵合線一般應具備良好的導電、導熱性,且與芯片之間焊接性良好。

粘結材料是將芯片與承載體連接的材料,以起到固定芯片的作用(因為處于芯片和基板之間,未在圖1中顯示出來)。一般應具有物理、化學性能穩定,導電導熱性強,低固化溫度等要求。根據貼裝方式的不同,常用的粘結材料有銀漿、低熔點玻璃、導電膠、環氧樹脂、金屬-硅共晶體。

焊點指的是封裝體底部與電路板連接時的焊球以及焊球與封裝體連接使用的共晶焊料。通常陶瓷球柵陣列封裝(CBGA)會采用底部焊點與電路板相連,其焊球材料為高溫共晶焊料10Sn90Pb,焊球和封裝體的連接采用低溫共晶焊料63Sn37Pb。
由于芯片封裝的形式多樣,涉及的材料種類也比較多,不同的封裝類型涉及的相關材料也不太一樣,這里只是列舉出常見的一些在陶瓷封裝中需要應用到的材料。
原文始發于微信公眾號(艾邦加工展):?一文看懂陶瓷封裝所需材料