隨著 IC 封裝技術向高密度、高性能、低成本的方向發展,陶瓷球柵陣列(CBGA,Ceramic Ball Grid Array)封裝已成為解決高密度、高可靠封裝的重要手段之一。艾邦建有陶瓷封裝全產業鏈微信群,歡迎陶瓷封裝產業鏈上下游加入,請您識別二維碼加入。長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊1、BGA技術的發展
?BGA 技術的研究始于上個世紀 60 年代,最早被美國IBM公司采用,但一直到 90 年代初,BGA 才真正進入實用化的階段。BGA 技術采用的是一種全新的設計思維方式,它采用將圓型或者柱狀點隱藏在封裝下面的結構,引線間距大、引線長度短。這樣,BGA 就消除了窄節距(QFP 系列)器件中由于引線問題而引起的共平面度和翹曲的問題。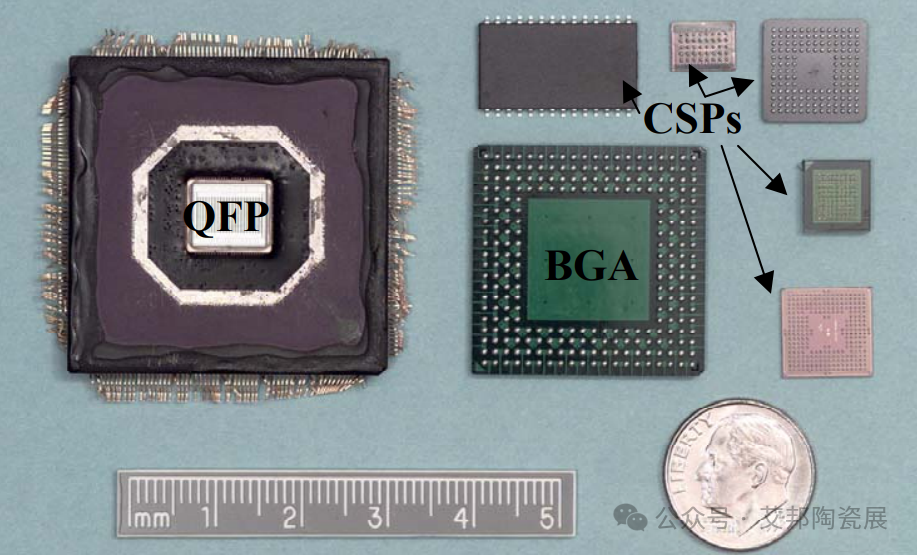
圖 表面貼裝電子封裝的小型化趨勢,從四邊引線扁平封裝 (QFP) 到球柵陣列封裝 (BGA) 和芯片尺寸級封裝 (CSP)BGA 封裝現已發展成為一項成熟的高密度封裝技術。它的 I/O 引線以圓形或柱狀焊點按陣列形式分布在封裝下面,引線間距大,引線長度短,這樣 BGA 消除了精細間距器件中由于引線而引起的共面性和翹曲的問題。BGA 技術的優點是可增加 I/O 數和間距,消除 QFP 技術的高 I/O 數帶來的生產成本和可靠性問題。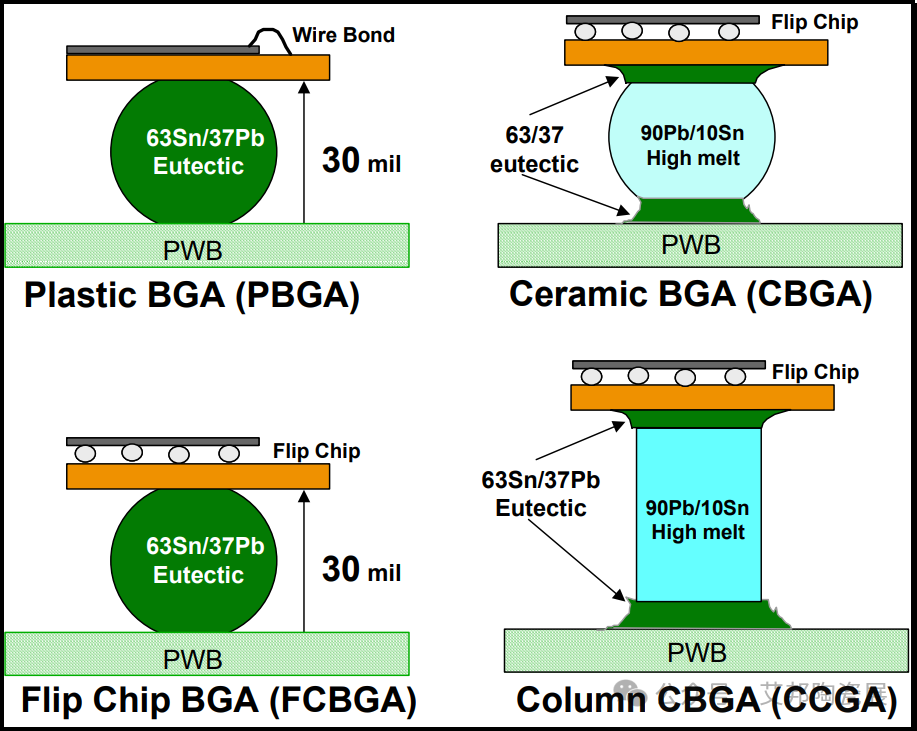
BGA 封裝主要用于高密度、高性能器件的封裝,主要適用于 PC 芯片組、微處理器/控制器、ASIC、門陣列、存儲器、DSP、FPGA 等器件的封裝。BGA 封裝按基板種類與結構可分為塑封BGA(PBGA)、陶瓷 BGA (CBGA)、陶瓷焊柱 BGA(CCGA)、載帶 BGA 等。2、陶瓷球柵陣列(CBGA)的特點
作為BGA的一種封裝形式,陶瓷球柵陣列(CBGA)的基板是多層陶瓷,金屬蓋板用密封焊料焊接在基板上,用以保護芯片、引線及焊盤。焊球材料為高溫共晶焊料10Sn90Pb(熔點300℃左右),焊球和封裝體的連接需使用低溫共晶焊料63Sn37Pb(熔點183℃),在焊接過程中,共晶釬料膏熔化,而焊球不熔化,保持接頭的高度,提高了接頭的可靠性。由于CBGA具有優異的熱性能和電性能,同時具有良好的氣密性和抗濕氣性能高,是一種高可靠高性能的封裝,這使其在航空、航天、兵器、船舶等領域的電子設備中廣泛使用。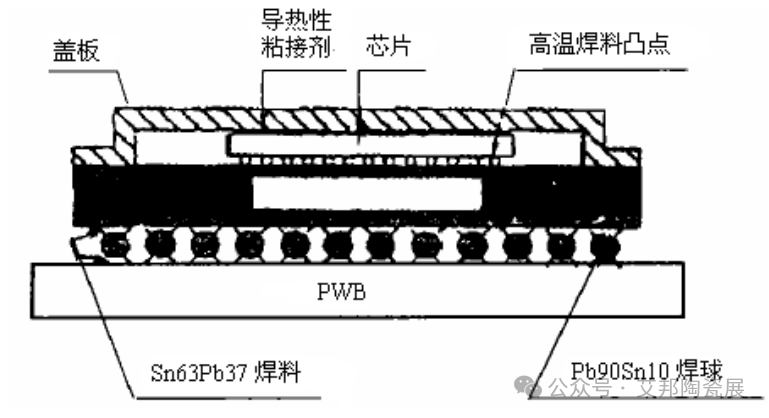
CBGA 封裝的主要優點有:
(1)封裝與電路板互連的電感減小改善了電性能。
(2)散熱效率高,熱性能好。
(3)具有良好的密封性能,對濕氣不敏感。
(4)封裝組件的可靠性高,由于從可控塌陷芯片互連(Controcced Collapse Chip Connection,C4)直接擴展而來。為面陣式倒裝互連建立的焊接疲勞的許多基本模型、方法和條件,都可直接應用于 CBGA 的互連。
(5)封裝密度高(焊球為全陣列分布),適用于 I/O 數大于 250 的電子組裝應用。
(6)共面性好,焊點成形容易,目前的共面性指標要求為 0.1mm。對于陶瓷球柵陣列封裝而言,由于陶瓷和印制電路板之間的熱脹冷縮引起的熱失配較大,從而使得在通電和斷電過程中因溫度變化而在焊點上引起很大的變形,其變形量受到焊點的幾何參數、焊盤尺寸以及焊球體積等因素的影響。CBGA 封裝的主要缺點有:
(1)由于熱膨脹系數不同。因此和環氧樹脂印制電路板的熱匹配性差。焊點疲勞是主要失效形式;
(2)焊球在封裝體邊緣的對準困難;
表 CBGA 與 CCGA 的優缺點對比
由于 CBGA 封裝的復雜性以及相對高的費用,使得 CBGA 被局限應用于高性能、高 I/O 數要求的電子產品。CBGA 有優異的熱性能和電性能,同時氣密性好,抗濕氣性能高,因而封裝組件的長期可靠性高,CBGA 工藝技術水平很高,系列產品化的 CBGA 產品的引腳數達 1000pin 以上,但由于 CBGA 實裝中存在 PCB 和多層陶瓷載體之間的熱膨脹系數不匹配問題,從而在熱循環中造成封裝尺寸較大的 CBGA 焊點失效,一般認為封裝體的尺寸小于 32mm×32mm 的 CBGA 封裝均可滿足熱循環實驗要求,而對應較大尺寸的陶瓷封裝來說,國際上一般考慮陶瓷柱柵陣列(CCGA)封裝形式,CCGA 是 CBGA 的改進型,它采用焊料圓柱陣列來替代 CBGA 的焊料球陣列,以提高其焊點的抗疲勞性能,這是因為柱狀結構更能緩解由熱失配引起的陶瓷載體和PCB板之間的剪切應力。與 CBGA 相比,CCGA 適用于更大尺寸的封裝和更多的 I/O 引腳數,而且耐高溫、高壓。資料來源:
1.BGA技術成為現代組裝技術的主流,鮮飛.
2.陶瓷陣列封裝的兩種形式及其接頭可靠性,張成敬,王春青.
3.CBGA(陶瓷球柵陣列)封裝關鍵工藝技術研究,尹學群.
4.Technology Readiness Overview: Ball Grid Array and Chip Scale Packaging,Reza Ghaffarian.艾邦建有陶瓷封裝全產業鏈微信群,歡迎陶瓷封裝產業鏈上下游加入,請您識別二維碼加入。長按識別二維碼關注公眾號,點擊下方菜單欄左側“微信群”,申請加入群聊The 2nd Ceramic Packages Industry Forum河北·石家莊
序號 | 暫定議題 | 擬邀請 |
1 | 集成電路陶瓷封裝的發展概況 | 擬邀請陶瓷封裝廠商/高校研究所 |
2 | 光通信技術的發展及陶瓷封裝外殼的應用趨勢 | 擬邀請光通信企業/封裝廠商/高校研究所 |
3 | 電子封裝陶瓷的研究進展 | 擬邀請陶瓷封裝廠商/高校研究所 |
4 | 陶瓷封裝技術在傳感器領域的應用 | 擬邀請陶瓷封裝廠商/高校研究所 |
5 | 基于DPC的3D成型陶瓷封裝技術 | 擬邀請陶瓷封裝廠商/高校研究所 |
6 | 集成電路陶瓷封裝外殼仿真設計 | 擬邀請陶瓷封裝廠商/高校研究所 |
7 | 系統級封裝用陶瓷材料研究進展和發展趨勢 | 擬邀請陶瓷封裝廠商/高校研究所 |
8 | 基于3D-SiP集成技術的新型微波模塊 | 擬邀請陶瓷封裝廠商/高校研究所 |
9 | 陶瓷封裝結構優化及可靠性分析 | 擬邀請陶瓷封裝廠商/高校研究所 |
10 | 低溫玻璃-陶瓷封裝技術的研究進展 | 擬邀請陶瓷封裝廠商/高校研究所 |
11 | 低溫共燒陶瓷基板及其封裝應用 | 擬邀請陶瓷封裝廠商/高校研究所 |
12 | 微電子陶瓷封裝的金屬化技術 | 擬邀請陶瓷封裝廠商/高校研究所 |
13 | 高溫共燒陶瓷金屬化膜厚影響因素分析 | 擬邀請陶瓷封裝廠商/高校研究所 |
14 | 銅漿在多層陶瓷封裝外殼制備技術中的應用 | 擬邀請陶瓷封裝/漿料廠商/高校研究所 |
15 | 電子陶瓷封裝用玻璃粉的開發 | 擬邀請陶瓷封裝/玻璃粉廠商/高校研究所 |
16 | 金屬陶瓷膠黏劑封裝工藝及可靠性研究 | 擬邀請陶瓷封裝/材料廠商/高校研究所 |
17 | 陶瓷封裝外殼釬焊工藝研究 | 擬邀請釬焊設備企業/高校研究所 |
18 | 高密度陶瓷封裝外殼散熱問題探討 | 擬邀請陶瓷封裝/材料廠商/高校研究所 |
19 | 陶瓷封裝平行縫焊工藝與技術 | 擬邀請陶瓷封裝/設備廠商/高校研究所 |
20 | 陶瓷封裝缺陷自動檢測技術 | 擬邀請檢測方案商 |
更多議題征集中,歡迎自擬或者推薦議題。演講&贊助&會議報名請聯系李小姐:18124643204(同微信)方式一:加微信
李小姐:18124643204(同微信)
郵箱:lirongrong@aibang.com
掃碼添加微信,咨詢展會詳情


https://www.aibang360.com/m/100216?ref=196271點擊閱讀原文,即可在線報名!
原文始發于微信公眾號(艾邦陶瓷展):一文了解陶瓷球柵陣列(CBGA)封裝