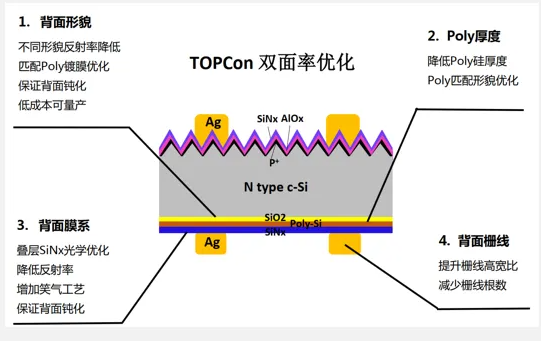
1)金屬化成本降低,通過(guò)SMBB、激光轉(zhuǎn)印和柵線(xiàn)圖形優(yōu)化等技術(shù)降低銀漿使用量;
2)硅材料降本,目前N型硅片較P型存在6%-8%的溢價(jià),通過(guò)大尺寸薄片化降低硅片成本,目前減薄帶來(lái)的價(jià)格下降低于節(jié)省的硅料成本,未來(lái)不排除電池廠(chǎng)尋求代切片服務(wù)代替購(gòu)買(mǎi)成品的可能性;
3)通過(guò)提高單臺(tái)產(chǎn)能達(dá)到降本;
4)提升工藝,雙面鈍化工藝以及摻雜技術(shù)優(yōu)化提升效率達(dá)到降本目的。同時(shí)TOPCon主流的LPCVD工藝存在石英管/舟損耗問(wèn)題,目前可以通過(guò)涂層工藝將石英管壽命提升至4-12個(gè)月,石英舟壽命約6個(gè)月對(duì)應(yīng)清洗周期15天,當(dāng)前每年更換2-3次爐管,石英件成本200萬(wàn)/GW,仍存在較大降本空間。?
TOPCon量產(chǎn)效率突破25%,效率提升路徑清晰。目前先導(dǎo)智能的GW級(jí)TOPCon整線(xiàn)量產(chǎn)效率突破25%。下階段TOPCon引進(jìn)激光SE技術(shù)預(yù)計(jì)可將轉(zhuǎn)換效率提升至25.5%。后續(xù)通過(guò)引入Poly finger以及雙面Poly技術(shù)可將轉(zhuǎn)換效率提升至26%以上。進(jìn)一步細(xì)分,柵線(xiàn)高寬比優(yōu)化以及金屬?gòu)?fù)合提升分別帶來(lái)約0.30%效率提升,背面吸收光優(yōu)化提升約0.10%,正背面鈍化提升以及金屬接觸提升預(yù)計(jì)也可分別帶來(lái)0.15%效率提升;硅片品質(zhì)也可帶來(lái)0.25%左右的效率提升。
TOPCon多種技術(shù)路線(xiàn)并存,PECVD潛力值得期待
TOPCon制備關(guān)鍵-氧化層與摻雜多晶硅層的沉積。根據(jù)氧化層和摻雜多晶硅層的沉積方法的不同,TOPCon存在多種制備路徑。氧化硅層制備中,濕化學(xué)氧化法多屬于實(shí)驗(yàn)室制備方案,工業(yè)上以熱氧化和PEALD為主。摻雜多晶硅薄膜層則使用薄膜沉積設(shè)備,一般劃分為PVD、CVD以及ALD技術(shù)。PVD技術(shù)沉積速率最快但后盾均勻性較差,可應(yīng)用于HJT的透明電極;CVD技術(shù)主要包含PECVD和LPCVD應(yīng)用最為廣泛,CVD設(shè)備成熟度較高,沉積速率和鍍膜均勻性也較為均衡;ALD設(shè)備沉積速率最慢但均勻性最好。
Topcon主流量產(chǎn)路線(xiàn)?
TOPCon存在四種主流量產(chǎn)路徑,LPCVD+磷擴(kuò)占據(jù)上半年90%的出貨。
1)LPCVD法,即低壓化學(xué)氣相沉積,在低壓條件下熱分解氣體源或化學(xué)反應(yīng)沉積所需薄膜,目前行業(yè)占比約67%,國(guó)內(nèi)外起步較早,基礎(chǔ)工藝成熟但原位摻雜速率較慢一般配合磷擴(kuò)散爐且存在較重的繞鍍問(wèn)題,但拉普拉斯使用水平插片可將繞鍍控制在10mm以?xún)?nèi),預(yù)計(jì)年底推廣;
2)PECVD法,即等離子體增強(qiáng)化學(xué)氣相沉積,借助微波或射頻等使含有薄膜組成原子的氣體,在局部形成等離子體,而等離子體化學(xué)活性很強(qiáng),很容易發(fā)生反應(yīng),在基片上沉積薄膜,目前行業(yè)占比約24%,PECVD的優(yōu)勢(shì)在于可以實(shí)現(xiàn)SiO2隧穿層,poly層,原位摻P三合一,減少設(shè)備數(shù)量提升生產(chǎn)效率,但PECVD沉積的SiO2隧穿層均勻性較差影響轉(zhuǎn)換效率,同時(shí)存在一定的繞鍍的問(wèn)題;
3)PEALD+PECVD法,使用PEALD沉積SiO2隧穿層解決原有的不均勻性問(wèn)題,同時(shí)使用PECVD可以較好的完成poly層沉積和原位摻雜,減少繞鍍;
4)PVD法,即物理氣相沉積,利用氧氣電離形成隧穿、硅源靶材轟擊的方式進(jìn)行沉積Poly,不存在繞鍍問(wèn)題,但受制于設(shè)備價(jià)格高且良率約95%低于LPCVD的97%,產(chǎn)業(yè)化進(jìn)度較慢,行業(yè)占比約9%。
TOPCon設(shè)備各技術(shù)路線(xiàn)進(jìn)展
LPCVD線(xiàn)路-50GW級(jí)別量產(chǎn),技術(shù)明確正處于快速擴(kuò)張期
LPCVD技術(shù)路線(xiàn)成膜速率在5-8nm/min,使用單插時(shí)4300pcs,雙插時(shí)8000pcs具備產(chǎn)能大,氧化生長(zhǎng)質(zhì)量高等優(yōu)勢(shì),同時(shí)LAPLACE水平插片可將繞鍍控制在10mm以?xún)?nèi)。
GW級(jí)別的量產(chǎn)效率達(dá)到24.9%,研發(fā)實(shí)驗(yàn)室效率來(lái)到了25.7%,同時(shí)GW級(jí)別的產(chǎn)品良率達(dá)到97%,在效率、良率、產(chǎn)能以及成本上達(dá)成了較好的兼顧。
目前仍存在的問(wèn)題是石英件的損耗,以目前每年200萬(wàn)元/GW的成本計(jì)算,預(yù)計(jì)增加0.002元/W的成本,同時(shí)沉積速率仍然較慢,存在改良空間。
PECVD線(xiàn)路-16GW規(guī)模待產(chǎn),潛力值得期待
PECVD技術(shù)路線(xiàn)成膜速率在10nm/min,采用原位三合一方式,生產(chǎn)效率較高設(shè)備機(jī)臺(tái)數(shù)更低,繞鍍面積在2mm以?xún)?nèi),但良率以及效率數(shù)據(jù)仍舊等待GW級(jí)驗(yàn)證。
但PECVD生產(chǎn)的氧化層不均勻?qū)е滦孰x散性較高,原位摻雜也會(huì)導(dǎo)致陶瓷環(huán)導(dǎo)電縮短石墨舟的維護(hù)周期,同時(shí)也存在PH3消耗過(guò)高等問(wèn)題。PECVD設(shè)備投入低于LPCVD,生產(chǎn)效率較高若良率驗(yàn)證具備優(yōu)勢(shì),未來(lái)有望迎來(lái)較大規(guī)模擴(kuò)張。
PVD線(xiàn)路-6GW量產(chǎn),保養(yǎng)周期長(zhǎng)良率數(shù)據(jù)不理想
PVD技術(shù)路線(xiàn)由江蘇杰太主導(dǎo),磁控濺射需要用到靶材,雖然PVD不存在繞鍍現(xiàn)象,但PVD設(shè)備每30天需要保養(yǎng)約2天,同時(shí)更換靶材也需要3天時(shí)間,GW級(jí)別驗(yàn)證的量產(chǎn)效率為24.5%,良率僅為95%,明顯低于LPCVD路線(xiàn),同時(shí)設(shè)備價(jià)格也高于LPCVD路線(xiàn),現(xiàn)階段PVD路線(xiàn)優(yōu)勢(shì)不明顯,未來(lái)擴(kuò)產(chǎn)速度將會(huì)低于LPCVD和PECVD。
來(lái)源:東北證券
原文始發(fā)于微信公眾號(hào)(光伏產(chǎn)業(yè)通):TOPCon降本路徑及設(shè)備各技術(shù)路線(xiàn)進(jìn)展