該文主要內(nèi)容引用英特爾一篇技術(shù)文章“Thermo-compression Bonding for Fine-pitch Copper-pillar Flip-chip Interconnect– Tool Features as Enablers of Unique Technology”
2010年Iphone 4橫空出世,輕薄又強(qiáng)大的性能深深震撼了消費(fèi)者。消費(fèi)電子產(chǎn)業(yè)注定要在輕薄的賽道上狂飆猛進(jìn),而PC領(lǐng)域更不會(huì)獨(dú)善其身。
很快時(shí)間來(lái)到了2年后,全球半導(dǎo)體領(lǐng)導(dǎo)者英特爾的芯片封裝研發(fā)總部的會(huì)議室進(jìn)行著一場(chǎng)激烈的技術(shù)路線定型爭(zhēng)論,爭(zhēng)論的最終結(jié)果必將深刻的影響公司的下一世代的全球競(jìng)爭(zhēng)力,數(shù)百億美元的投資以及龐大的供應(yīng)鏈的去存。當(dāng)前成熟的倒裝回流焊(Flip Chip Mass Reflow) 封裝工藝注定很快成為明日黃花,其已經(jīng)無(wú)法應(yīng)對(duì)新產(chǎn)品對(duì)輕薄的高要求,尤其是切入到14nm工藝后,基板(substrate)和晶片的厚度將成倍下降,熱應(yīng)力下的翹曲效應(yīng)使得凸點(diǎn)橋接(Solder Bump Bridge) 失效異常嚴(yán)重。
?
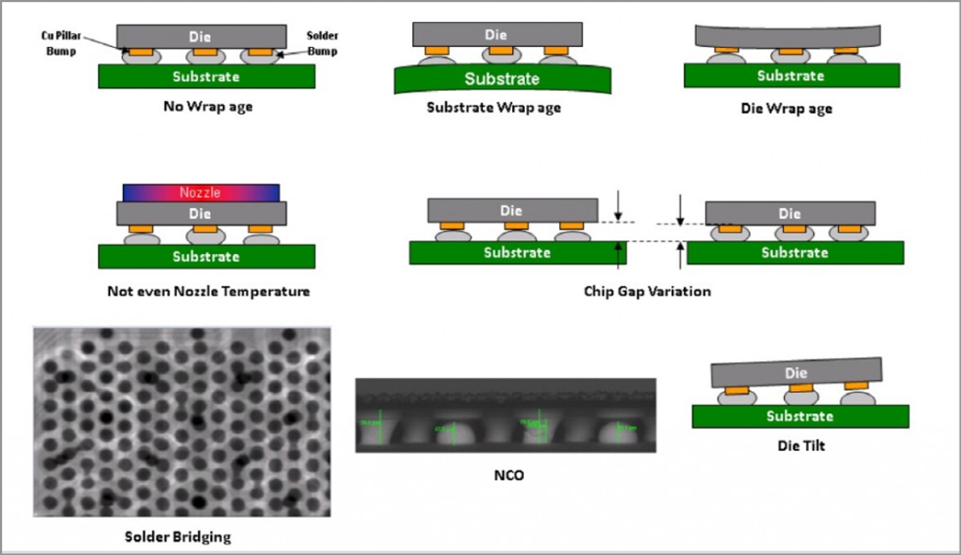
行業(yè)巨頭們都在提出自己的方案,簡(jiǎn)而言之兩個(gè)方向,要么將晶圓的刻蝕工藝拓展到封裝,要么在兼容當(dāng)前的基板封裝但研發(fā)全新的設(shè)備和工藝解決翹曲問(wèn)題。每個(gè)方案都牽扯到巨額的成本問(wèn)題。尤其是對(duì)于英特爾而言,PC行業(yè)的生態(tài)鏈龐大而復(fù)雜,放棄兼容性無(wú)異于傷筋動(dòng)骨甚至自廢武功。
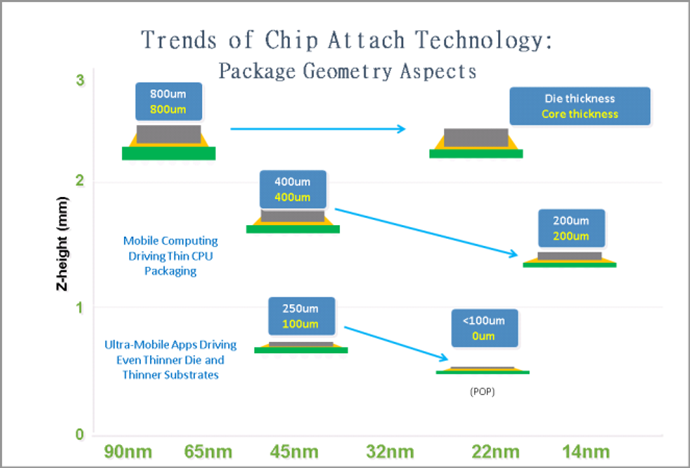
最終基板封裝方案獲得了勝利,下游廠商的兼容性得到照顧,所有的人都心潮澎湃,因?yàn)檫@必將是場(chǎng)豪賭,新一代的封裝設(shè)備將挑戰(zhàn)機(jī)械加工的極限。對(duì)新設(shè)備的要求無(wú)比苛刻: 能貼裝更薄的晶片,支持多晶片貼裝,更小的晶片間距離,更緊密的凸點(diǎn)陣列,以及3D晶片堆疊。事實(shí)上就連英特爾公司總部也為這個(gè)賭注深深捏了把汗。
工藝方向很明確:熱壓鍵合 (Thermo-compression Bonding, TCB)。這項(xiàng)工藝并不是新事物,早在上世紀(jì)八九十年代,摩托羅拉公司就有過(guò)應(yīng)用。然而新紀(jì)元對(duì)設(shè)備的精度要求卻不可同日而語(yǔ)。其工藝機(jī)理如下圖:
-> BondHead(貼片頭)自帶加熱源,可以將撿起的晶片(Die)迅速加熱到臨界錫球融化溫度;
-> 在基板于晶片的凸點(diǎn)物理位置接觸的一瞬間, BondHead從壓力敏感控制轉(zhuǎn)為位置敏感控制,并迅速加熱到錫球融化溫度以上保持?jǐn)?shù)秒,之后BondHead迅速冷卻,使得上下凸點(diǎn)之間的連接變?yōu)楣滔唷:附舆^(guò)程完成。
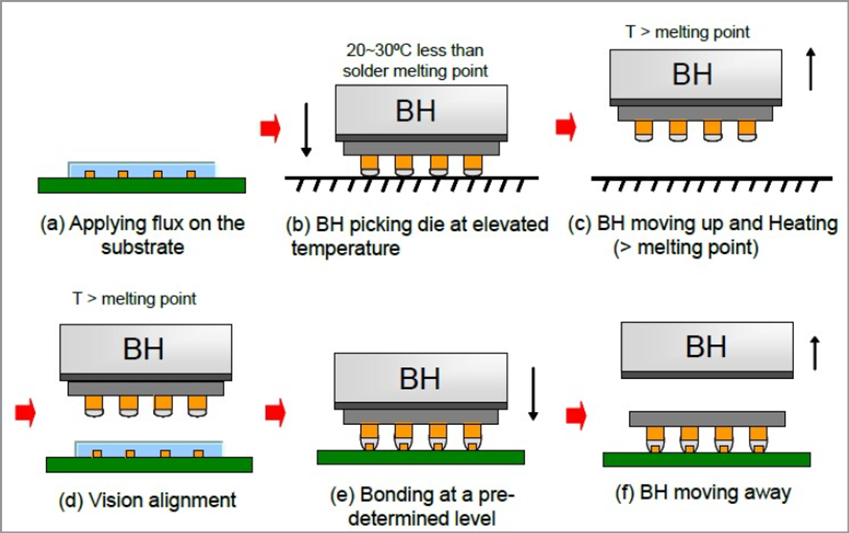
該工藝的設(shè)備關(guān)鍵工藝指標(biāo)最主要有兩點(diǎn):一是貼放的精度,在Z方向位置控制靈敏度要達(dá)到驚人的1微米,且與壓力控制轉(zhuǎn)換無(wú)縫銜接(因?yàn)橥裹c(diǎn)錫球融化后,變?yōu)橐簯B(tài),此時(shí)壓應(yīng)力突然消失,貼片頭必須靠高精度的位置控制保持晶片和基板的距離);二是極快的加熱降溫能力,這是為了提高生產(chǎn)效率,如果以1分鐘加工1顆芯片的效率來(lái)估算,就算一條標(biāo)準(zhǔn)的TCB產(chǎn)線(包含4個(gè)熱壓鍵和頭) 12h加工能力不到3k顆,大概只有傳統(tǒng)的回流焊效率的十分之一到五分之一,這對(duì)量產(chǎn)來(lái)講簡(jiǎn)直就是災(zāi)難。
設(shè)備原型機(jī)的訂單很快拋給了幾家有實(shí)力也有意向的供應(yīng)商,有的廠家看到技術(shù)指標(biāo)大呼不可能,很快放棄了英特爾的橄欖枝。面對(duì)難以逾越的技術(shù)鴻溝,ASM Pacific一開始并不是最有希望的,但誘惑是巨大的,一旦成功ASM-P將晉升細(xì)分領(lǐng)域的頂尖玩家,執(zhí)行業(yè)之牛耳。ASM-P為此做了充分準(zhǔn)備,調(diào)動(dòng)公司的一切資源,聘請(qǐng)行業(yè)的大咖,以期能實(shí)現(xiàn)技術(shù)上的突破,正如該公司一路走來(lái)發(fā)展為行業(yè)龍頭的故事的又一次重復(fù)。在此兩家深度捆綁,克服一個(gè)又一個(gè)的困難,最終實(shí)現(xiàn)了設(shè)備的成功開發(fā),并于2014年將設(shè)備導(dǎo)入量產(chǎn)。對(duì)英特爾來(lái)講,全新理念的TCB設(shè)備讓該公司的封裝能力有了無(wú)限可能,除了更輕薄外,還可以做更復(fù)雜的封裝,比如EMIB,F(xiàn)overos,3D Die Stack等等。而對(duì)于ASM-P來(lái)說(shuō),TCB的成功讓其一躍而成為封裝細(xì)分領(lǐng)域的龍頭之一,在先進(jìn)分裝領(lǐng)域牢牢鎖定一席之地,此后ASM-P公司繼續(xù)在SMT行業(yè)攻城略地,續(xù)寫輝煌。
至此TCB修成了正果,下一篇文章我們將繼續(xù)探索英特爾公司在TCB上的各種工藝的開發(fā)和應(yīng)用,以及其優(yōu)缺點(diǎn)。
原文始發(fā)于微信公眾號(hào)(艾邦半導(dǎo)體網(wǎng)):熱壓鍵合(TCB)與英特爾的先進(jìn)封裝
