功率轉(zhuǎn)換電路中的晶體管的作用非常重要,對(duì)其改良可以實(shí)現(xiàn)低損耗與應(yīng)用尺寸小型化。SiC 功率元器件半導(dǎo)體具有低損耗、高速開(kāi)關(guān)、高溫工作等優(yōu)勢(shì)。
目前?SiC-MOSFET 有用的范圍是耐壓 600V 以上、特別是 1kV 以上。

相對(duì)于 IGBT,SiC-MOSFET 降低了開(kāi)關(guān)關(guān)斷時(shí)的損耗,實(shí)現(xiàn)了高頻率工作,有助于應(yīng)用的小型化。
相對(duì)于同等耐壓的 SJ-MOSFET(超級(jí)結(jié) MOSFET),導(dǎo)通電阻較小,可減少相同導(dǎo)通電阻的芯片面積,并顯著降低恢復(fù)損耗。
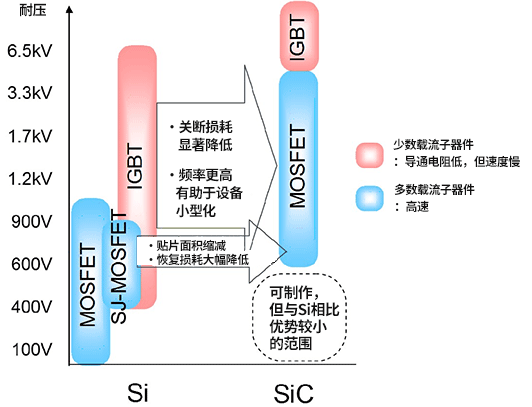
一、SiC-MOSFET 與 Si-MOSFET 的區(qū)別
與其詳細(xì)研究?SiC-MOSFET?每個(gè)參數(shù),我們可以先弄清楚驅(qū)動(dòng)方法等與 Si-MOSFET 有怎樣的區(qū)別。這里主要介紹 SiC-MOSFET 的驅(qū)動(dòng)與 Si-MOSFET的比較中應(yīng)該注意的兩個(gè)關(guān)鍵要點(diǎn)。
SiC-MOSFET 與 Si-MOSFET 相比,由于漂移層電阻低,通道電阻高,因此具有驅(qū)動(dòng)電壓即柵極-源極間電壓 Vgs 越高導(dǎo)通電阻越低的特性。下圖表示 SiC-MOSFET 的導(dǎo)通電阻與 Vgs 的關(guān)系。
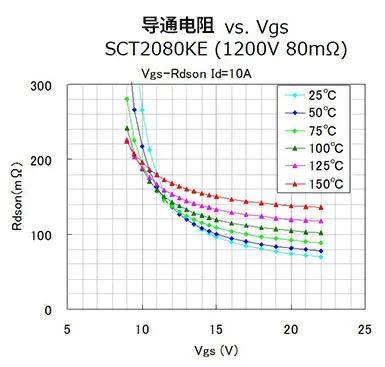
圖表示?SiC-MOSFET?的導(dǎo)通電阻與?Vgs?的關(guān)系
導(dǎo)通電阻從 Vgs 為 20V 左右開(kāi)始變化(下降)逐漸減少,接近最小值。一般的 IGBT 和 Si-MOSFET 的驅(qū)動(dòng)電壓為 Vgs=10~15V,而 SiC-MOSFET 建議在 Vgs=18V 前后驅(qū)動(dòng),以充分獲得低導(dǎo)通電阻。也就是說(shuō),兩者的區(qū)別之一是驅(qū)動(dòng)電壓要比 Si-MOSFET 高。與 Si-MOSFET 進(jìn)行替換時(shí),還需要探討柵極驅(qū)動(dòng)器電路。
2.內(nèi)部柵極電阻
SiC-MOSFET 元件本身(芯片)的內(nèi)部柵極電阻 Rg 依賴于柵電極材料的薄層電阻和芯片尺寸。如果是相同設(shè)計(jì),則與芯片尺寸成反比,芯片越小柵極電阻越高。同等能力下,SiC-MOSFET 的芯片尺寸比 Si 元器件的小,因此柵極電容小,但內(nèi)部柵極電阻增大。例如,1200V 80mΩ 產(chǎn)品(S2301 為裸芯片產(chǎn)品)的內(nèi)部柵極電阻約為 6.3Ω。
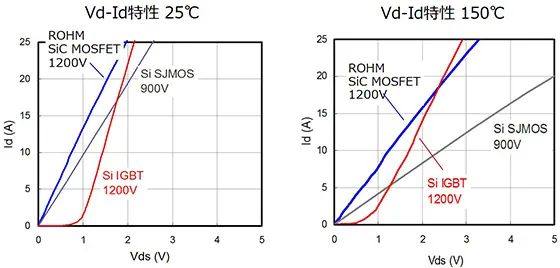
這不僅局限于 SiC-MOSFET,MOSFET 的開(kāi)關(guān)時(shí)間依賴于外置柵極電阻和上面介紹的內(nèi)部柵極電阻合在一起的綜合柵極電阻值。SiC-MOSFET 的內(nèi)部柵極電阻比 Si-MOSFET 大,因此要想實(shí)現(xiàn)高速開(kāi)關(guān),需要使外置柵極電阻盡量小,小到幾 Ω 左右。
但是,外置柵極電阻還承擔(dān)著對(duì)抗施加于柵極的浪涌的任務(wù),因此必須注意與浪涌保護(hù)之間的良好平衡。
二、SiC-MOSFET 與 IGBT的區(qū)別
1.Vd-Id特性
Vd-Id 特性是晶體管最基本的特性之一。下面是 25℃ 和 150℃ 時(shí)的 Vd-Id 特性。
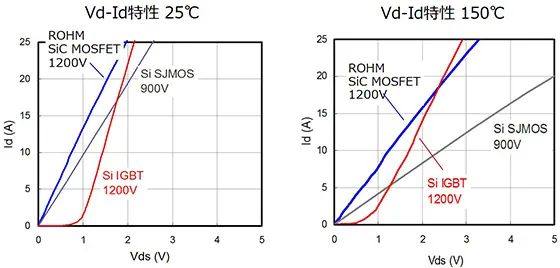
請(qǐng)看 25℃ 時(shí)的特性圖表。SiC 及 Si MOSFET 的 Id 相對(duì) Vd(Vds)呈線性增加,但由于 IGBT 有上升電壓,因此在低電流范圍 MOSFET 元器件的 Vds 更低(對(duì)于 IGBT 來(lái)說(shuō)是集電極電流、集電極-發(fā)射極間電壓)。
不言而喻,Vd-Id 特性也是導(dǎo)通電阻特性。根據(jù)歐姆定律,相對(duì) Id,Vd 越低導(dǎo)通電阻越小,特性曲線的斜率越陡,導(dǎo)通電阻越低。
IGBT 的低 Vd(或低 Id )范圍(在本例中是 Vd 到 1V 左右的范圍),在IGBT中是可忽略不計(jì)的范圍。這在高電壓大電流應(yīng)用中不會(huì)構(gòu)成問(wèn)題,但當(dāng)用電設(shè)備的電力需求從低功率到高功率范圍較寬時(shí),低功率范圍的效率并不高。
相比之下,SiC MOSFET 可在更寬的范圍內(nèi)保持低導(dǎo)通電阻。
此外,可以看到,與150℃ 時(shí)的 Si MOSFET 特性相比,SiC、Si-MOSFET 的特性曲線斜率均放緩,因而導(dǎo)通電阻增加。但是,SiC-MOSFET 在 25℃ 時(shí)的變動(dòng)很小,在 25℃ 環(huán)境下特性相近的產(chǎn)品,差距變大,溫度增高時(shí) SiC MOSFET 的導(dǎo)通電阻變化較小。
2.關(guān)斷損耗特性
前面多次提到過(guò),SiC 功率元器件的開(kāi)關(guān)特性優(yōu)異,可處理大功率并高速開(kāi)關(guān)。在此具體就與 IGBT 開(kāi)關(guān)損耗特性的區(qū)別進(jìn)行說(shuō)明。
眾所周知,當(dāng) IGBT 的開(kāi)關(guān) OFF 時(shí),會(huì)流過(guò)元器件結(jié)構(gòu)引起的尾(tail)電流,因此開(kāi)關(guān)損耗增加是 IGBT 的基本特性。
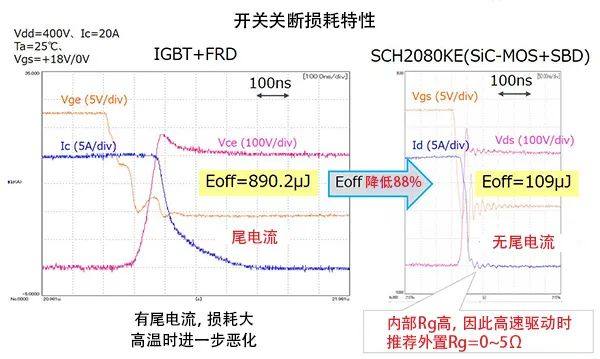
比較開(kāi)關(guān) OFF 時(shí)的波形可以看到,SiC-MOSFET 原理上不流過(guò)尾電流,因此相應(yīng)的開(kāi)關(guān)損耗非常小。在此例中,SiC-MOSFET+SBD(肖特基勢(shì)壘二極管)的組合與 IGBT+FRD(快速恢復(fù)二極管)的關(guān)斷損耗 Eoff 相比,降低了 88%。
還有重要的一點(diǎn)是 IGBT 的尾電流隨溫度升高而增加。順便提一下,SiC-MOSFET 的高速驅(qū)動(dòng)需要適當(dāng)調(diào)整外置的柵極電阻 Rg。
3.導(dǎo)通損耗特性
接下來(lái)看開(kāi)關(guān)導(dǎo)通時(shí)的損耗。
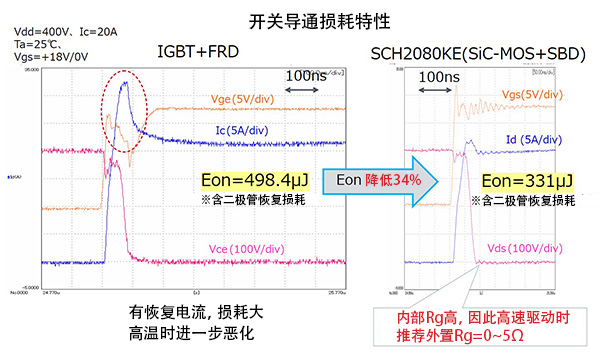
IGBT 在開(kāi)關(guān)導(dǎo)通時(shí),流過(guò) Ic(藍(lán)色曲線)用紅色虛線圈起來(lái)部分的電流。這多半是二極管的恢復(fù)電流帶來(lái)的,是開(kāi)關(guān)導(dǎo)通時(shí)的一大損耗。請(qǐng)記住:在并聯(lián)使用 SiC-SBC 時(shí),加上恢復(fù)特性的快速性,MOSFET 開(kāi)關(guān)導(dǎo)通時(shí)的損耗減少;FRD 成對(duì)時(shí)的開(kāi)關(guān)導(dǎo)通損耗與 IGBT 的尾電流一樣隨溫度升高而增加。
總之,關(guān)于開(kāi)關(guān)損耗特性可以明確的是:SiC-MOSFET 優(yōu)于 IGBT。
來(lái)源:https://techclass.rohm.com.cn/knowledge/category/sic
原文始發(fā)于微信公眾號(hào)(艾邦半導(dǎo)體網(wǎng)):一文了解 SiC-MOSFET