SiC MOSFET 器件的集成化、高頻化和高效化需求,對功率模塊封裝形式和工藝提出了更高的要求。本文將從互聯、燒結技術以及材料方面介紹未來 SiC 模塊封裝的演進趨勢。
1. 在互聯、燒結技術方面
內部互聯技術將從鋁線鍵合/超聲焊接將改用銅線方式形式,芯片/襯板燒結方式將采用銀燒結技術代替傳統 Pb/Sn 合金焊。
銀燒結工藝燒結體具有優異的導電性、導熱性、高粘接強度和高穩定性等特點。用該工藝燒結的納米銀燒模塊可長期工作在高溫環境;另外銀燒結工藝會在芯片燒結層形成可靠的機械連接和電連接,半導體模塊的熱阻和內阻均會降低,提升模塊性能及可靠性。銀燒結技術可使模塊使用壽命提高 5-10 倍,燒結層厚度較焊接層厚度薄 60-70%,熱傳導率提升 3 倍。
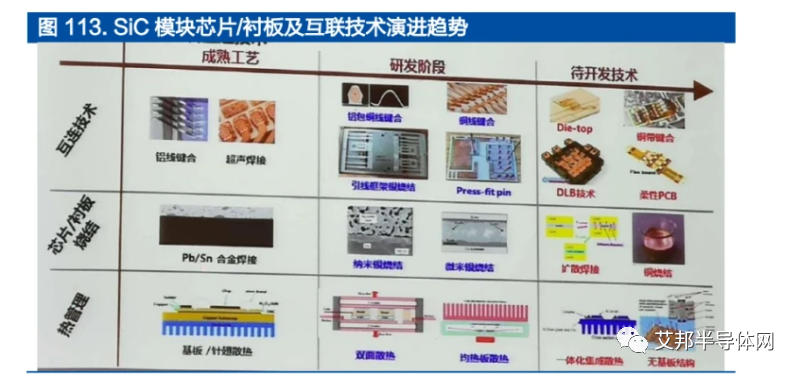
目前銀燒結技術成為國內外第三代半導體封裝技術中應用最為廣泛的技術。國內外諸多廠商把銀燒結技術作為第三代半導體封裝的核心技術,同時在此基礎上開發出雙面銀燒結技術,并將銀帶燒結在芯片正面代替了鋁線,或取消底板將基板直接燒結在散熱器上,大大簡化了模塊封裝的結構。目前銀燒結技術已經由微米銀燒結進入納米銀燒結階段,納米銀燒結與微米銀燒結技術相比連接溫度和輔助壓力均有明顯下降,極大擴大了工藝的使用范圍。
Model3 的 SiC 單管與散熱器的焊接采用銀燒結的方式。2006 年英飛凌推 出了 Easypack1 的封裝形式,分別采用單面銀燒結技術和雙面銀燒結技術。2015 年,三菱電機采用銀燒結技術制作功率模塊,循環壽命是軟釬焊料的 5 倍左右。
國內方面,斯達半導 T6 系列汽車級的單管,1200V 和 750V 兩款產品芯 片也將采用的銀燒結工藝;雙面冷卻的 N3 和 N7 系列,2022 年底也有望推出相應的碳化硅的版本數量,結構同樣采用雙面銀燒結技術。其他如芯聚能、利普思等 SiC 模塊廠商也在積極布局銀燒結封裝工藝。
伴隨銀燒結工藝成本逐步下降,將會拉動銀燒結的材料和機臺設備的市場需求。博世曼科技幫助特斯拉完成早期的碳化硅模塊的組裝,其中燒結、焊接、引線鍵合、成型、修整和成型都由其完成。2022 年 4 月 Boschman 被蘇州 寶士曼半導體設備有限公司收購,并且將在蘇州建廠。
ASMPT 太平洋科技有限公司是全球領先的先進半導體封裝設備及微電子封裝解決方案的最主要的供應商,SilverSAM 銀燒結設備具備專利防氧化及均勻壓力控制技術,除確保基本高強度燒結鍵合,對應導熱性和導電性的要求外,更能提高 IPM 芯片密度的設計,并配合未來銅燒結鍵合的方向,有效幫助 SiC 模塊充分發揮高功率的性能。
國產設備在該環節也已出現部分替代。2021 年深圳市先進連接科技有限公司的 AS(Ag-Sintering)系列燒結設備就成功中標“比亞迪半導體股份有限公司-燒結設備采購項目”。除此之外,嘉源昊澤、拓鼎電子等半導體設備公司也正在研發中。
2.在材料方面
襯板從氧化鋁升級到氮化硅、氮化鋁、AMB 厚銅襯板,塑封取代傳統灌膠。傳統的 HPD 使用氧化鋁材料,優點在于價格便宜、供應量充足,缺點在于散熱能力較差。新型基材主要是氮化硅、氮化鋁材料、AMB 厚銅襯板。氮化鋁一般用于工業領域,氮化硅常用于汽車領域,AMB 厚銅襯板用在車載 SiC 領域。
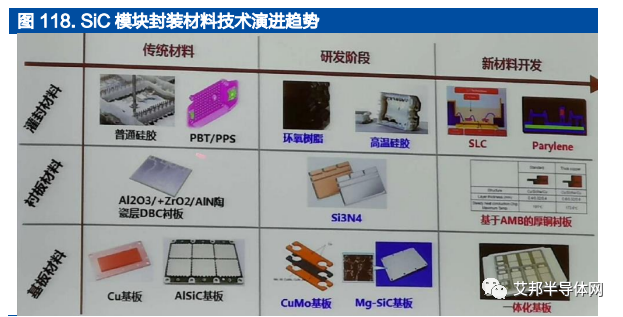
對于模塊的散熱結構來說,襯板的選擇尤為重要,目前主流的功率半導體模塊封裝主要還是用 DBC(直接鍵合銅)陶瓷基板,AMB 的熱導率比 DBC 氧化鋁高 3 倍,且機械強度及機械性能更好。隨著碳化硅功率模塊的應用逐漸成熟, AMB 有望逐漸成為電子模塊封裝的新趨勢。此外,塑封模塊相較于 hybridpack 模塊的優勢具有低雜散電感、高可靠等特性。
文章來源:https://www.vzkoo.com/question/1691981420504079
原文始發于微信公眾號(艾邦半導體網):未來 SiC 模塊封裝的演進趨勢