名古屋大學和旭化成于12月14日宣布,已成功制造出在氮化鋁(AlN)基材料中表現出理想特性的p-n結,該材料有望用作下一代半導體材料。該成果是名古屋大學未來材料與系統研究所須田淳教授、天野浩教授和旭化成聯合研究小組的成果。
"超寬帶隙"(UWBG)半導體的帶隙(禁帶寬度)比目前主要的半導體材料硅(Si)和砷化鎵(GaAs)大4至5倍以上,新一代半導體材料,世界范圍內的研究正變得更加活躍。如果UWBG半導體的研究得到發展,相信它將能夠為更高頻率的設備做出貢獻,這將提高設備的通信速度,并減少功率設備的損耗,從而進一步節省能源。 然而,UWBG半導體的一個常見技術問題是難以實現作為半導體器件基礎的理想p-n結。

因此,研究團隊通過在高質量的AlN單晶襯底上使用化學成分(含有數%至30%的AlN的氮化鎵(GaN)),開發了一種AlN基材料,它是UWBG半導體之一,通過使用一種稱為分布式偏振摻雜(DPD)的方法,該方法可以在空間上改變氮化物的量(混合),研究人員旨在創建具有優異性能的基于 AlN 的 p 層和 n 層。 此外,為了實現理想的DPD,需要高質量的薄膜晶體生長技術,因此該技術的研發也同時取得進展。
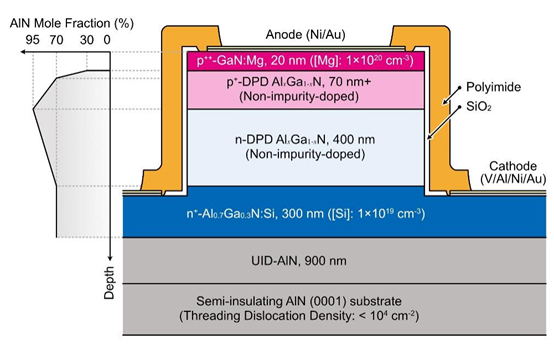
研究中,采用金屬有機化合物氣相外延(MOVPE)方法在高質量AlN(0001)襯底上形成未摻雜的AlN層和高濃度n型Al0.7Ga0.3N層后,逐漸增加AlN的摩爾分數(n型DPD層)、逐漸減少AlN的摩爾分數的層(p型DPD層),最后形成高濃度的p型GaN層。 然后,在頂部高濃度p型GaN層和底部高濃度n型Al0.7Ga0.3N層上形成電極,形成pn結二極管。
由此制造的AlN基p-n結由于電流注入而表現出理想的電流-電壓特性、電壓-電容特性和發光特性。特別是電流-電壓特性顯示出優異的耐高電壓性。關于其高耐壓特性,確定介電擊穿場強為7.3MV/cm,這是AlN基p-n結介電擊穿場強的世界最高測量值。這是傳統Si半導體的約25倍,是具有優異介電擊穿電場強度的寬帶隙WBG半導體碳化硅(SiC)和GaN的約2倍。據稱,AlN基p-n結的實現滿足所有這些優良性能在世界上是前所未有的。此外,在本研究中,沒有采取措施提高耐壓,因此預計在未來的研究中將進一步提高相同的值。
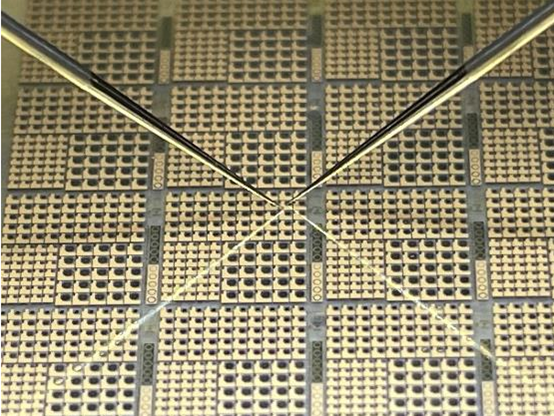
這項研究的成果是"利用高質量的AlN單晶基板基材"、"實現理想的DPD層形成的精細薄膜晶體生長技術(外延生長技術)"、"器件(pn這是通過"結型二極管(結型二極管)制造技術"的結合而實現的。 其中使用的AlN單晶基板基材是旭化成的技術,其余兩項是名古屋大學與旭化成共同研究的成果。
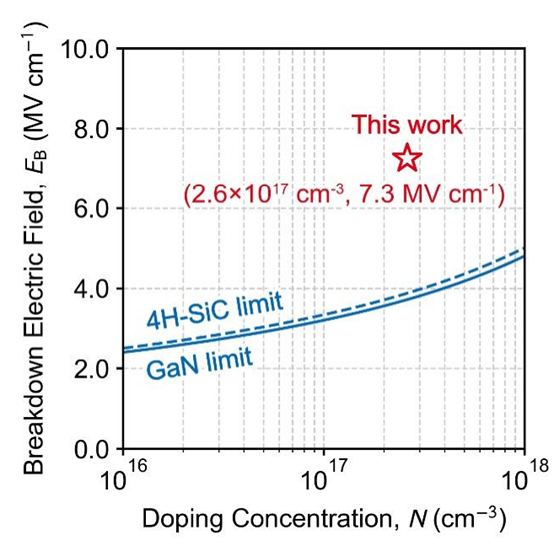
在這項研究中,實驗表明,通過使用分布式極化摻雜作為雜質摻雜的替代方案,即使在 AlN 基半導體中也可以實現良好的 p-n 結。 此外,AlN材料最重要的物理性能值——介電擊穿場強,經實驗證明至少是傳統WBG半導體的兩倍。 研究小組預計,這項研究結果將刺激對AlN基材料的研究,并擴大利用DPD的各種設備的研究和開發。