據愛企查網站信息顯示,揚杰科技近日公布了六項關于碳化硅功率器件的制備方法發明專利。

包括一種碳化硅半導體器件及其制備方法、一種提升SIC功率器件短路魯棒性的結構及制造方法、一種碳化硅MOSFET器件及其制備方法、隔離柵碳化硅晶體管及其制備方法、一種新型源區溝槽碳化硅二極管器件及其制備方法、一種碳化硅二極管器件及其制備方法專利。
其中關于“提升SIC功率器件短路魯棒性的結構及制造方法”,涉及功率半導體技術領域。包括以下步驟:步驟001,提供一種N型重摻雜類型的襯底,即為N+型SiC半導體襯底,摻雜濃度為360~400um,摻雜濃度為1e19 cm?2;N+型襯底具有兩個表面,分為正面與背面,在正面形成一層N型緩沖層,厚度為0.8~1um,摻雜濃度為1e18 cm?2;在N型緩沖層覆蓋N型輕摻雜類型的漂移層,即為N?型漂移層,厚度為5~15um,摻雜濃度為5e15~1e16 cm?2,背面形成金屬電極層;步驟002,在漂移層的表面通過光刻掩膜,進行P型摻雜形成P?Well阱區;本發明制作工藝簡單,效果顯著,可以應用于新型碳化硅MOSFET功率器件的制造。
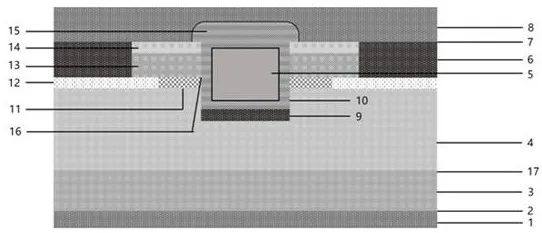
“隔離柵的碳化硅晶體管及其制備方法”,涉及半導體技術領域。包括從下而上依次連接的碳化硅襯底,碳化硅漂移層和正面金屬層;所述碳化硅漂移層的頂面設有向下延伸的PW區;所述PW區的頂面設有向下延伸的NP區;所述NP區內設有向下延伸的PP區;所述碳化硅漂移層的頂面依次設有向上伸入正面金屬層內的柵氧層和Poly層;所述碳化硅漂移層的頂面設有包裹所述柵氧層和Poly層的氧化物隔離層,所述氧化物隔離層底端分別與碳化硅漂移層和NP區連接;所述氧化物隔離層的側部設有與PP區連接的歐姆接觸金屬層。本發明一定程度上可提高器件的開關性能,降低開關損耗。
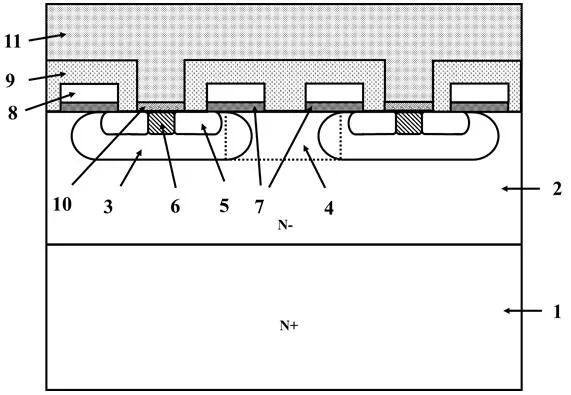
“一種新型源區溝槽碳化硅二極管器件及其制備方法”,涉及半導體技術領域。包括從下而上依次設置的背面加厚金屬、背面歐姆接觸金屬、碳化硅襯底、碳化硅外延層和N型注入區;所述N型注入區的頂面設有伸入碳化硅外延層的終端溝槽和若干間隔設置的源區溝槽;所述源區溝槽的槽底設有向下延伸的P型注入區;所述終端溝槽的頂面設有伸入碳化硅外延層的P型主結和若干間隔設置的P型分壓環;所述碳化硅外延層上設有覆蓋P型主和若干P型分壓環的場氧層;本發明在不增加單顆芯片面積和工藝復雜程度的基礎上,進一步降低了器件的正向導通壓降。
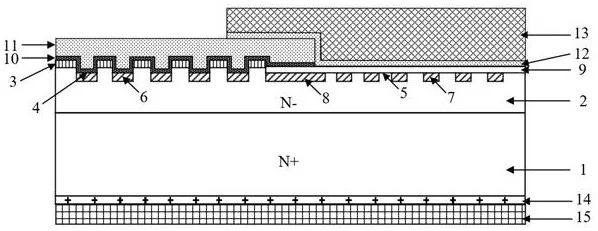
-END-
原文始發于微信公眾號(艾邦半導體網):揚杰科技公布六項關于碳化硅功率器件發明專利
