半導體晶圓面型參數TTV、BOW、Warp是芯片制造必須要考慮的因素,十分重要。這三個參數共同反映了半導體晶圓的平面度和厚度均勻性,對于許多芯片制造過程中的關鍵步驟都有直接影響。
SiC硬度高、脆性大,切割難度大,在切片和減薄的過程中容易在晶片表面和亞表面產生翹曲等質量問題,影響后道工藝的開展,因此對Warp(翹曲)、BOW(彎曲)、TTV(總厚度偏差)等精度控制要求很高。

工信部《重點新材料首批次應用示范指導目錄(2024 年版)》規定碳化硅單晶襯底(6 英寸及以上)標準:微管密度≤0.2/cm2,TTV≤10μm,BOW:-15~15μm,Warp≤35μm,表面粗糙度Ra≤0.15nm;N 型碳化硅襯底電阻率?0.015~0.025Ω·cm,BPD≤1000/cm2;半絕緣碳化硅襯底電阻率≥1010Ω·cm。

總厚度偏差——TTV(Total?Thickness?Variation)
晶片總厚度偏差TTV(Total Thickness Variation,總厚度變化)指晶圓在夾緊緊貼情況下,距離參考平面厚度的最大值和最小值的差值。一般以微米(μm)表示,一般表達形式如:TTV≤10μm。
TTV是晶圓減薄過程中的一項關鍵指標,它直接影響后續的各項封裝工藝和芯片的最終質量。如果TTV值過大,可能會導致芯片性能不穩定、封裝難度增加等問題,甚至可能使芯片失效。

彎曲度——BOW
Bow指晶圓在未緊貼狀態下,晶圓中心點表面距離參考平面的最小值和最大值之間的偏差,偏差包括凹形和凸形的情況,凹形彎曲度為負值,凸形彎曲度為正值;一般以微米(μm)表示,一般表達形式如:-15~15μm。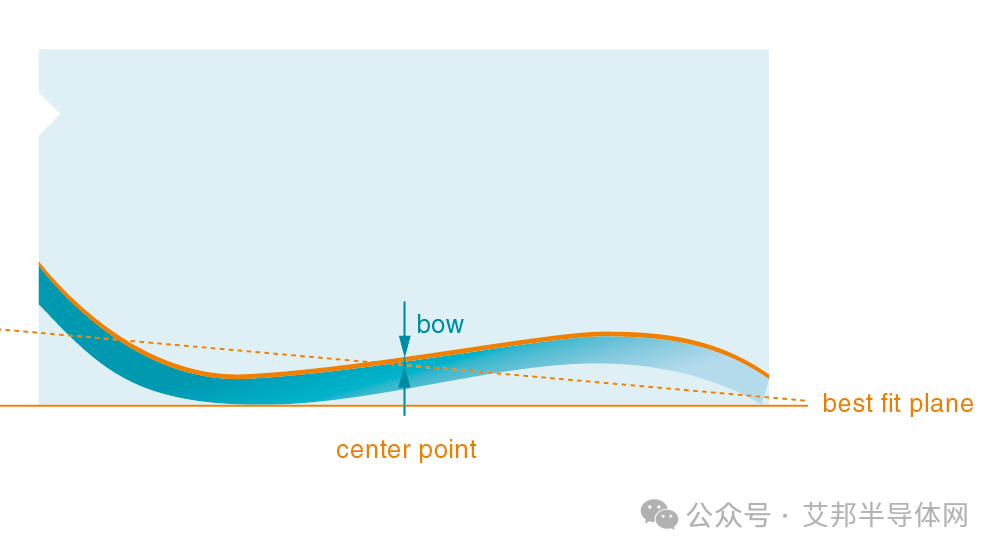
翹曲度——Warp
Warp是指晶圓的全局特性,晶圓在未緊貼狀態下,通常以晶圓背面為參考平面,測量的晶圓表面距離參考平面的最小值和最大值之間的偏差,偏差包括凹形和凸形的情況,凹形彎曲度為負值,凸形彎曲度為正值;一般以微米(μm)表示,一般表達形式如:Warp≤35μm。
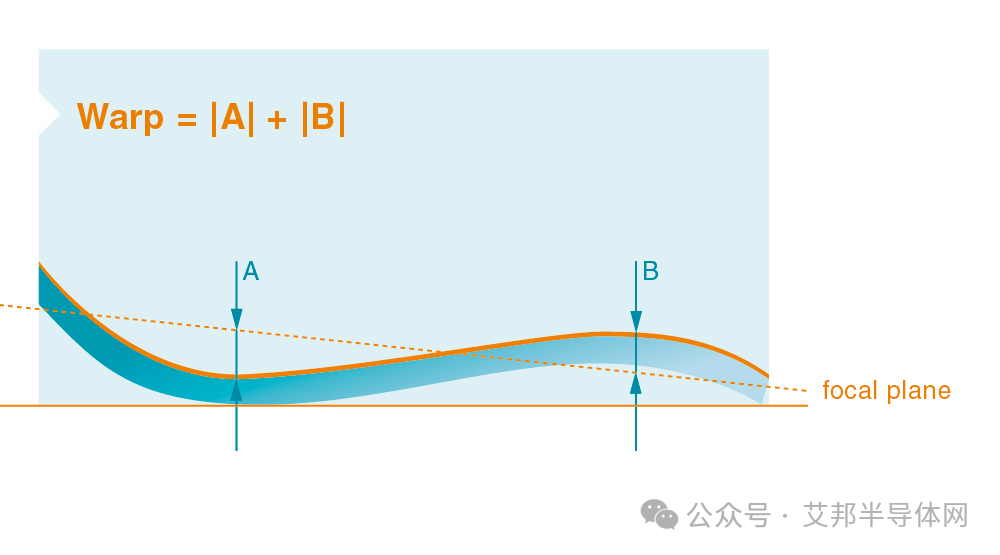
TTV、BOW、Warp的差別
Warp更全面,包括整個晶圓表面的彎曲和扭曲。
盡管這三個參數都與晶圓的形狀和幾何特性有關,但它們衡量和描述的方面各有不同,對半導體制程和晶圓處理的影響也有所區別。
TTV、BOW、Warp對半導體制程的影響
首先,這三個參數越小越好,TTV、BOW、Warp越大對于半導體制程的負面影響越大,因此如果三者的值超過標準,晶圓就要報廢。
對光刻過程的影響:
焦深問題:?在光刻過程中,可能會導致焦點深度的變化,從而影響圖案的清晰度。
對準問題:?可能會導致晶圓在對準過程中的偏移,進一步影響層與層之間的對準精度。
對化學機械拋光的影響:
拋光不均勻:?可能會導致CMP過程中的不均勻拋光,從而造成表面粗糙和殘留應力。
對薄膜沉積的影響:
沉積不均勻:?凸凹的晶圓在沉積過程中可能會導致沉積薄膜厚度的不均勻。
對晶圓裝載的影響:
裝載問題:?凸凹的晶圓可能在自動裝載過程中導致晶圓損壞。
碳化硅襯底加工過程中,除了改善切割工藝外,一般還會在切割時會留有余量,以便在后續研磨拋光過程中減小TTV、BOW、Warp的數值。
-END-
原文始發于微信公眾號(艾邦半導體網):碳化硅晶圓減薄工藝中的重要指標