封裝工藝經歷了從金屬導線架到打線封裝 (Wire Bond BGA) 到覆晶封裝 (FCBGA) ,隨著摩爾定律極限的逼近,半導體封裝產業已面臨無法透過微縮芯片的尺寸來提升電子裝置效能的窘境,因此又再開發創新的先進封裝工藝 Fan-In WLP ( 扇入型晶圓級封裝,在晶圓上進行封裝 )。
而扇入型晶圓級封裝構裝極大的挑戰在于:(1) 芯片尺寸持續縮小,大尺寸錫球再也無法容納于芯片的面積內。(2) 如果將 I/O 接點或錫球尺寸縮小,會帶來更多組裝成本。隨著管腳數增加,晶圓級封裝構裝面臨更多困難。因此,整體封裝市場朝向更先進的扇出型封裝方向發展。
來源:亞智科技
在扇出型封裝工藝中的 FOWLP(扇出型晶圓級封裝)面積使用率較低 ( 晶圓面積使用率 <85 %,面板工藝面積使用率 >95 %),在加速生產周期及降低成本考慮下,封裝工藝開發方向已由 FOWLP 轉向可在比 300 毫米晶圓更大面積的面板 ( 方形面積的載具 ) 上進行的 FOPLP(扇出型面板級封裝)。
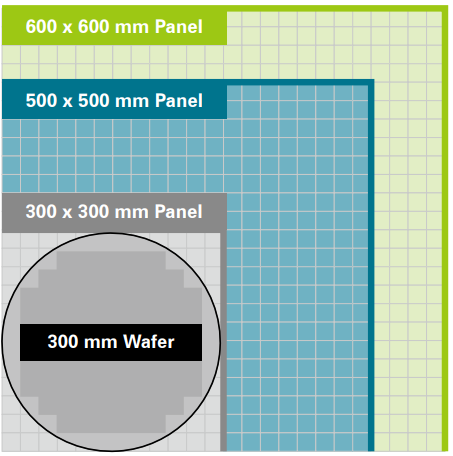
扇出型面板級封裝可以理解為扇出晶圓級封裝的延伸,是在多晶粒集成的需求,加上進一步降低生產成本的考量下,所衍生而出的封裝技術。因此,扇出型板級封裝具備顯著的效能提升和成本降低優勢。
在上一篇中小編介紹了扇出型面板級封裝的市場趨勢,今天為大家分享12家扇出型面板級封裝(FOPLP)廠商。不完全統計,排名不分先后。
三星電子

https://semiconductor.samsung.com/
三星電子在 2019 年以 7850 億韓元(約合 5.81 億美元)從三星電機手中收購了扇出型面板級封裝業務。三星電子以三星電機為主力,開發“面板級扇出型封裝(FOPLP)”。三星電機于2016年投資2640億韓元在忠清南道天安建立生產線并開始了PLP項目。

來源:搜狐
在今年3月的股東大會上,三星電子半導體(DS)部門前負責人Kyung Kye-hyun詳細闡述了PLP技術的必要性。“AI半導體芯片(帶電路的矩形片)的尺寸通常為600mm x 600mm或800mm x 800mm,需要PLP等技術。”
三星電子目前為需要低功耗內存集成的應用(如移動或可穿戴設備)提供FO-PLP。另據報道,該公司計劃擴展其2.5D封裝技術I-Cube,以包括PLP。
群創光電
https://www.innolux.com
群創光電成立于2003年,2006年股票在臺上市。群創打造全球最大尺寸扇出型面板級封裝廠(FO-PLP),垂直整合生產技術從Wafer進入到Chip測試產出提供一站式服務。
2019年,工研院以「低翹曲面板級扇出型封裝整合技術」與群創合作,將3.5代面板產線轉作成面板級扇出型晶片封裝應用,整合TFT制程技術跨入中高階半導體封裝。
群創光電首度提出一項前所未有的概念:「Panel Semiconductor」。其中,能夠高度整合晶片的先進封裝技術,成為群創在跨界半導體產業發展的重要方向之一。
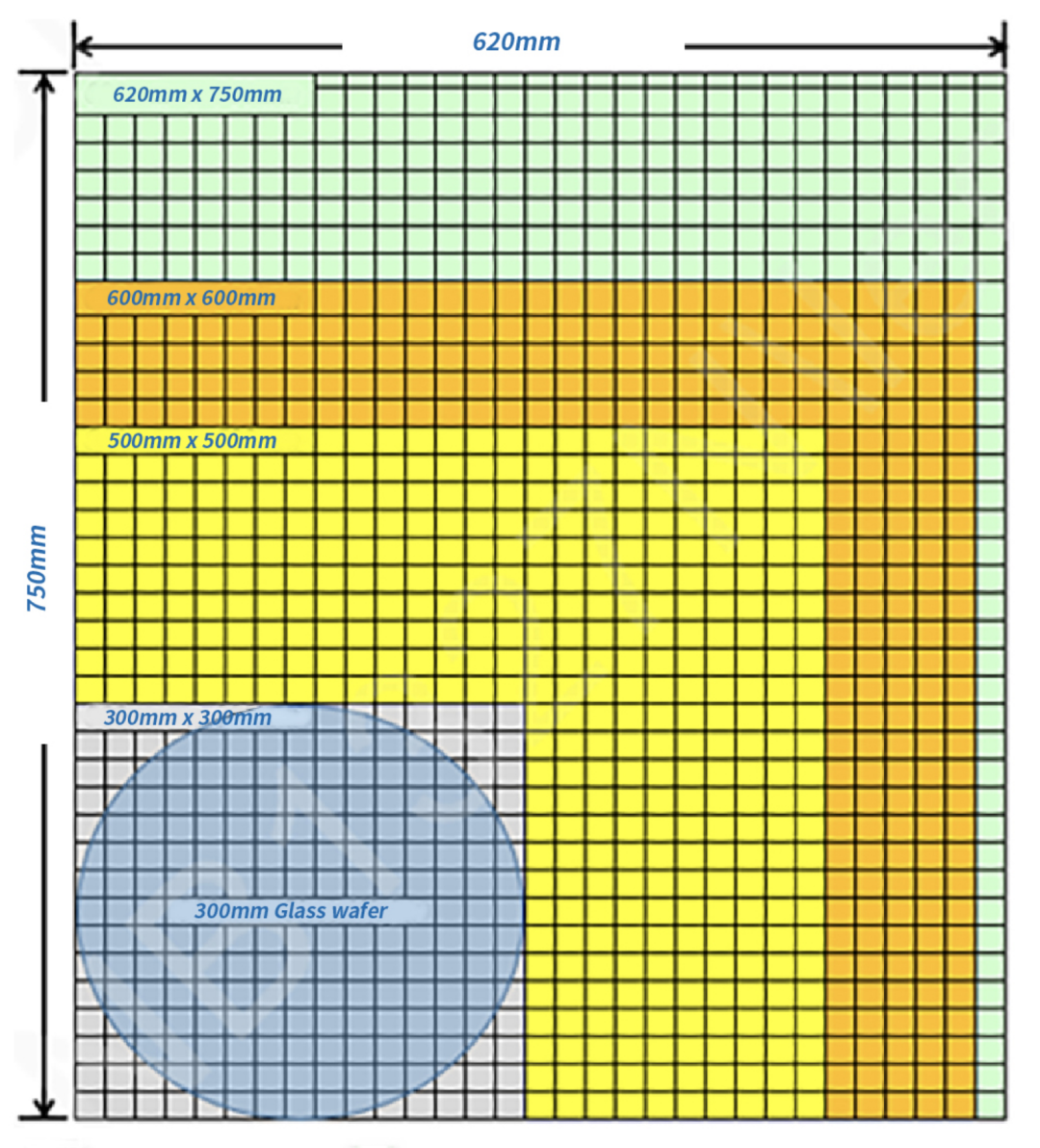
圖 G3.5 FOPLP Glass Panel 生產面積
力成科技

https://www.pti.com.tw
力成科技成立于1997年,專注于半導體專業封裝及測試領域。2018年為先進面板級扇出型封裝布局,于新竹科學園區投入高階封裝新廠建設計劃。力成科技提供 4 種封裝結構,包括無凸塊、Chip First、Chip Last 和 Chip Middle。
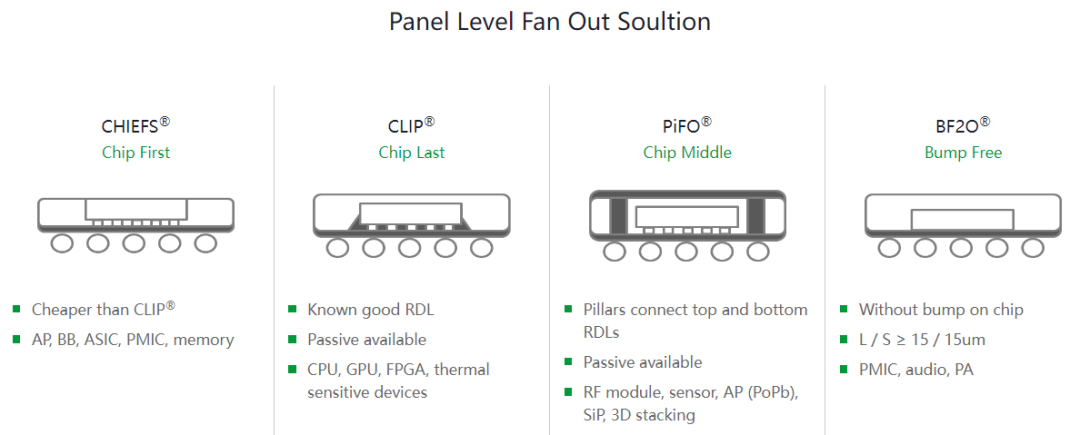
力成科技的扇出型面板級封裝產品兼容從低 I/O 到高端的邏輯和存儲設備,應用范圍更廣泛,包括電源、射頻、消費電子、移動、存儲、汽車、HPC 和 AiP。具有以下特征:
- 系統級封裝 (SiP) 可用于實現多芯片和無源元件集成
- 精細的RDL L/S和最短的信號傳輸路徑以獲得良好的電氣性能
細間距鍍高銅柱可用于扇出型 PoP
日月光

https://ase.aseglobal.com
面板級扇出型封裝,2019 年底產線建置完成,2020 下半年量產,應用在射頻(RF)、射頻前端模組(FEM)、電源(Power)、Server。(來源:雪球網)

來源:日月光
Nepes Lawe

https://www.nepes.co.kr
NEPES 專注于粗線寬線距設計(L/ S>10/10 μm),針對汽車,傳感器和物聯網等應用上,還應用于PMIC、RF模塊、APE和存儲器等。利用大面積方形面板工藝,超越扇出型WLP工藝,創新提升產能,降低成本,提供第四次工業革命所需的高性能,包括5G和云數據服務。

華潤微電子
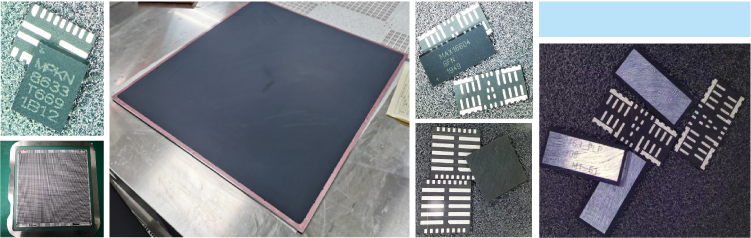
https://www.crmicro.com
華潤微電子于2018年成立矽磐微電子(重慶)公司從事面板級封裝業務,面板級封裝技術有效解決了Chiplet封裝成本高昂的問題,更適用于功率類半導體封裝異構集成化。
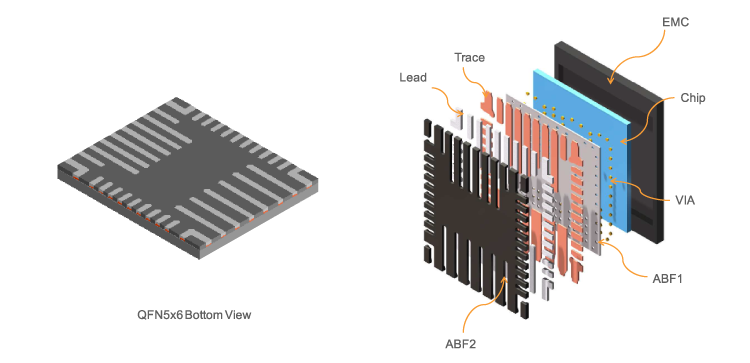
圖 面板級封裝產品結構
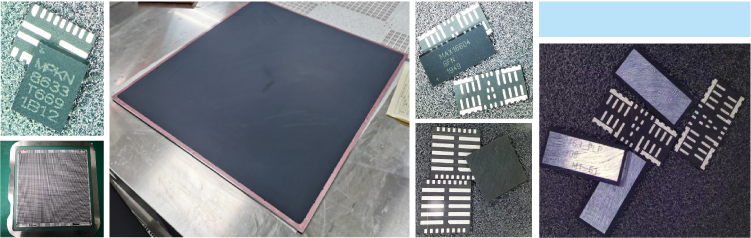
圖 矽磐微電子面板及產品(來源:華潤微)
華天科技

https://www.ht-tech.com/
華天科技(002185.SZ)通過其控股子公司江蘇盤古半導體科技股份有限公司,正式啟動了多芯片高密度板級扇出型封裝(FOPLP)產業化項目,標志著公司在先進封裝技術領域的又一重要布局。
6月30日,江蘇盤古半導體科技股份有限公司多芯片高密度板級扇出型封裝產業化項目奠基儀式舉行。該項目計劃總投資30億元,預計2025年部分投產。

奕成科技

https://www.echint.com
奕成科技是一家集成電路領域板級系統封測服務的卓越提供商。技術平臺可對應2DFO、2xD FO、FO POP.FCPLP等先進系統集成封裝。公司致力于開發先進板級系統封測技術,協同上下游供應鏈創新發展,為全球客戶提供一站式系統封測解決方案。
2023年4月,奕成科技高端板級系統封測集成電路項目點亮投產,標志著其首座板級高密系統封測工廠正式進入客戶認證及批量試產階段。
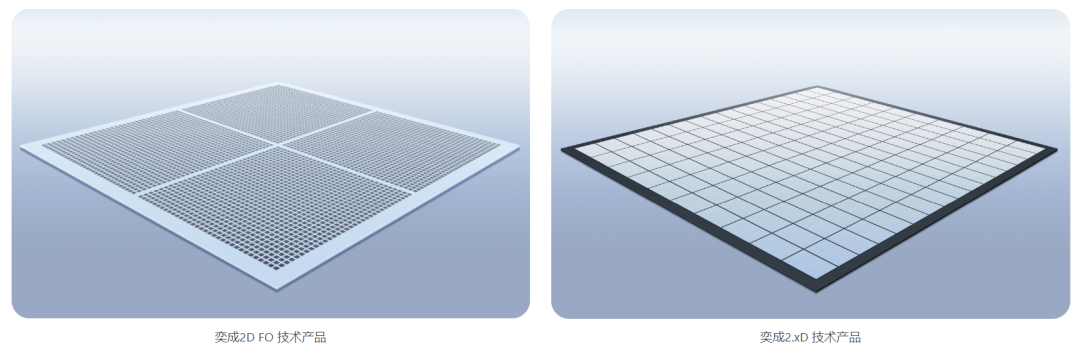
合肥矽邁微電子

https://www.ximaimicro.com
合肥矽邁微電子科技有限公司成立于2015年,是一家專注于半導體先進封裝的科技企業,建成了國內首條具備量產能力的基板扇出封裝生產線,并率先完成工藝開發,客戶認證和試驗量產,目前已經量產3年,量產產品包括電源管理類,射頻類,系統模塊等等。
中科四合

http://www.siptory.com/
深圳中科四合科技有限公司成立于2014年,并于2020年5月在廈門海滄成立全資子公司廈門四合微電子有限公司。2017年利用大板級扇出封裝技術實現TVS產品量產,成為全球最早將板級扇出封裝技術量產于功率類芯片的廠家之一。主要產品應用:TVS/SBD/MOSFET/GaN/PMIC/DCDC等功率芯片和模組類。
目前中科四合為我國領先的基于板級扇出型封裝技術制造特色產品(功率、模擬類芯片/模組)的供應商,深圳龍華區和廈門海滄區均設有制造工廠,其中深圳工廠以單、雙芯片板級扇出封裝量產技術為主,廠房面積為2,700平米,主要產品為面向消費類市場生產TVS、SBD等功率器件;廈門工廠以多芯片集成的三維板級扇出封裝量產技術為主,生產場地共計2.4萬平米,相較于深圳工廠,廈門工廠重點面向工業、通信、汽車等行業基于多芯片集成的三維板級扇出先進封裝技術開發和量產功率、模擬類芯片/模組,產品類型涵蓋MOSFET、GaN、DC-DC、IPM等。

廣東佛智芯微電子

http://www.fzxsmc.com
廣東佛智芯微電子結合現有半導體制程工藝設備和后道載板制程工藝裝備的優勢,打造了半加成法扇出封裝先進的線路創成工藝(i-FOSATM),建設國內首條高性價比板級扇出型封裝研發線和示范線。同時,為增加板級封裝技術創新與合作,佛智芯通過建立“板級扇出封裝創新聯合體”。
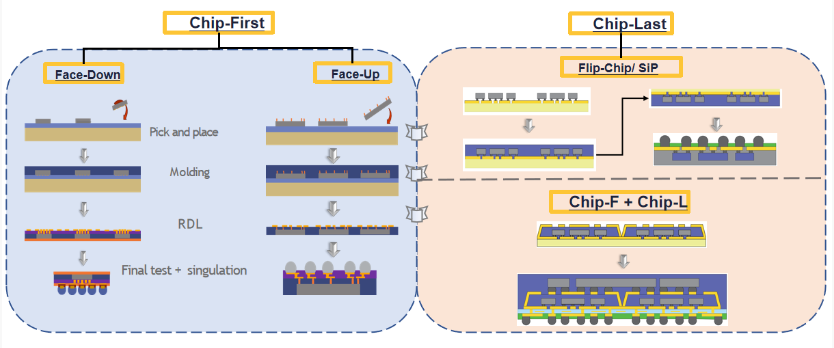
工藝路線能力:基于佛智芯示范線,打通Chip-First、Chip-Last、3D/SiP核心工藝。
天芯互聯

https://www.sky-chip.com
天芯互聯科技有限公司成立于2012年,天芯互聯致力于打造國際一流的半導體器件模組一站式解決方案提供商,依托晶圓級封裝(WLP)、系統級封裝(SiP)和板級扇出封裝(FOPLP)平臺,為客戶提供先進封裝與系統集成解決方案和集成電路測試解決方案。
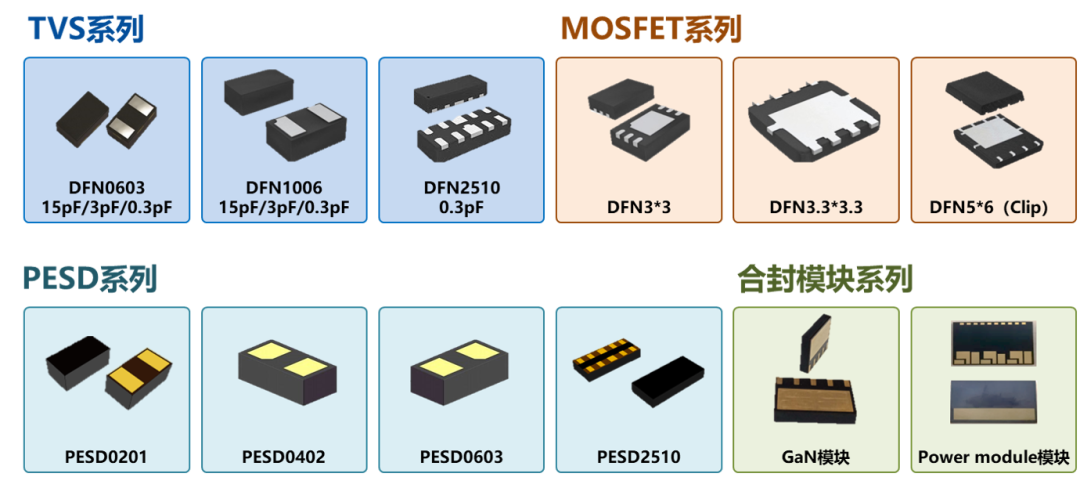
圖 FOPLP工藝產品
來源:
1.扇出型封裝技術及市場趨勢
2.許明哲,周云程,弘塑科技,2019年 2/3月 半導體芯科技
https://www.manz.com/ecomaXL/files/FOPLP_production_solutions_SC_2019.pdf
原文始發于微信公眾號(艾邦半導體網):先進封裝篇:10家扇出型面板級封裝(FOPLP)廠商介紹
