激光退火是絕緣柵雙極型晶體管(IGBT)背面工藝的重要步驟。對離子注入后的硅基IGBT 圓片背面進行激光快速退火,實現激活深度,有效修復離子注入破壞的晶格結構。隨著IGBT技術發展和薄片加工工藝研發的需要,IGBT背面退火越來越多應用激光退火技術。歡迎識別二維碼加入產業鏈微信群及通訊錄。

1.IGBT退火技術
在垂直方向上,IGBT結構經歷了穿通型(pouch through,PT),非穿通型(non pouch through,NPT)和電場截止型(field stop,FS),使器件的整體性能不斷提高。
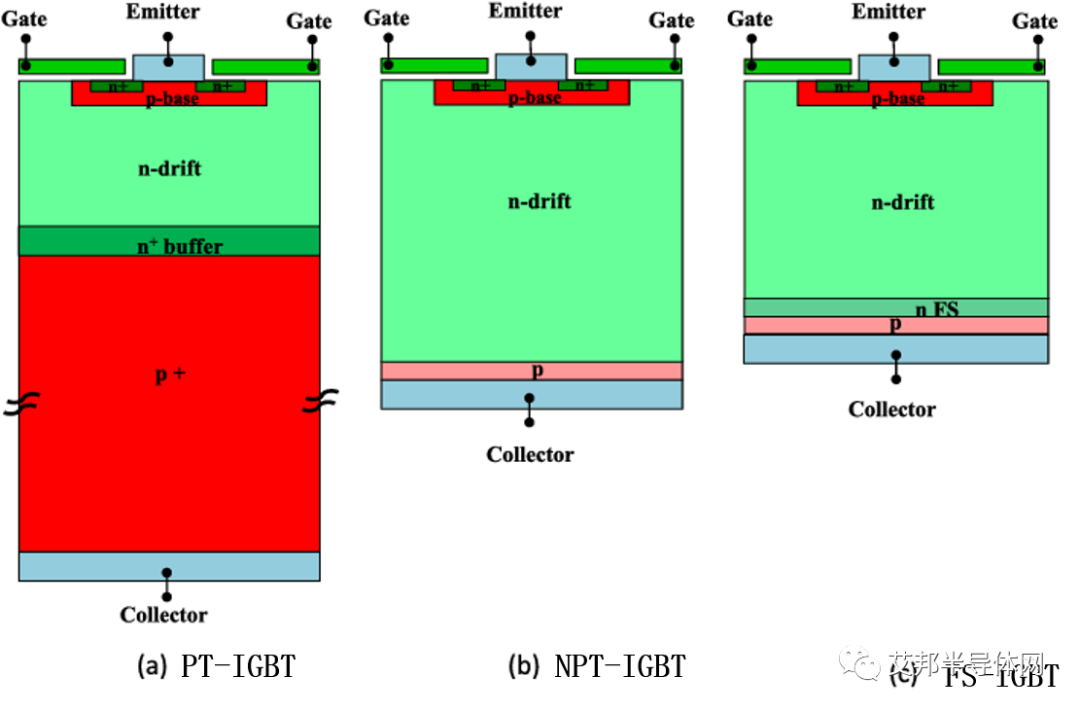
圖 IGBT結構的變化
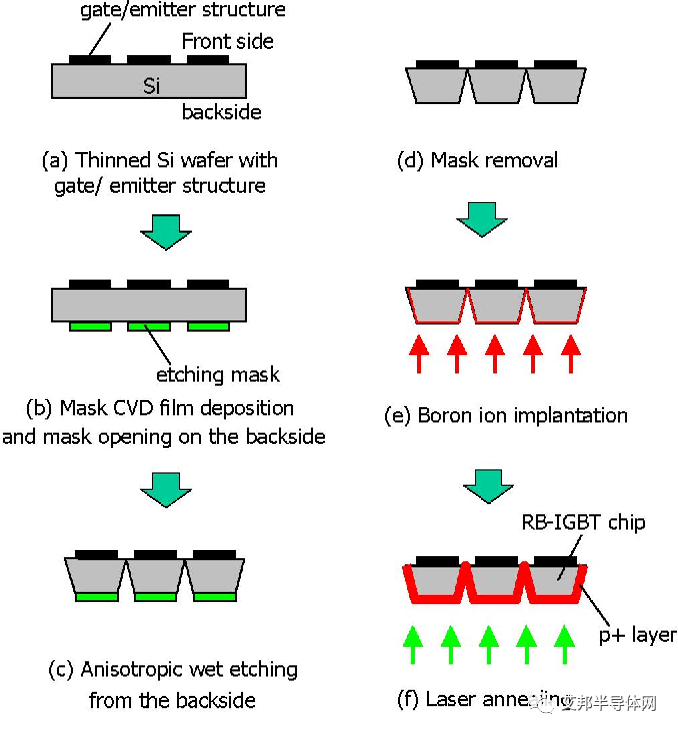
圖 IGBT 工藝流程
由于硅片正面金屬鋁的存在,此處的退火工藝必須保證硅片正面溫度要小于500℃,因此用爐管工藝來激活時溫度必須低于500℃(一般選擇400-450℃)。但在這一溫度范圍內,注入離子的激活率很低,對器件的性能調整造成影響。
激光退火由于能夠對硅片背面進行局域加熱,在硅片背面局部形成極高溫,大幅提高背面注入離子的激活率,同時保持硅片正面在較低溫度。
2.激光退火技術
20世紀60年代后期和20世紀70年代初期偶爾出現過關于激光退火的報道,但是激光退火直到1971年才被發明出來。為了保證不損傷正面的器件結構,并保證背面的激活效果,從IGBT第四代之后,逐步采用激光退火技術取代傳統熱退火技術。
激光退火的原理是用激光束照射半導體表面,在照射區內產生極高的溫度,使晶體的損傷得到修復,并消除位錯的方法。它能有效地消除離子注入所產生的晶格缺陷,同時由于加熱時間極短(約為普通熱退火的百萬分之一),可避免破壞集成電路的淺結電導率和其他結特性。

圖 激光退火波長與深度的關系示意圖
激光退火工藝可以有效修復離子注入破壞的晶格結構,獲得比傳統退火方式更好的離子激活效率和激活深度,且不損傷硅片的正面器件,從而在IGBT制造過程中得到業界的廣泛關注和應用。
資料來源:
1.雷海波,肖勝安,童宇峰.激光退火工藝在絕緣柵雙極型晶體管的應用[J].半導體技術,2014(6):434-437,451.
2.陳勇輝,劉國淦.高性能IGBT激光退火設備及其量產應用[J].電子工業專用設備,2014(4):1-7.
原文始發于微信公眾號(艾邦半導體網):激光退火工藝在IGBT制造中的應用
