一提到先進封裝必須提到RDL(重布線層),而RDL在大部分的場景下的目的都是Fan Out (扇出),以實現更輕薄、更多的IO接口、更好的電性能。在芯片設計和制造時,IO Pad一般分布在芯片的邊沿或者四周。IO pad是指芯片管腳處理點位,即負責將芯片管腳的信號經過處理送給芯片內部,又會將芯片內部輸出的信號經過處理送到芯片管腳。
而RDL工藝是指在晶圓表面沉積金屬層和相應的介質層,并形成金屬布線,對IO端口進行重新布局,將其布局到新的且占位更為寬松的區域,并形成面陣列排布。RDL的另一大好處,為多芯粒橫向堆疊提供了便利條件。如圖1所示,多個功能不同的芯粒與PCB板之間的連接通過RDL層來實現。
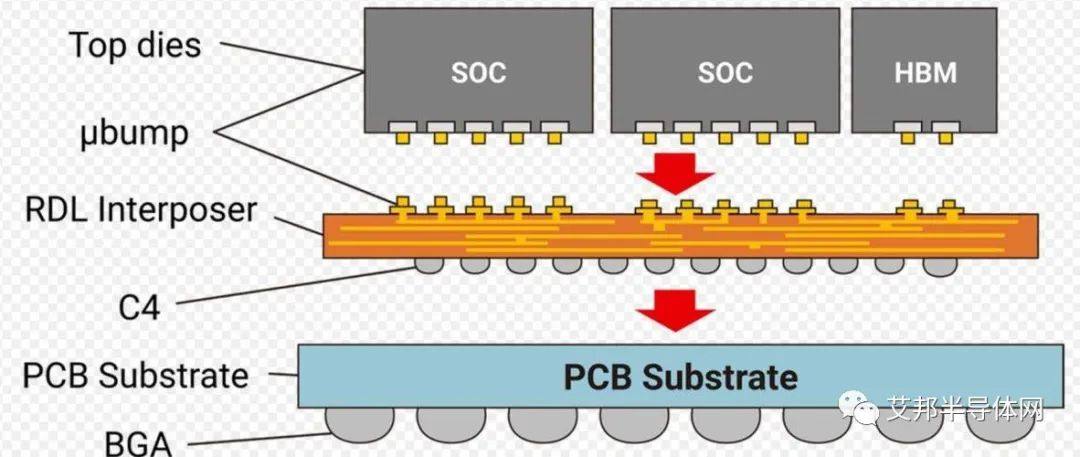
圖1. 臺積電官網(CoWos-R)示意圖
在整個Fan Out扇出工藝分為兩大類型RDL First和Die First/ Mold First。而整個扇出工藝中,難點主要集中在翹曲變形、芯片貼裝偏移、塑封質量等多個環節。今天我們就找幾個典型的問題進行大致講述。
Mold First 和RDL First兩個工藝路線細節如圖2所示。Mold First和RDL First工藝細節在艾邦半導體公眾號中已經有詳細介紹,此處不再細談。
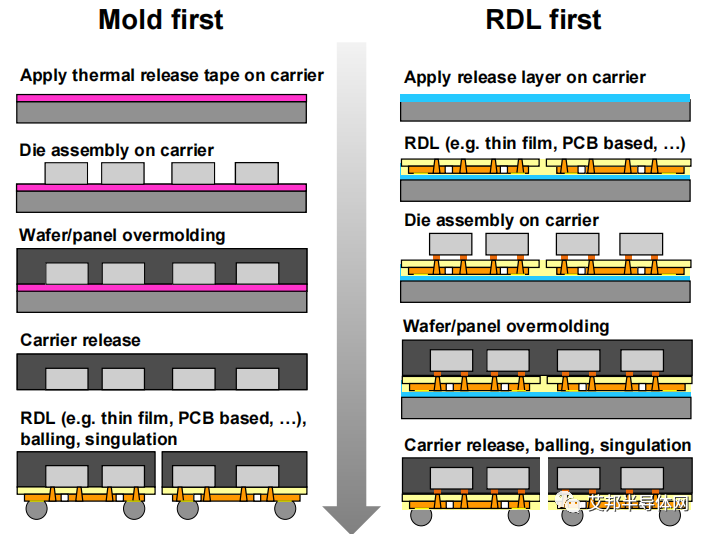
圖2. Mold First或DIE First與 RDL First或 DIE Last工藝差異
先談談Mold First工藝中芯粒貼裝偏移問題,我們都知道精度再高的DIE Pick and Place 設備都不可能沒有偏移量。而Mold First工藝中第一步在載板上先貼或涂 release film,第二步貼adhesive tape,第三步便是貼芯粒在載板上,然后塑封并制備與芯粒IO Pad連接的RDL層。芯粒貼裝(pick and place)和塑封(Molding) 在RDL制備之前,因此芯粒位置偏移主要由四方面原因導致:
一,塑封后由于塑封料固化后收縮導致芯粒位置發生變化;
二,芯粒貼裝位置精度不夠高;
三,塑封時由于CTEmismatch產生翹曲;
四,Adhesive tape粘力不夠強,外力改變了芯粒的設定位置。一旦芯粒位置發生偏移都會給后續RDL的制備增加工藝難度,并導致良率問題。那如何解決這一問題呢?業界常用的方法有兩種,一種是根據經驗或模型在貼芯粒的時候進行預先補償,提前預判塑封后由于收縮或翹曲等導致的變形。另外一種便是在制備RDL層前,對不同的芯粒IO Pad或Bump進行測量,提前將測量出來的值輸入到RDL制備設備中進行提前補償,避免錯位引起的失效。如圖3所示,首先創建一個標準的RDL圖形,然后省略掉一部分與DIE Pad接近的RDL,最后根據測量好每個芯粒實際位置后進行重新定位以便于RDL的制備。
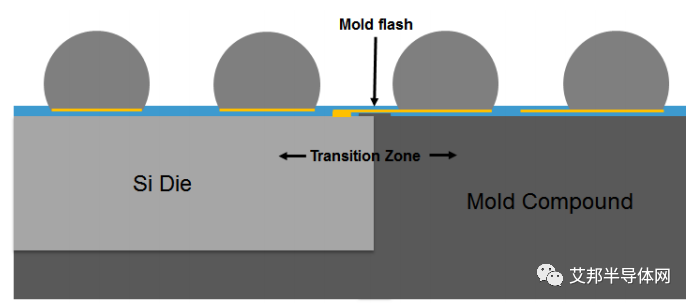
圖3. 創建自適應模式扇出RDL層的過程
接著我們再聊聊DIE Pick and Place精度問題的解決方案,我們都知道任何貼裝都需要通過Fiducial進行定位,而Mold First/DIE First工藝都需要將成百上千的芯粒先貼到基板上。因此,如何實現準確的定位就是整個工藝中的難點之一。如圖4所示,在面板級封裝界,通常采用的辦法是將整個面板分為多個區域,例如將一個大的區域劃分為四個小的部分,分別重新定位從而避免較大的累積誤差。當然,這樣做也會由于定位點的增加而損失一些UPH。
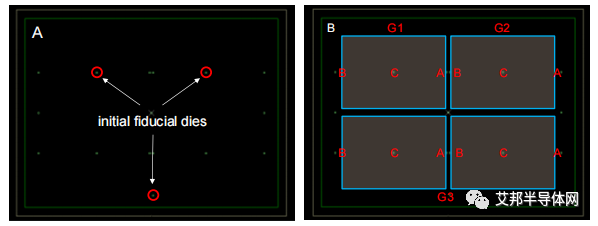
圖4. 圖A先貼3顆DIE作為Fiducial DIE或稱定位DIE,然后將整個面板貼完,而圖B則是將一個大的面板分為四份,每小份都分別貼定位DIE,這樣就可以減少累計誤差,從而提高貼裝精度
我們再仔細看一下RDL層制備前芯粒的IO Pad以及DIE 貼在面板級載板上的實物圖,如圖5所示。我們可以看到IO Pad分布在DIE周邊一圈,而最后制備好RDL后,經過RDL扇出后均勻分布在整個DIE的平面上。
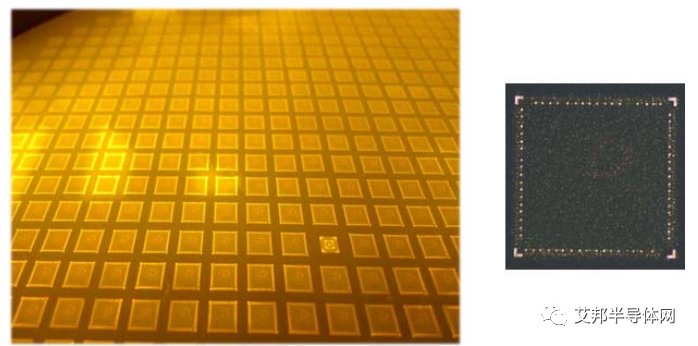
圖5. DIE First 在貼裝芯片都面板級載板上的實物圖,右圖為芯粒在晶圓廠制備好后的IO Pad分布
另外一個工藝難點便是Mold過程中整個基板的平整度以及溢料等問題的解決方案。圖6可以看出,溢料的產生很容易為后續RDL的制備帶來困難,主要是由于溢料會直接導致斷路。業界針對該問題標準的解決方案如圖7所示,在塑封前生成一定高度的銅柱,最終使得塑封料與RDL層隔開一定的距離,避免了上述由于溢料等導致的斷路。也相當于通過物理隔離的辦法增加了工藝的穩定性并提高了后續的良率。
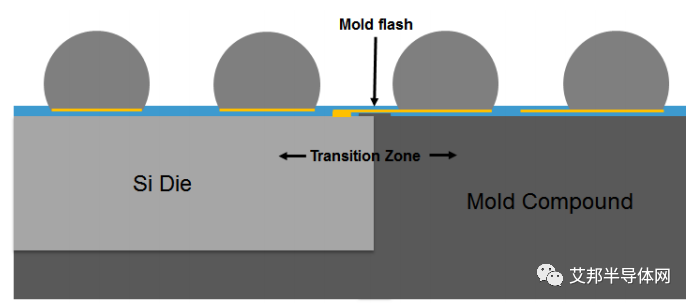
圖6. 芯粒(DIE)在載板上塑封后溢料的產生
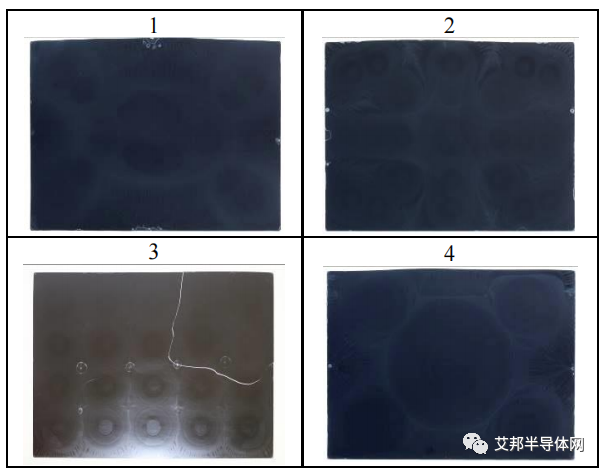
圖7. 通過生長一定高度Cu Pillar(銅柱),使得塑封料與RDL層隔開一定的距離
最后,我們再談談塑封料的選擇。在先進封裝塑封環節,塑封料的選型必不可少。塑封料一般分為三種:Liquid 液體,Granular:顆粒狀和Sheet:片。選擇不同塑封料的標準是材料應具有低化學收縮、低固化溫度和相匹配的熱機械性能,以滿足塑封后載板的低翹曲變形和成型后的DIE位置偏移。而塑封料的流動特性應允許大空腔的均勻填充。針對液體式塑封料,液滴位置的選取也是一個非常有技巧的環節。如圖10所示,不同液滴位置最終塑封后的塑封形貌。

圖8. 塑封料種類:Liquid 液體,Granular:顆粒狀,Sheet:片
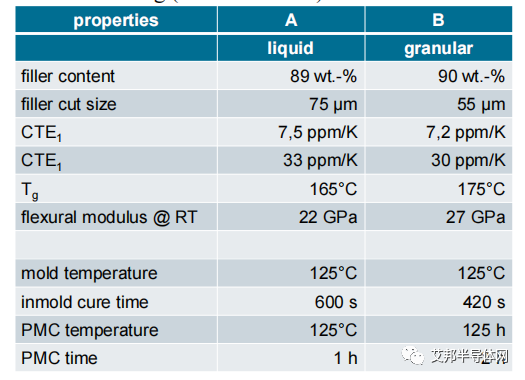
圖9. 不同塑封料類型參數對比表

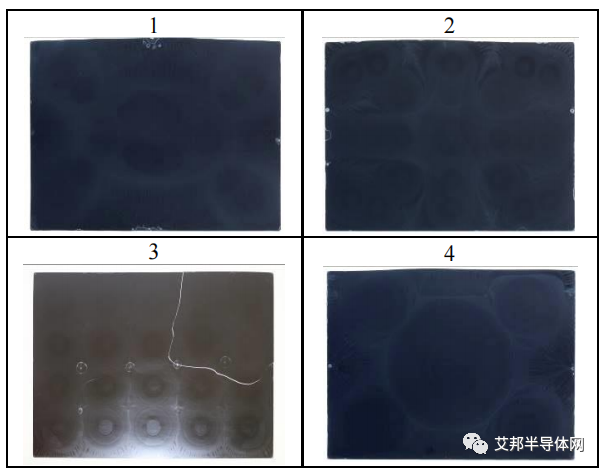
圖10. 同液滴位置最終塑封后的塑封形貌
據筆者初步了解,中國大陸地區封裝龍頭企業長電科技等主要精力放在晶圓級RDL封裝。面板級RDL封裝的主要玩家則是奕斯偉、合肥矽邁、中科四合、重慶矽磐微等。當然如果您對此有興趣希望深入了解,歡迎入群交流。

圖11. 全球面板級封裝廠商 來自MAZN
參考文獻:
Large Area Compression Molding for Fan-out Panel Level Packing T. Braun (1 ), S. Raatz (1 ), S. Voges (2 ), R. Kahle (2 ), V. Bader (1 ), J. Bauer (1 ), K.-F. Becker (1 ), T. Thomas (2 ), R. Aschenbrenner (1 ), K.-D. Lang (2 )
- IMPLEMENTATION OF A FULLY MOLDED FAN-OUT PACKAGING TECHNOLOGY B. Rogers, C. Scanlan, and T. Olson
原文始發于微信公眾號(艾邦半導體網):先進封裝之Fan Out扇出工藝細節
