隨著新一代IGBT芯片及功率密度的進一步提高,對功率電子模塊及其封裝工藝要求也越來越高,特別是芯片與基板的互連技術很大程度上決定了功率模塊的壽命和可靠性。傳統釬焊料熔點低、導熱性差,難以滿足高功率器件封裝及其高溫應用要求。此外隨著第三代半導體器件(如碳化硅和氮化鎵等)的快速發展,對封裝的性能方面提出了更為嚴苛的要求。銀燒結技術是一種新型的高可靠性連接技術,在功率模塊封裝中的應用受到越來越多的關注。
一、銀燒結技術的優勢特點
1.什么是銀燒結技術
20世紀80年代末期,Scheuermann等研究了一種低溫燒結技術,即通過銀燒結銀顆粒實現功率半導體器件與基板的互連方法。
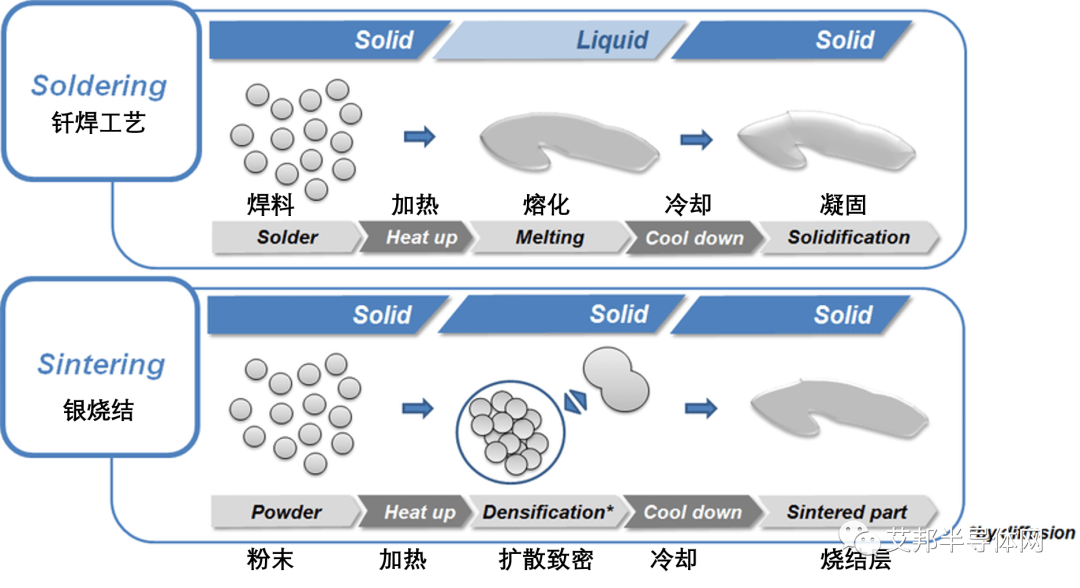
圖 釬焊與銀燒結對比
銀燒結技術也被成為低溫連接技術(Low temperature joining technique,LTJT),作為一種新型無鉛化芯片互連技術,可在低溫(<250℃)條件下獲得耐高溫(>700℃)和高導熱率(~240 W/m·K)的燒結銀芯片連接界面,具有以下幾方面優勢:
表 互連材料性能對比
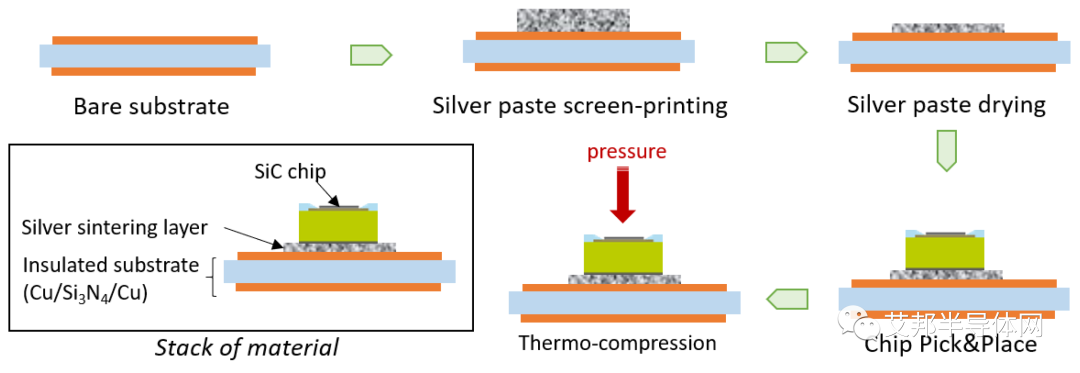
相對于焊料合金,銀燒結技術可以更有效的提高大功率硅基IGBT模塊的工作環境溫度及使用壽命。目前,銀燒結技術已受到高溫功率電子領域的廣泛關注,它特別適合作為高溫SiC器件等寬禁帶半導體功率模塊的芯片互連界面材料。
2.銀燒結技術原理
銀燒結技術是一種對微米級及以下的銀顆粒在300℃以下進行燒結,通過原子間的擴散從而實現良好連接的技術。所用的燒結材料的基本成分是銀顆粒,根據狀態不同,燒結材料一般為銀漿(銀膏)、銀膜,對應的工藝也不同:
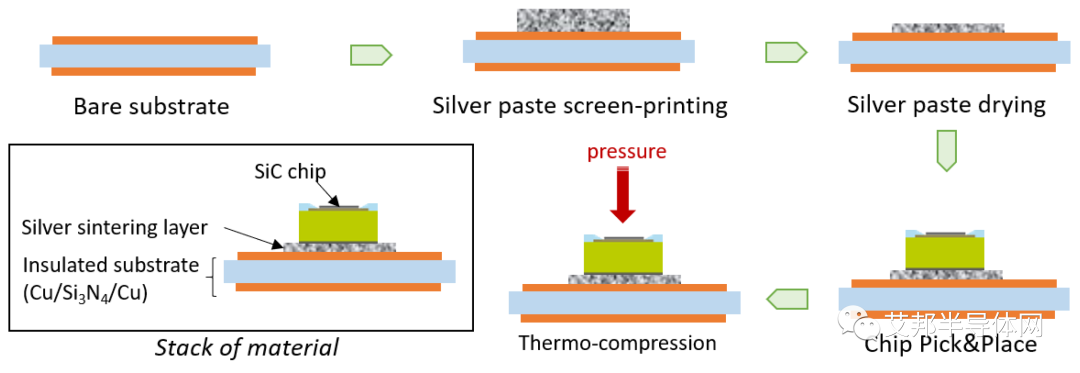
圖 納米銀膏中分散劑、粘接劑和稀釋劑的作用原理
銀漿工藝流程:銀漿印刷——預熱烘烤——芯片貼片——加壓燒結;
銀膜工藝流程:芯片轉印——芯片貼片——加壓燒結。
芯片轉印是指將芯片在銀膜上壓一下,利用芯片銳利的邊緣,在銀膜上切出一個相同面積的銀膜并粘連到芯片背面。
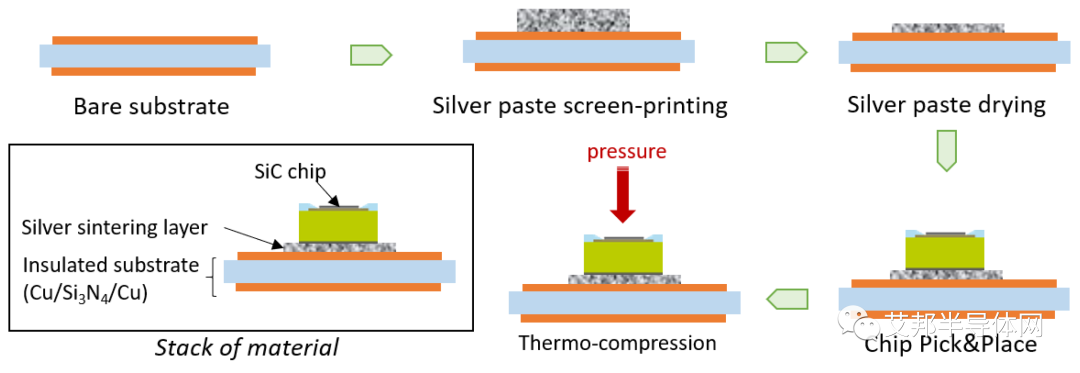
圖 銀燒結技術工藝流程
以納米銀漿為例,如下圖所示,在燒結過程中,銀顆粒通過接觸形成燒結頸,銀原子通過擴散遷移到燒結頸區域,從而燒結頸不斷長大,相鄰銀顆粒之間的距離逐漸縮小,形成連續的孔隙網絡,隨著燒結過程的進行,孔洞逐漸變小,燒結密度和強度顯著增加,在燒結最后階段,多數孔洞被完全分割,小孔洞逐漸消失,大空洞逐漸變小,直到達到最終的致密度。
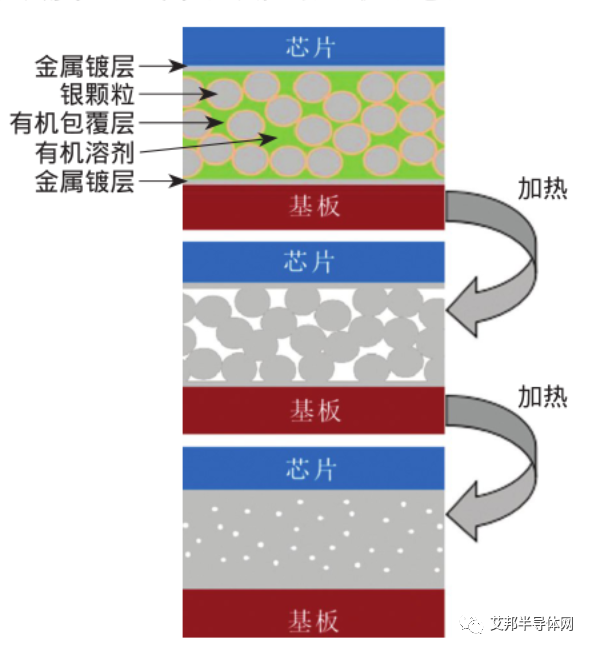
圖 銀漿燒結互聯示意圖
燒結得到的連接層為多孔性結構,孔洞尺寸在微米及亞微米級別,連接層具有良好的導熱和導電性能,熱匹配性能良好。
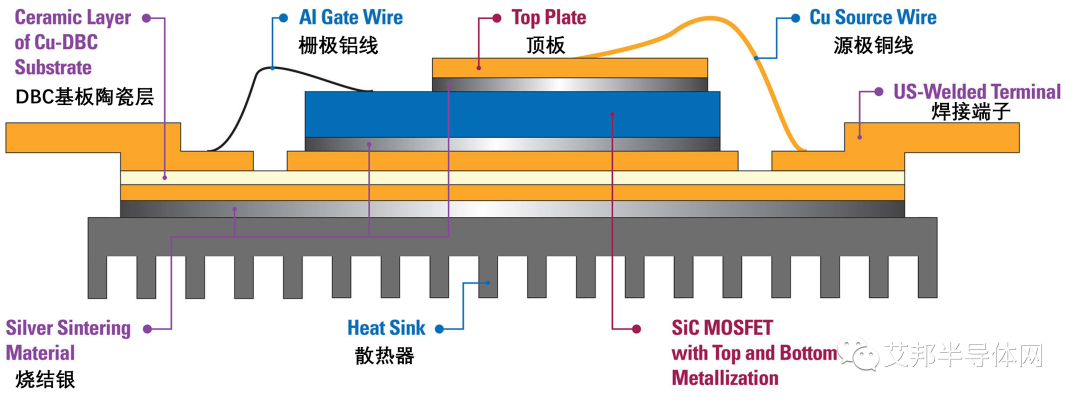
圖 燒結銀-電鍍鎳互連界面形貌
二、銀燒結技術在功率模塊封裝的應用
作為高可靠性芯片連接技術,銀燒結技術得到了功率模塊廠商的廣泛重視,一些功率半導體頭部公司相繼推出類似技術,已在功率模塊的封裝中取得了應用。
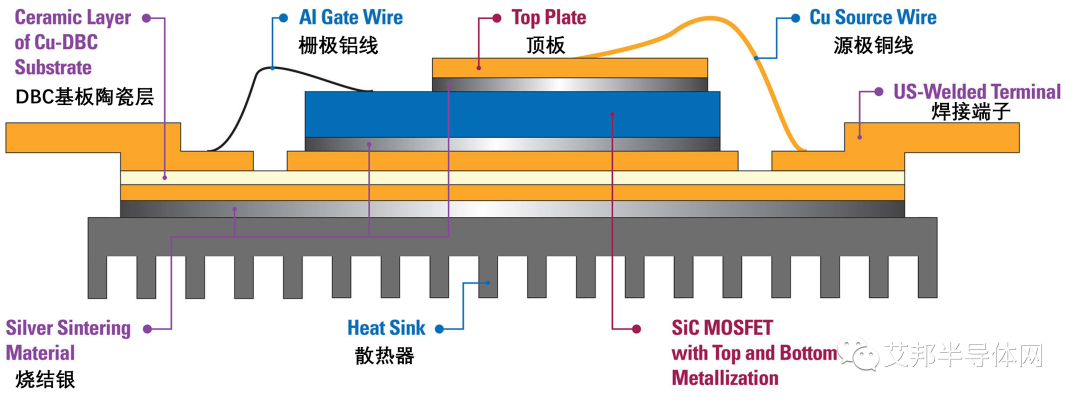
圖 SiC MOSFET封裝模塊剖面圖,來源:銦泰
2006年,英飛凌與開姆尼茨工業大學(Chemnitz University of Technology)等高校,采用銀燒結技術的功率模塊進行了高溫循環測試。在Easypack功率模塊中分別采用了單面銀燒結技術和雙面銀燒結技術,測試結果表明,相對傳統軟釬焊工藝模塊,采用單面銀燒結技術的模塊壽命提高5~10倍,采用雙面銀燒結技術的模塊壽命提高10倍以上。2012年,英飛凌推出.XT封裝連接技術(英飛凌高可靠封裝與互連技術的統稱),采用了擴散焊接工藝,在封裝中實現了從芯片到散熱器的可靠熱連接。
圖 大功率IGBT模塊中的.XT技術,來源:英飛凌
2007年,賽米控推出的功率模塊技術SKiNTER,利用精細銀粉,在高壓及大約250°C溫度條件下燒結為低氣孔率的銀層。其功率循環能力提升二至三倍,而且高運行溫度下的燒結組件長期可靠。如下圖所示,與燒結模塊相比,焊接模塊由于散熱性差,很早就會因焊接老化引起芯片溫度上升。芯片與DCB之間為燒結結合的模塊使用壽命更長。
圖 焊接功率模塊與燒結功率模塊最終的失效機理,來源:賽米控
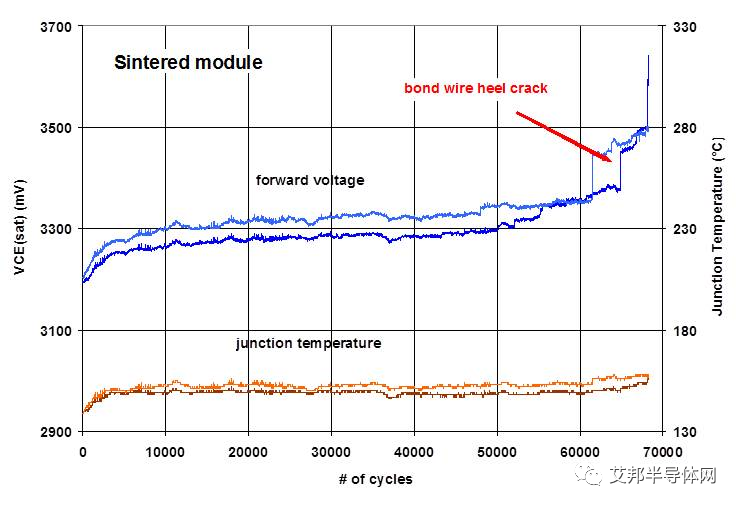
圖 焊接功率模塊與燒結功率模塊最終的失效機理,來源:賽米控
2015年,三菱電機采用銀燒結技術制作出功率模塊,循環壽命是軟釬焊料(Sn-Ag-Cu-Sb)的5倍左右,并且三菱電機自主開發了加壓燒結的專用設備。
如今,銀燒結技術已經成為寬禁帶半導體功率模塊必不可少的技術之一,隨著寬禁帶半導體材料(SiC、GaN)的發展,銀燒結技術將擁有良好的應用前景。
參考資料:
1.銀燒結技術在功率模塊封裝中的應用,李聰成,滕鶴松等;
2.納米銀焊膏無壓低溫燒結連接方法的絕緣柵雙極型晶體管(IGBT)模塊封裝應用研究,付善燦;
3.高功率IGBT芯片的瞬時低溫燒結互連方法及其性能研究,封雙濤;
4.燒結工藝對納米銀焊膏微觀結構的影響,王一哲;
5.Silver Sintering for Silicon Carbide Die Attach: Process Optimization and Structural Modeling,Michele Calabretta,Alessandro Sitta and etc.
6.無壓燒結銀與化學鍍鎳(磷)和電鍍鎳基板的界面互連研究,王美玉,梅云輝等。
原文始發于微信公眾號(艾邦半導體網):銀燒結技術在功率模塊封裝中的應用
