在環(huán)保和能源可持續(xù)發(fā)展的背景下,二氧化碳排放問題受到越來越多的關(guān)注。新能源汽車憑借其環(huán)保性和可持續(xù)性的明顯優(yōu)勢,正逐步取代傳統(tǒng)汽車,呈現(xiàn)出一種不可逆轉(zhuǎn)的發(fā)展趨勢。為了進(jìn)一步推動這一進(jìn)程,國家政府、各省市相繼出臺各項政策措施,加大對車規(guī)級功率器件行業(yè)的扶持力度,以加速其發(fā)展進(jìn)程。
近年來半導(dǎo)體技術(shù)的發(fā)展促使車規(guī)級功率器件封裝技術(shù)的發(fā)展和進(jìn)步,在政策和技術(shù)的推動下,多種封裝形式相繼衍生。然而,相比工業(yè)應(yīng)用,車規(guī)級功率器件的應(yīng)用工況更為復(fù)雜,對其設(shè)計、制造和驗證提出了更為嚴(yán)格的高功能安全標(biāo)準(zhǔn)。

圖源?攝圖網(wǎng)
半導(dǎo)體技術(shù)的發(fā)展使得芯片的尺寸進(jìn)一步縮小,給車規(guī)級功率器件的封裝帶來了巨大挑戰(zhàn),國內(nèi)外廠商從結(jié)構(gòu)、制程、技術(shù)、工藝、集成化、材 料等方面對車規(guī)級功率器件進(jìn)行了全面提升,促使封裝技術(shù)向著更高的功率密度、更緊湊的體積、更優(yōu)化的驅(qū)動電路、更低的系統(tǒng)成本的方向發(fā)展。
器件的封裝電感、芯片散熱和電氣絕緣等問題,以及器件內(nèi)部的耦合效應(yīng),與器件的熱學(xué)、電學(xué)、機械性能和可靠性密切相關(guān),特別是車規(guī)級功率器件,其可靠性問題是封裝關(guān)鍵技術(shù)研究的重點。因此,需要深入研究車規(guī)級功率器件的可靠性問題,才能探索適應(yīng)市場發(fā)展需求的車規(guī)級功率器件封裝結(jié)構(gòu)。
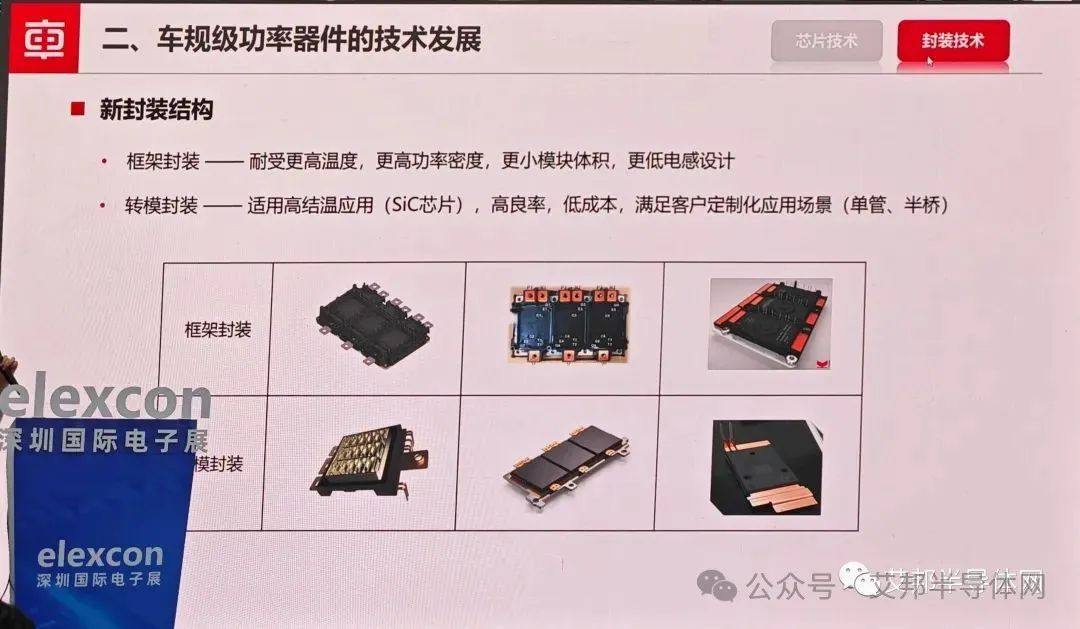
在上述研究背景下,本文將緊密圍繞車規(guī)級功率器件的封裝關(guān)鍵技術(shù)和可靠性研究現(xiàn)狀,從實際應(yīng)用需求角度出發(fā),深入剖析封裝設(shè)計和可靠性問 題及其難點。首先,詳細(xì)闡述車規(guī)級功率器件的應(yīng)用場景及發(fā)展需求;其次,結(jié)合現(xiàn)有設(shè)計水平和主要廠商對車規(guī)級功率器件的封裝關(guān)鍵技術(shù)進(jìn)行歸納,并對可靠性研究難點進(jìn)行總結(jié);最后,歸納需要重點研究的問題,并在此基礎(chǔ)上提出了相應(yīng)現(xiàn)有可行的解決方案。今天我們先詳細(xì)闡述一下車規(guī)級功率器件的應(yīng)用場景及發(fā)展需求,后面的內(nèi)容將陸續(xù)放出
一、車規(guī)級功率器件封裝現(xiàn)狀及需求
封裝現(xiàn)狀
車規(guī)級功率器件的封裝方案可分為以下兩類:多分立器件并聯(lián)式方案和功率模塊式方案,圖 1 為兩種封裝方案的基本結(jié)構(gòu)。圖1(a)為多分立器件并聯(lián)式方案的基本結(jié)構(gòu),功率芯片焊接在以銅基底為支撐面的底座上,通過內(nèi)部的連接線引出芯片的電極,管腳直插式焊接。分立器件大多基于標(biāo)準(zhǔn)封裝,工藝成熟,成本低,采購周期短,提高了開發(fā)設(shè)計的適應(yīng)性和適配性。
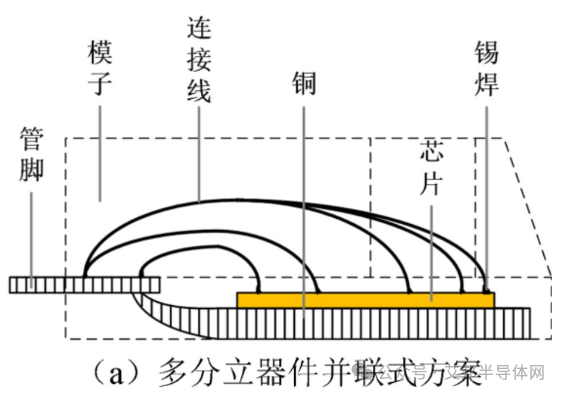
圖 1 車規(guī)級功率器件的封裝方案
圖1(b)為功率模塊式方案的基本結(jié)構(gòu),隔離構(gòu)造,芯片之間通過焊錫與鍵 合線相連,銅箔附著在陶瓷基板的上下兩面,上層銅箔與芯片及端子連接,下層銅箔與散熱基板連接。可以容納多個功率芯片串并聯(lián),可應(yīng)用于更高功率的場合,通過提高內(nèi)部設(shè)計達(dá)到更高的可靠性和魯棒性。
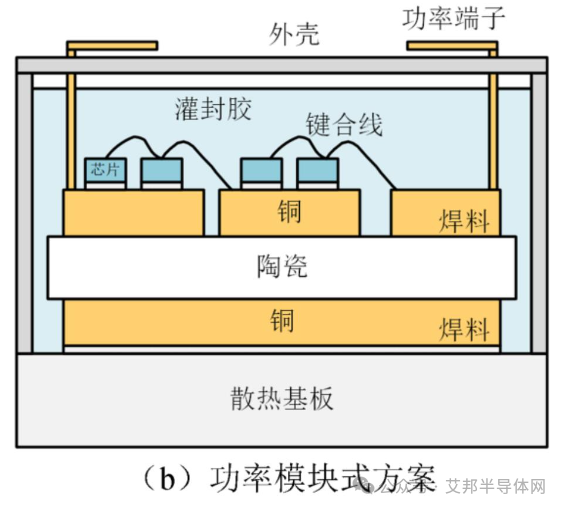
圖 1 車規(guī)級功率器件的封裝方案
功率模塊式方案憑借其高功率密度的封裝優(yōu)勢又衍生出各具特色的封裝方式,典型代表有 HybridPACK 封裝、EasyPACK 封裝、功率集成模塊(PIM)封裝和雙面散熱(DSC)封裝,如圖2 所示。HybridPACK 封裝具有高集成度、體積小、質(zhì)量輕的特點;EasyPACK 封裝的特點是簡化集成,降低電感,即插即用;PIM 封裝將多電路集成到單個模塊中,高效、可靠、緊湊;DSC 封裝則實現(xiàn)了雙面散熱且空間利用率高,熱性能和可靠性好。

圖2 功率模塊式方案封裝典型代表
2)主要應(yīng)用場景
與燃油汽車相比,新能源汽車功率半導(dǎo)體器件的用量明顯增長,廣泛應(yīng)用于車載充電機(OBC)、功率控制單元(PCU)等部件中。OBC 是實現(xiàn)電網(wǎng)經(jīng) AC/DC 轉(zhuǎn)換器為電池組充電的關(guān)鍵部件。與 PCU 相比 OBC 的功率等級較低,功率器件產(chǎn)品往往具有體積小、質(zhì)量輕、功率密度高的優(yōu)勢,一般采用分立式封裝和 EasyPACK 封裝。以功率器件制造廠商德國 Infineon 公司為例,針對 OBC 用功率器件的封裝設(shè)計,Infineon 公司開始采用 TO247-3 和 TO247-4 封裝的 SiC 功率器件,而后是 TO263-7 貼片封裝的 SiC 功率器件,近幾年則推出了 QDPAK TSC 頂部散熱封裝技術(shù),如圖 3 所示。
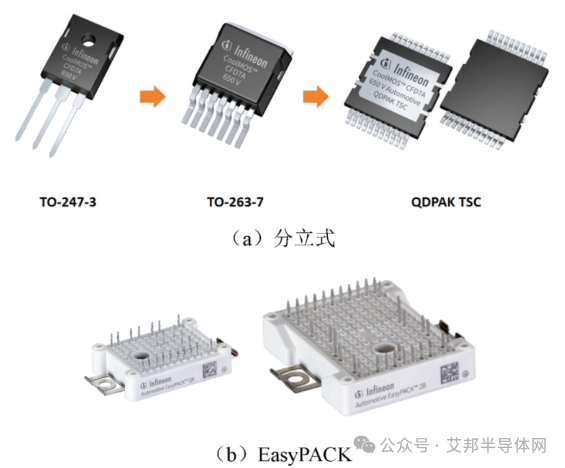
圖 3 OBC 用功率器件封裝技術(shù)發(fā)展主要歷程
PCU 是實現(xiàn)電池組經(jīng) DC/AC 轉(zhuǎn)換器驅(qū)動電機的關(guān)鍵部件,功率等級相對較高,因此對其功率器件的功率密度和可靠性提出了更高要求。以 Infineon 公司為例,其車規(guī)級功率器件產(chǎn)品早期采用 Si 基 IGBT 的平面型、波浪型 HybridPack Drive(HPD)封裝,而后采用針翅(Pin-Fin)型 HPD 封裝,再進(jìn)一步將 Al2O3 基板更換為 AlN 基板并將電流提高到 950 A,之后提出用雙面散熱塑封 DSC 模塊降低熱阻提高功率密度。但考慮到雙面塑封 DSC 模塊封裝應(yīng)力會導(dǎo)致芯片柵極失效,為了消除此影響,現(xiàn)有封裝形式多采用單面直冷塑封模塊,封裝內(nèi)部采用銅帶鍵合和納米銀燒結(jié)技術(shù),如圖 4 所示。
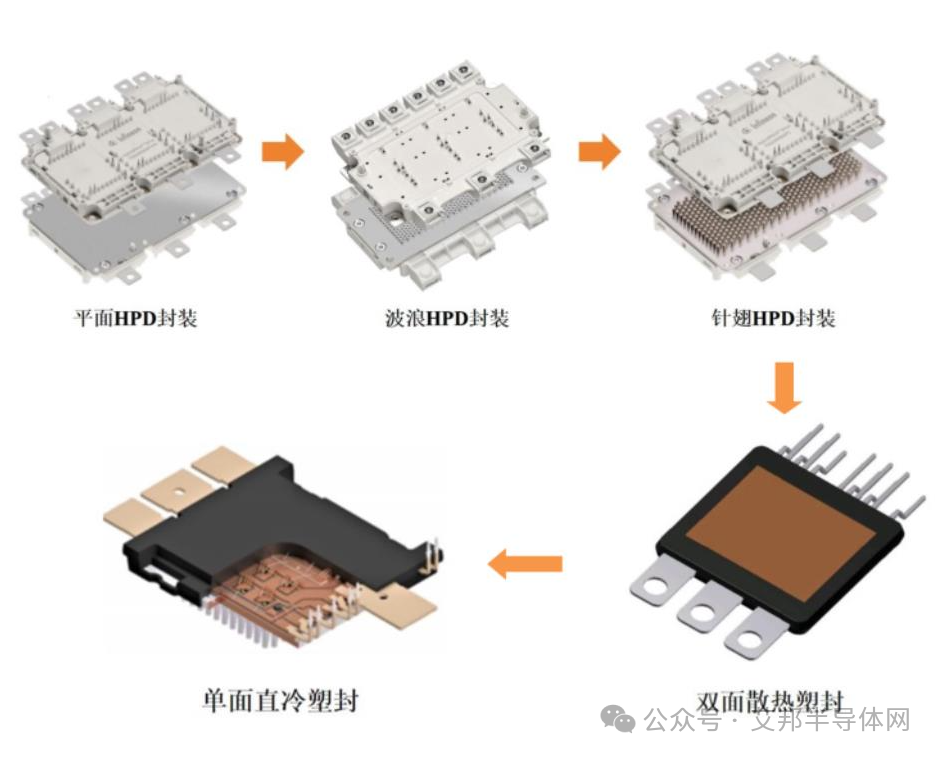
圖 4 PCU 用功率器件封裝技術(shù)發(fā)展主要歷程
2. 發(fā)展方向及需求
針對車規(guī)級功率器件的封裝設(shè)計,很多學(xué)者和器件廠商進(jìn)行了研究,本文將圍繞以下幾個重難點,對已有封裝設(shè)計發(fā)展方向進(jìn)行總結(jié),并參考已有模塊設(shè)計給出相應(yīng)的發(fā)展需求。
1)高功率密度和高工作效率
車規(guī)級功率器件影響著整車的充電效率和行駛工況,要具備盡可能高的功率密度和工作效率。若應(yīng)用第三代寬禁帶半導(dǎo)體材料的 SiC MOSFET 和 GaN HEMT等半導(dǎo)體器件,能使電動汽車的能耗在降低的同時,獲得更好的性能和里程表現(xiàn),并且可以大大縮短能源補給時間。
目前特斯拉、比亞迪、蔚來均已有車型采用了全 SiC 模塊主逆變器,且已有幾十家車企在 OBC 上采用了 SiC 技術(shù);晶體管外形(TO)封裝的多分立器件并聯(lián)式方案,通過先進(jìn)的均流技術(shù)可以在性能不變的情況下降低單個器件的電流負(fù)擔(dān),降低溫度并提高效率。
Infineon 公司的無引線封裝有助于減少導(dǎo)通電阻(Rds,on)和提高載流能力;ABB 基于堆疊陶瓷基板結(jié)構(gòu)的大電流 SiC 功率模塊的 3D 結(jié)構(gòu),可以更加靈活地控制各電位信號并將多個半導(dǎo)體并聯(lián)工作,實現(xiàn)模塊的快速開、關(guān)切換。
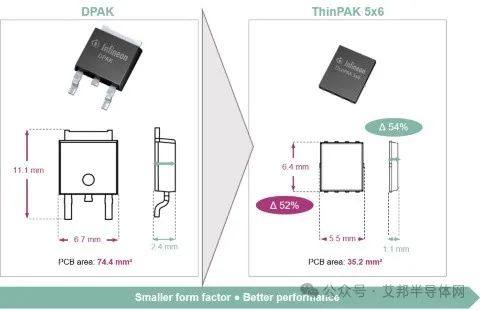
Infineon無引線 SMD 封裝
2)強散熱能力和低熱阻
大功率混合動力汽車(HEV)/電動汽車(EV)的使用對電驅(qū)動系統(tǒng)的熱管理提出了更高要求,要兼具承受較高局部電流和損耗密度的能力,需要提升散熱能力、降低熱阻。
對稱設(shè)計的雙面散熱結(jié)構(gòu)可以將模塊的散熱效率提高一倍,等效芯片的結(jié)-殼熱阻(Rth,j-c)降低了約 50%,從而大大降低了結(jié)溫(Tj),提高了熱性能和可靠性;集成針翅基板的直接液體冷卻(DLC)模塊消除了導(dǎo)熱硅脂的負(fù)面影響,具有優(yōu)越的熱性能;無基板結(jié)構(gòu)、無襯板結(jié)構(gòu),如直接芯片鍵合到母排、襯板直接液體冷卻、襯板基板一體化設(shè)計、集成液體循環(huán)冷卻通道等,其設(shè)計目標(biāo)是通過簡化模塊結(jié)構(gòu),減少結(jié)合層,去除熱界面材料(TIM),實現(xiàn)降低熱阻抗,降低 Tj,增加熱穩(wěn)定性和可靠性。
Infineon 采用了 Pin-Fin 和 DSC 相結(jié)合的散熱結(jié)構(gòu)以增強模塊散熱能力;Infineon 采用的擴散焊互連技術(shù)可以降低 Rth,j-c;Y.Y.Chen 等人提出了基板集成相變散熱結(jié)構(gòu)的 IGBT 器件,提高了溫度均勻性,有助于器件散熱;ABB 的印制電路板(PCB)嵌入式封裝可以增強器件的散熱能力并降低熱阻;Semikron 的 SKiM 技術(shù)將芯片通過銀燒結(jié)與絕緣襯板相結(jié)合,克服了無基板結(jié)構(gòu)襯板底部和散熱器間導(dǎo)熱硅脂材料對模塊熱性能和可靠性的影響;Semikron 的芯片直接壓接技術(shù)可以降低封裝熱阻;ST 的 SLLIMM HP 系列智能功率模塊采用直接覆銅(DBC)HPS(Al2O3,質(zhì)量分?jǐn)?shù)為 9%的 ZrO2)基板以提高其散熱能力,其推出的 ACEPACKTM SMIT 功率器件封裝頂部絕緣散熱采用 DBC 貼片技術(shù),實現(xiàn)了高效的封裝頂部冷卻。

賽米控丹佛斯?SKiM 技術(shù)
3)低寄生參數(shù)
寄生參數(shù)包括回路總電感、分布電感和電阻,寄生參數(shù)會影響功率器件的開關(guān)損耗,功率器件的開關(guān)瞬變還會帶來一系列器件和封裝內(nèi)部電磁寄生效應(yīng)問題。
Infineon 在 HybridPACK 模塊中采用了高水平電流對稱性設(shè)計,可以降低雜散電感;Infineon 的 EasyPACK 功率模塊通過采用并行化帶狀線設(shè)計,也達(dá)到了降低模塊雜散電感的目的;一些改進(jìn)型引線鍵合結(jié)構(gòu)通過減小換流回路長度、優(yōu)化功率端子、改進(jìn)芯片布局方式等思路降低回路寄生電感。

英飛凌 EasyPACK 系列產(chǎn)品
4)高絕緣能力
功率芯片在使用過程中要避免與外界接觸,否則芯片電路將受到空氣中的污染或雜質(zhì)顆粒的腐蝕或影響,導(dǎo)致功率器件電氣性能降低甚至使電路失效。在 SiC 功率器件內(nèi)部高電場強度下,電化學(xué)腐蝕過程將尤為嚴(yán)重,需要通過采用高強度的頂部封裝材料等措施,應(yīng)對由 SiC 功率器件強內(nèi)外磁場所帶來的高絕緣需求。
采用灌封膠進(jìn)行封裝可以提升器件在高溫和高壓下的電氣絕緣能力;絕緣材料在過高的溫度下也可能發(fā)生老化和性能的下降,合理設(shè)計散熱結(jié)構(gòu)對提升功率器件的絕緣能力也十分重要;采用塑封功率集成模塊可以提高器件的可靠性、抗震性和防塵防水性能;TOSHIBA 的塑封模塊式柵極注入增強型晶體管(IEGT)器件為了獲得更好的絕緣性而采用了高相對漏電起痕指數(shù)(CTI)的材料。
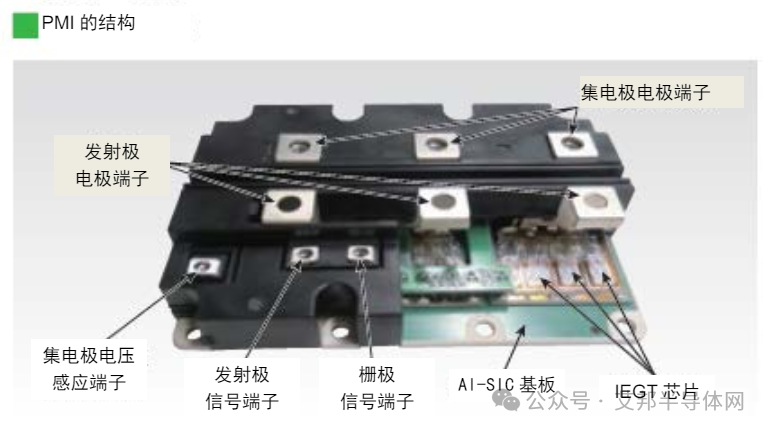
東芝塑料模塊式 IEGT 器件 PMI
5)高集成度

TOSHIBA 碳化硅功率模塊的新封裝?iXPLV?
除上述外,還有低成本、采購周期短、耐久性好、便于使用和優(yōu)化升級等發(fā)展需求。對于車規(guī)級功率器件的封裝設(shè)計來說,滿足不同應(yīng)用場景、適應(yīng)高標(biāo)準(zhǔn)的發(fā)展需求、從不同角度綜合考慮、達(dá)到多維度優(yōu)化的最佳效果,依然是一個值得研究的復(fù)雜問題,后續(xù)內(nèi)容請持續(xù)關(guān)注。
參考資料:車規(guī)級功率器件的封裝關(guān)鍵技術(shù)及封裝可靠性研究進(jìn)展,武曉彤等.
原文始發(fā)于微信公眾號(艾邦半導(dǎo)體網(wǎng)):車規(guī)級功率器件的封裝關(guān)鍵技術(shù)(上)
