功率器件作為電子產品的核心組成部分,通常分為單管和模塊兩種形式。在這些器件投入市場前,都必須進行可靠性試驗。了解單管與模塊在可靠性試驗上的差異性,對于選擇合適的器件以及確保系統的穩定性和長期性能至關重要。
單管和模塊的結構差異
單管功率器件通常指獨立封裝的單個晶體管,如IGBT、MOSFET等,模塊則是由多個功率器件及其他組件集合而成。這種結構上的差異直接影響了它們的散熱性能、電氣特性和機械強度。在封裝結構方面,單管的結構較為簡單,即將芯片焊在一個平整的銅板上,一般覆蓋塑封料。模塊通常會增加一個DBC結構,將芯片焊接在陶瓷基板上的銅層上,使用硅凝膠作保護材料,其銅板設計通常考慮一定的弧度,以減輕由材料熱膨脹系數差異造成的內部應力,提升封裝可靠性。各個材料之間熱膨脹系數差異是導致封裝內應力的主要原因之一。可靠性測試及失效模式
可靠性測試項目參考一般兩個車規級標準,考慮應用場景等區別,單管參考AEC-Q101標準,模塊參考AQG-324標準。可靠性測試項目中包括壽命測試和環境測試,其中壽命測試有:高溫反向偏置(HTRB)、高溫柵極偏壓(HTGB)、高溫高濕反向偏置(H3TRB)、間歇操作壽命(IOL)、功率循環測試(PCsec/PCmin)等,環境測試有溫度循環(TC)、高壓爐測試(AC)、熱沖擊試驗(TST)、震動測試(V)、機械沖擊測試(MS)等。
1.高溫反偏-HTRB
在進行HTRB試驗時,單管和模塊的試驗條件基本一致,要求在最高結溫下以80%額定電壓運行1000小時。但現代器件的高電壓和電流使得高溫下的漏電流顯著增加,許多器件在150℃下的漏電流已達到毫安級別,此時如果直接給烘箱加 150℃的設定,則很難在這樣的高溫環境中維持恒定的高溫并確保良好散熱。因此散熱問題一直是HTRB實驗的難題之一。此外,由于單管的封裝更簡單,銅底板更薄,熱阻更大,導致在相同的測試條件下溫度升得更快。相反,模塊可能由于更優的熱管理設計,在相同的條件下能夠承受更高的溫度。因此,在進行HTRB試驗時,考慮到單管和模塊在熱管理和結構上的差異,以及現代器件漏電流的增加,可能需要針對不同類型的器件調整測試條件,以確保實驗的有效性和器件的穩定性。典型失效一:電壓擊穿
失效模式:通常表現為芯片正面可見深燒熔洞,側面可見貫穿芯片的洞。失效機理:漏電流持續上升,與結溫升高形成正反饋,最終將芯片擊穿。擊穿點一般出現在靠近終端的過渡區這種芯片的薄弱區域。整體的失效模式與RBSOA失效模式相似,即從集電極到發射極出現一個貫穿的洞。典型失效二:芯片缺陷/焊接應力
由于出現這種失效模式時,很難分辨是純粹的芯片缺陷還是焊接應力導致,所以在此將芯片缺陷跟焊接應力結合說明。單管采用塑封料結構,因此更容易使芯片產生焊接應力。HTRB可以有效的篩選出芯片缺陷產生的前期失效,所以產線基本會增加這項HTRB測試,例如車規級模塊在進行HTRB測試時,進行至少4-12h的試驗后可篩出千分之幾的潛在缺陷芯片。2.高溫柵偏-HTGB
單管和模塊在高溫柵偏試驗時基本執行相同的條件,但需要注意的是,更新的AQG-324標準中,對試驗條件進行了嚴格規定:要求一半樣品經受正壓測試,另一半樣品經受負壓測試,而非此前版本允許先進行正壓后進行負壓的測試。典型失效
失效模式:門極bonding線或是集成門極電阻周圍有燒毀的痕跡。對于IGBT芯片,由于其柵極擊穿電壓(BV)一般超過50V,通常遠高于測試電壓(±20V),幾乎不會出現失效。但對于SiC芯片來說,材料的缺陷密度更大,因此該實驗對其 來說是重點考核項目。目前,SiC器件在出廠試驗中基本必做HTGB試驗,甚至較好的器件不僅會進行HTGB試驗,還會包括HTRB試驗。3.高溫高濕反偏-H3TRB
模塊在H3TRB試驗中通常要求承受更高的反偏電壓,且模塊端子間的電氣間隙及爬電距離通常大于10mm,以增加電氣安全性。相比之下,單管一般進行較低電壓的試驗,但由于其較小的C/E間距(約5mm左右),更容易發生電氣打火。因此較大的單管已開始進行高壓H3TRB實驗,且模塊參照 AQG-324 標準時一定要求80% 電壓試驗。
典型失效
水汽是導致H3TRB試驗中常見的失效原因之一。對于模塊,硅凝膠雖能在短時間(幾個小時)內阻擋水汽,但長時間曝露后水汽可能穿透至芯片表面。而單管由于使用塑封料,對水汽有更長時間的阻隔效果,一般能持續7至15天。因此,在相同條件下進行H3TRB試驗時,單管相較于模塊可能會展現出更佳的可靠性。失效現象一:PI (聚酰亞胺)層與終端剝離,在芯片擊穿點下方形成失效點。失效現象二:鈍化層裂紋導致失效。當 PI 層下面、鈍化層上有裂紋時,水汽透過 PI 層直接進入鈍化層,最終導致失效。? ?4.間歇壽命試驗-IOL
間歇壽命實驗是評估單管在反復加熱和冷卻條件下的可靠性的重要方法,通常指單管風冷分鐘級功率循環實驗。在這種測試中,單管的開啟時間(Ton,即加熱時間)根據封裝的大小而變化,一般在 2min~3.5min,封裝越大,Ton越長。且由于單管相對簡單的封裝結構,其綁定線(bonding wire)被塑封料固定,因此綁定線的失效率相對較低,失效主要在芯片下的焊料層。熱應力和熱循環也可能導致這些焊料層出現裂紋或斷裂,從而導致器件失效。5. 功率循環試驗
功率循環試驗通常包括秒級(PCsec)和分鐘級(PCmin)兩種,其中秒級功率循環是考核模塊鍵合的唯一手段,分鐘級則主要通過較長的加熱時間使整個模塊經歷升溫和降溫,考核銅底板與DBC之間的焊料層。AQG-324標準對該試驗沒有明確規定,一般可參考以下國內的標準,即秒級功率循環應達到或超過6萬次,而分鐘級功率循環應達到或超過≥1.5萬次。
PCsec失效現象一:綁定線疲勞
失效機理:在進行試驗時,反復的熱機械應力的沖擊使IGBT模塊內部的綁定線產生疲勞,導致單根綁定線失效,進而使其他并聯綁定線承受更大電流,增加熱機械應力,最終導致連鎖失效。如下圖所示是秒級功率循環失效之后的電鏡圖。從圖中可以觀察到,鍵合斷裂點并非直接位于芯片表面,芯片表面的綁定線仍與芯片本身緊密結合。這說明調節功率僅增加了推拉力,對于鍵合壽命的效果有限。因此,除了功率調節外,還需要考慮鍵合的其他參數,例如鍵合弧高、鍵合數量、及鍵合方向等,這些因素綜合起來可以更有效地延長功率循環的壽命。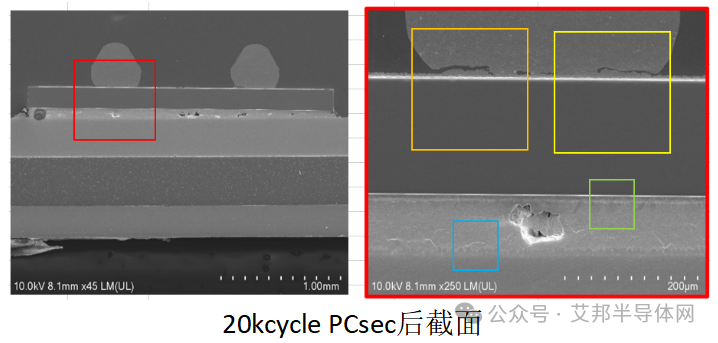
PCsec失效現象二:芯片金屬化層重構
失效模式:芯片表面鋁金屬層出現退化、晶粒增大、鋁層擠壓等現象。失效機理:這種失效一般只會在高結溫條件下出現。隨著功率循環次數的增加,芯片結溫過熱,金屬層可能發生重構出現鋁晶粒擠出等現象,導致接觸電阻變大,導通壓降上升,最后導致失效。

另外,金屬化層的重構不但會造成本身層電阻增加而導致同樣導通電流下的VCE上升,還有可能造成有效的芯片元胞和導通面積減少,從而產生局部的熱點或燒熔。PCsec失效現象三:芯片焊接層退化
失效機理:由芯片與 DBC 板上銅箔的熱膨脹系數差異而導致,所以不同的焊料開裂特征有所不同:含鉛焊料一般從芯片的周邊逐步向中心開裂;而含錫、銀材料的焊層由芯片中心出現開裂。
PCmin失效現象:基板焊層開裂
失效模式:焊料層隨循環次數增加逐漸開裂,熱阻隨之升高。
失效機理:PCmin主要對整個模塊進行加熱,除了對鍵合與芯片焊接層產生應力以外,也會對基板焊層產生應力,且當DBC與銅基板的熱膨脹系數差異較大時,二者之間的焊接層可能分離,最終導致基板焊層開裂。因此使用與DBC熱膨脹系數更接近的AlSiC基板可以提升模塊的可靠性。6.溫度循環/溫度沖擊-TC/TS
為了提高測試的效率和實用性,當前階段的AQG-324標準將溫度循環(TC)與溫度沖擊(TS)試驗整合測試,普遍認為具有較高升降溫速率的溫度循環能夠有效替代溫度沖擊實驗。在此試驗中,單管因其簡單的結構展現出較高的溫度循環可靠性。
失效現象一:芯片焊接層退化
與PCsec的失效機理類似,區別主要在于TC/TS試驗中是主動加熱器件,PCsec是被動加熱;以及PCsec試驗花費時間相較于一般需要1000小時的TC/TS來說更快。
失效現象二:基板焊層開裂
與PCmin的失效機理類似,區別同樣在于TC/TS的主動加熱與PCmin的被動加熱。
失效現象三:DBC開裂
根據AQG-324 標準要求,TS 試驗需要器件加散熱器進行,因此模塊中銅板的弧度會產生安裝應力,導致模塊受到額外應力;此外,散熱器與銅板的熱膨脹系數不同,也會導致應力疊加在 DBC 板上,此時如果銅板弧度設計不當,最終也會導致DBC開裂,進而引起絕緣耐壓失效。
值得注意的是,普通材料的裸DBC在進行溫度沖擊試驗時,約100次左右之后可能會出現陶瓷開裂或者銅箔脫離的情況,如下圖所示;但在封裝完芯片之后,整個DBC的可靠性會顯著提升,此時再進行100次試驗之后則很少出現以上情況。這說明芯片封裝在提高溫度循環穩定性方面起著關鍵作用。另外,通過在相同產品平臺上進行大尺寸芯片的可靠性測試覆蓋小尺寸芯片測試,我們發現:對于單管來說,芯片表面應力來源于芯片與封裝料CTE差異,當焊接在銅板上的芯片尺寸越大時,受到的應力越大,此時同平臺大尺寸的芯片可以覆蓋小尺寸芯片的TS試驗;但對于模塊來說,DBC銅箔表面應力來源于陶瓷材料與銅箔TEC差異,當模塊中的芯片尺寸越小時,DBC銅箔受到的應力則會越大,此時無法完全參考同平臺大尺寸的芯片覆蓋小尺寸芯片的TS試驗。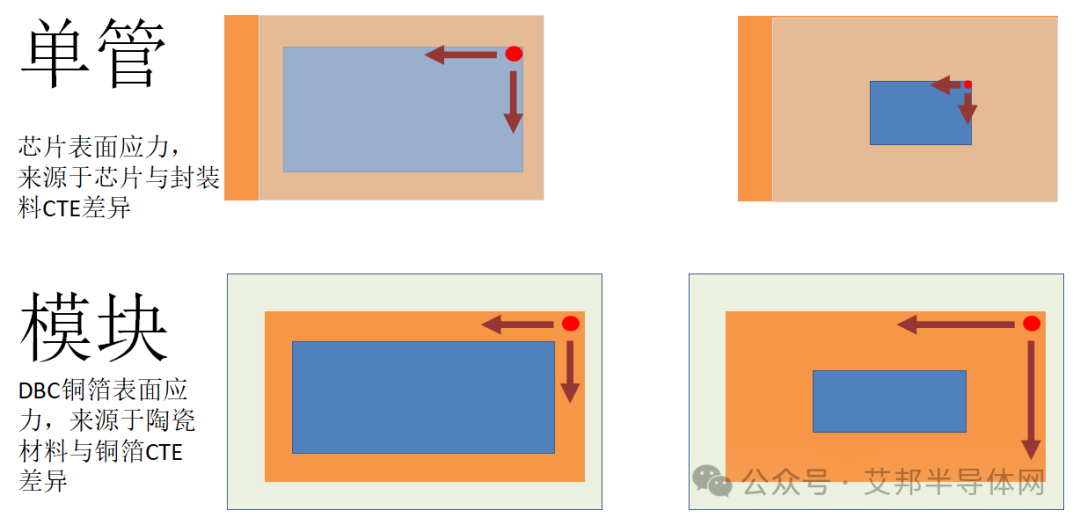
總體而言,單管與模塊在可靠性考核方面具有差異性,不僅體現在器件結構和設計上,還反映在失效現象和失效機理上。隨著技術的發展和對材料特性的深入理解,這些失效模式的研究正不斷進化,推動著可靠性評估方法的創新和變革。? ??本文由索力德普半導體實驗室主管屠星宇《功率器件中單管與模塊可靠性考核的差異》主題報告分享整理,關注公眾號,回復關鍵詞:20231108,即可查看演講視頻,下載演講資料。原文始發于微信公眾號(艾邦半導體網):功率器件中單管與模塊可靠性考核的差異性